GaN外延膜厚度的精确控制,对于GaN器件的外延生长至关重要。GaN外延膜厚度的测量,最直观的方法就是采用扫描电子显微镜(SEM)来观察.但由于蓝宝石衬底本身的不易解理。以及GaN外延膜与衬底之间水平方向上存在30°转向,这就给随后断面的精确观察和厚度的测量带来了困难,利用薄膜干涉条纹也可以拟合出GaN外延膜的厚度,但这要求样品上下表面平整,GaN样品有时很难符合这一要求.可见,寻找一种非破坏性、快捷方便并且具有普适性的手段来测量GaN外延膜的厚度,对于GaN材料研究和器件制作是非常必要的。X射线双晶衍射,因其快捷、准确和具有非破坏性的特点,而成为表征GaN外延膜晶体质量最常规的方法。但由于目前外延生长的GaN外延膜的结晶质量尚未达到完美的程度,通常X射线双晶衍射的Rocking curve中不出现Pendellosung条纹,无法利用Pendellosung条纹间距测量GaN外延膜的厚度.本文提出一种利用X射线双晶衍射中的积分强度来测量GaN外延膜厚度的新方法。
1. 实验
GaN外延膜的生长用低压金属有机物化学汽相淀积( LP-MOCVD)方法进行,衬底为蓝宝石(0001),TMGa和NH3分别为Ga和N源,H2为载气,通过改变生长时间来获得不同厚度的GaN外延膜样品。X射线双晶衍射在日本Rigaku SLX-IA型双晶衍射仪上完成,采用CuKa1辐射,电压40kV,电流100mA。样品的厚度采用JEOL 6300F场发射扫描电子显微镜(SEM)测量,加速电压为15kV。
2. 测试原理
x射线双晶衍射Rocking Curve可以用来直接测量结晶质量高度完整的异质外延膜的厚度,通常对于Si和GaAs外延膜采用干涉条纹( Pendellosung)方法来测量。但Pendellosung条纹的出现是有条件的,它要求外延膜结晶质量好、厚度均匀并且适当。对于GaN外延膜的结构,一般为镶嵌结构,表面起伏较大,不会出现Pendellosung条纹,对GaN外延膜的厚度测量,我们可以采用X射线双晶衍射中积分强度的方法。
对GaN外延膜的某个衍射而言,在不考虑吸收的情况下,術射峰的积分强度可以简单的表达为
 (1)
(1)其中lO为入射束强度,S是样品被照射的面积,t为样品厚度,λ为X射线波长,F为结构因子,A为常数.由(3)式可见I/IO与样品的厚度成线性关系。因此,测出一系列不同厚度的GaN外延膜X射线双晶衍射Rocking curve的积分强度,就可以拟合出t与t的关系。
通常在t<1µm的情况,积分强度与厚度为线性关系,当厚度再厚时,由于吸收的影响,可能会偏离线性关系,此时就要进行吸收系数的修正。
3. 结果与讨论
GaN外延膜的厚度首先采用SEM进行测量,测量结果分别为:044,0.60,0.70,0.88,1.20,1.62,1.80和2.12µm.对于不同厚度的样品分别进行GaN 0002X射线双晶衍射Rocking curve测量,图1为各积分强度于对应GaN外延膜厚度的关系。由图1可见,当t<1µm时,GaN积分强度与厚度为线性关系(如虚线所示)而当t>1µm时,积分强度与GaN厚度巳经偏离线性关系,样品的吸收影响越来越大,必须进行吸收的修正。

图1 GaN外延质厚度与其0002 Rocking curve积分强度的关系
考虑GaN对X射线的吸收,如图2所示,方程(1)可变为
 (2)
(2)其中µ为GaN对x射线的线吸收系数,θB为GaN 0002衍射的Bragg角。
我们利用方程(2)对数据点进行非线性拟合,如图1实线所示,拟合结果与数据点很好的符合,井在t<1µm时,与不考虑吸收的虚线重合,这是因为对于t<1µm时,吸收影响非常小,可忽略。
实际GaN外延工艺中,GaN的厚度一般为1.0-2.0µm之间,其数据点在图1上都落在非线性部分,这给厚度的测量带来了不便。我们进一步提出采用GaN积分强度和衬底积分强度的比值与GaN外延膜厚度的关系来测量GaN厚度的新方法。

图2 X射线衍射光程示意图
对于蓝宝石衬底,结晶质量接近完整晶体,其X射线双晶衍射Rocking curve积分强度为一定值IS。外延GaN后,实际测量到的蓝宝石衬底的积分强度由于受到GaN外延膜吸收的影响变为
 (3)
(3)方程(2),(3)相比,可得
 (4)
(4)由于θBS与θB相差很小,对于t<2µm的GaN样品,方程(6)中吸收项可近似为1。因此,GaN积分强度与蓝宝石衬底积分强度的比值和外廷膜的厚度成线性关系。图3为GaN外延膜积分强驱度和蓝宝石衬底积分强度的比值与GaN外延膜厚度的关系.由图3可见,该比值与GaN厚度成很好的线性关系,这与我们理论计算的结果一致。
在实际测量中,只要分别测量GaN外延膜的0002衍射峰的积分强度和蓝宝石衬底0006衍射峰的积分强度,然后算出两者的比值,就可以通过图3推算出GaN外延膜的厚度。该方法可以消除测试条件的差异所引起的误差,比单纯用GaN外延膜的积分强度和厚度的关系测量GaN厚度的方法更精确可靠。
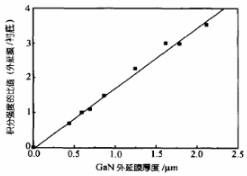
图3 GaN 0002积分强度和蓝宝石衬底0006积分强度的比值与GaN外延膜厚度的关系
4. 结论
通过对GaN外延膜X射线双晶衍射Rocking curve积分强度的理论分析,提出采用GaN积分强度和衬底积分强度的比值与样品厚度的关系来测量GaN外廷膜厚度的方法,该比值与GaN样品厚度在t<2µm为很好的线性关系。该方法消除了因GaN吸收造成的影响,比单纯用GaN积分强度与样品厚度的关系测量GaN外延膜厚度精度更高,更方便可靠。
