通过AlN栅介质层MIS-HEMT和Al2O3栅介质层MOS-HEMT器件对比研究发现,PEALD沉积AlN栅绝缘层可以大幅改善绝缘栅器件的界面和沟道输运特性;但是由于材料属性和生长工艺的局限性,采用AIN完全代替Al2O3栅介质层改善器件界面特性的同时也牺牲了一部分的器件关态漏电性能,即采用Al2O3栅介质层能获得更好的器件漏电抑制效果。为了解决采用不同栅介质层的绝缘栅器件界面特性和关态漏电之间的矛盾,本文创新性地采用Al2O3/AlN叠层栅介质结构,可以在利用AlN介质插入层改善界面和沟道输运特性的同时,保证器件具有优良的关态漏电和击穿性能。另外,采用绝缘栅结构后栅电极距离沟道距离増大,器件栅控能力减弱,会导致微波功率器作的跨导、增益和效率性能降低,本文一方而采用超薄栅介质层,减小栅绝缘层引起的栅控能力减弱效应,另一方面采用凹槽栅结构减小栅到沟道的距离,进一步提高器件跨导和微波功率增益。
Al2O3/AlN叠层介质凹槽栅MIS-HEMT器件结构如图1所示,采用生长在3英寸SiC衬底上的商用异质外延材料,AlGaN势垒层铝组分为25%,室温Hall测试得到沟道载流子密度和迁移率分别为7.7×1012cm-2和2180cm2/V·s,方阻约为370Ω/sq。器件欧姆接触制作、有源区隔离、表面钝化层沉积工艺之后,利用F基刻蚀表面钝化层定义出0.5µm长的T型栅脚区域,然后转为Cl基刻蚀减薄栅下区域的氮化物势垒层。在栅介质层沉积前,采用化学表面清洗、原位低损伤等离子体进行栅下区域表面预处理,然后分别采用PEALD和热型ALD模式在同一台原子层沉积设备中先后沉积1nm AlN界面插入层和5nm Al2O3栅介质层。最后完成栅帽金属制作、表面保护SiN层、电极开孔和互联工艺。
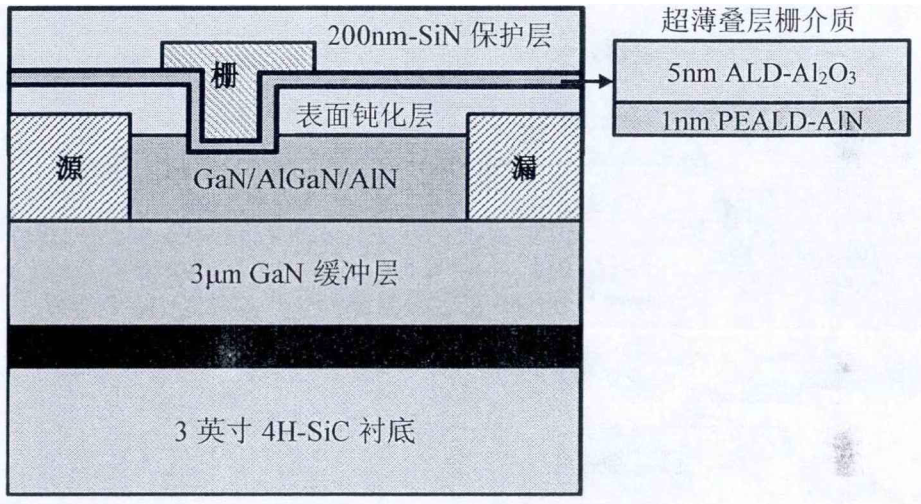
图1 Al2O3/AlN叠层介质凹槽栅MIS-HEMT器件结构横截面示意图
2. 器件关态漏电和转移特性
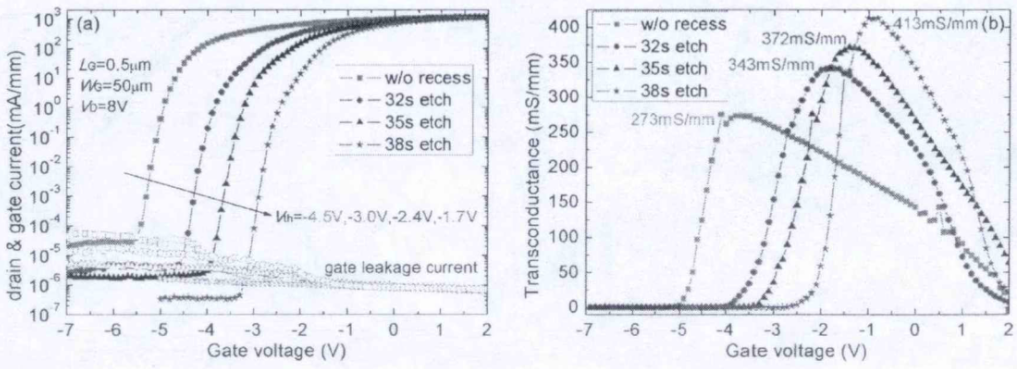
图2 凹槽刻蚀吋间对Al2O3/AlN叠层介质MIS-HEMT器件的(a)转移曲线、关态泄漏电流和(b)跨导曲线的影响
图2给出了Al2O3/AlN叠层栅介质MIS-HEMT器件的转移和跨导曲线,漏压偏置设置为8V,栅电压从-7V向正向扫描至2V,扫描步长为0.1V。常规无凹槽刻蚀器件的关态漏电水平在10-5mA/mm量级,开关态电流比约为108,峰值跨导为273mS/mm,利用跨导峰值处的转移曲线线性外推得到的阈值电压为-4.5V。采用凹槽Cl基刻蚀后势垒层减薄使得器件阈值电压正向漂移,跨导峰值显著提高,器件关态漏电降低1-2个数量级。32s凹槽刻蚀后器件阈值电压正向漂移了1.5V,跨导峰值提高了70mS/mm;凹槽刻蚀时间分别增加3s和6s之后,阈值电压继续正向漂移了0.6V和1.3V,跨导峰值分别提高了29mS/mm和41mS/mm。根据三种刻蚀条件实验结果分析,Cl基刻蚀速率约为每s刻蚀减薄势垒层导致阙值电压正向漂移0.2V和跨导峰值提高10mS/mm。通过凹槽刻蚀工艺,使得器件峰值跨导从273mS/mm显著提高到410mS/mm以上,有利于提高微波功率器件的高频增益和功率附加效率,器件开关态电流比达到1010量级。
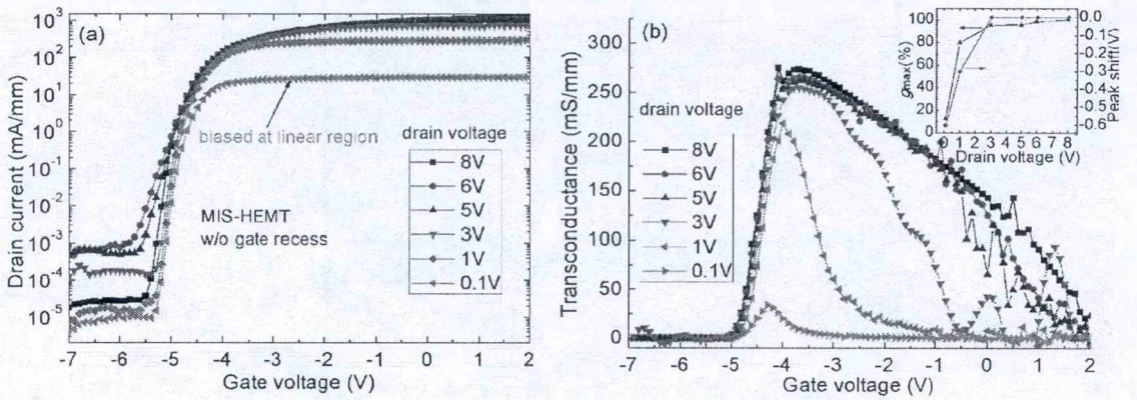
图3 Al2O3/AlN叠层介质MIS-HEMT器件的(a)转移和(b)跨导曲线随漏极电压偏置的变化关系,插入图表示峰值跨导和对应的栅压偏置随漏压偏置的变化曲线
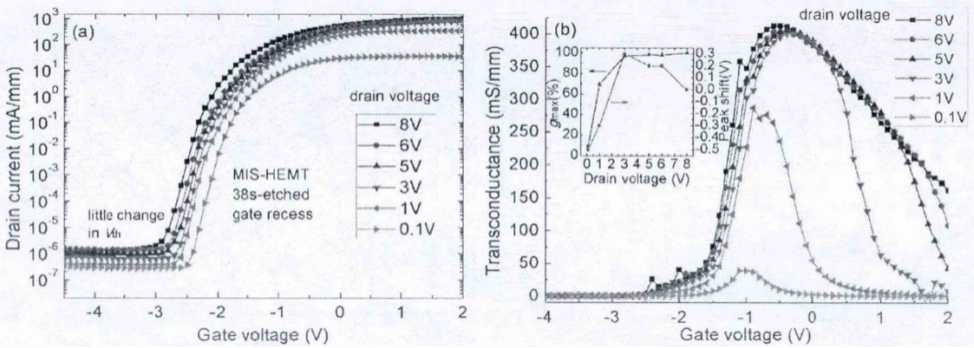
图4 Al2O3/AlN叠层介质凹槽栅(刻蚀时间38s)MIS-HEMT器件的(a)转移和(b)跨导曲线随漏极电压偏置的变化关系,插入图表示峰值跨导和对应的栅压偏置随漏压偏置的变化曲线
图3不同漏压偏置下MIS-HEMT器件的转移和跨导曲线,当漏极电压从8V减小到3V时器件阈值电压和饱和输出电流基本保持不变,跨导峰值降低量在5%以内,说明釆用超薄栅介质层后栅对沟道控制能力依然很好,栅接触区域受漏致势垒降低影响不明显;当漏压偏置为1V时,器件沟道载流子没有达到饱和速率,输出电流减小至300mA/mm以下,跨导峰值降低~20%,线性外推得到的阈值电压负向漂移0.3V;当漏压偏置在0.1V时,器件工作在线性区,异质结沟道处于高阻态,输出电流急剧下降至30mA/mm,跨导峰值降低近90%,阙值电压负向漂移0.6V。凹槽栅MIS-HEMT器件的转移特性随漏极偏置的变化关系如图4所示,与无凹槽刻蚀器件结果类似,在漏压从8V减小到3V时转移特性变化不明显,漏压偏置在1V时沟道不饱和效应使输出电流和峰值跨导显著降低,漏压偏置在线性区0.1V时输出电流和跨导降低至很低的水平。
3. 栅正向偏置和器件输出特性
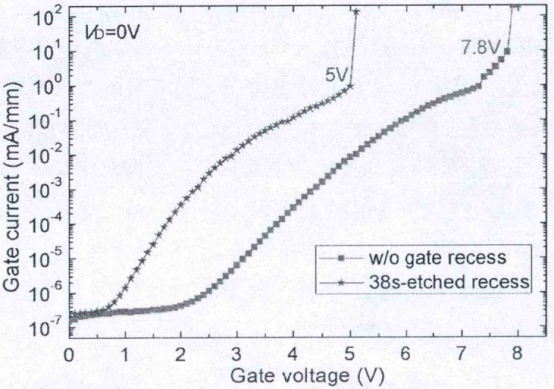
图5 叠层介质MIS-HEMT器件的栅极正向泄漏电流曲线
绝缘栅结构在降低HEMT器件关态泄漏电流的同时,还可以提高正向栅开启和击穿电压,使栅电极可以偏置在更高的电压从而提高饱和电流和功率输出能力。图5给出了叠层介质MIS-HEMT器件的栅极正向泄漏电流曲线,无凹槽刻蚀器件的栅正向击穿电压高达7.8V,而38s凹槽刻蚀后栅极正向击穿电压仍然高达5V,说明器件工作状态下栅极极值电压至少可以达到4V而不会导致器件失效。图6所示的器件输出曲线表明,C1基凹槽刻蚀使器件跨导峰值大幅提升的同时,并没有造成明显的输出电流退化,即本文采用的凹槽刻蚀条件是一种低损伤刻蚀工艺。栅偏置为4V时无凹槽和凹槽栅MIS-HEMT器件的饱和输出电流分别高达1.26A/mm和1.24A/mm,约20mA/mm的电流差异来源于两种器件沟道载流子积累程度不同,而不是载流子面密度和迁移率损伤。
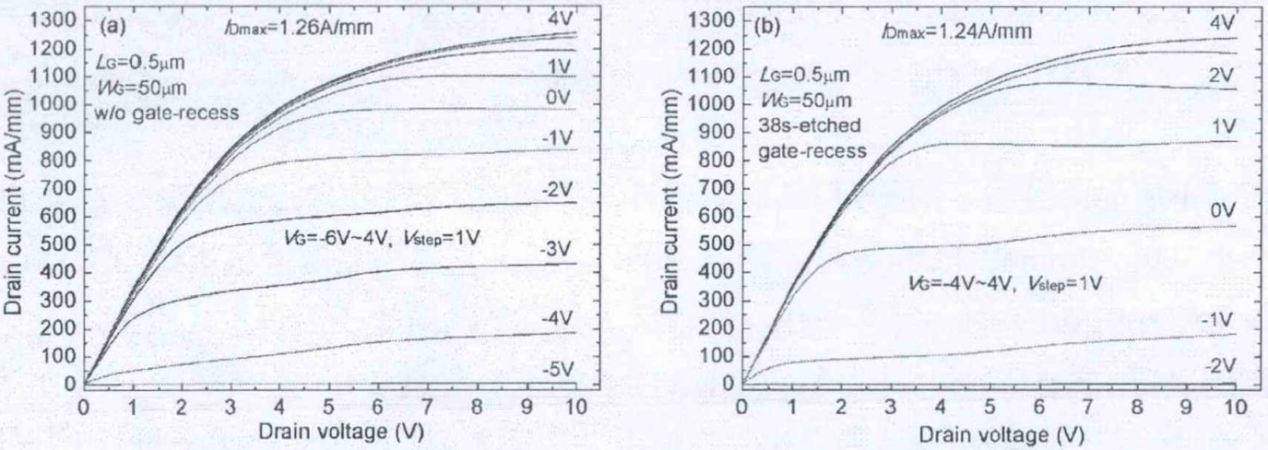
图6 Al2O3/AIN叠层介质MIS-HEMT器件输出曲线:(a)无凹槽刻蚀栅,(b)38s凹槽刻蚀
4. 器件击穿特性
图7给出了研制的Al2O3/AlN叠层介质凹槽栅MIS-HEMT器件的三端击穿特性,栅极电压偏置在关态-8V,漏极电压从0V扫描至150V,扫描步长为0.5V,限流为1mA/mm,源漏间距为5µm器件的击穿电压高于150V。漏极电压低于30V时,器件漏极泄漏电流以缓冲层漏电为主,随着电压偏置增大漏电流以指数规律上升;栅极泄漏电流以垂直与势垒层的栅-沟道漏电,器件关态情况下势垒层垂直电场饱和,所以栅极泄漏电流几乎不随外加偏置变化。当漏极电压偏置高于30V时,栅极表面泄漏电流急剧上升,栅漏电主导机制由垂直体漏电转变为表面漏电,并且随着漏极偏置电压增大,漏极-栅极之间横向电场电场强度増大,表面泄漏电流随着漏极电压以指数规律上升。由于栅极-漏极之间表面泄漏电流增大,漏极泄漏电流主导机制由外延层材料的缓冲层漏电转变为栅极泄漏电流主导。
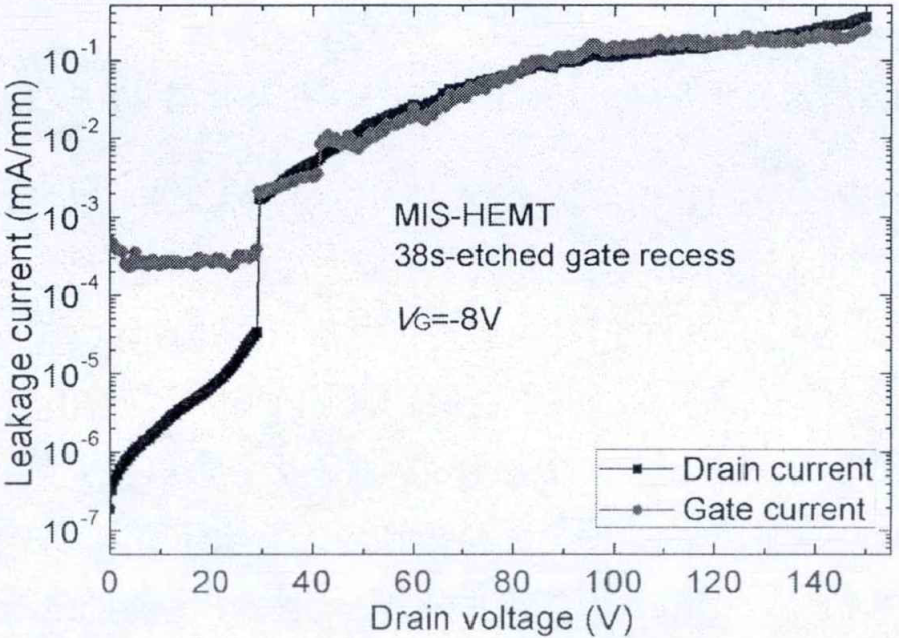
图7 凹槽栅叠层介质MIS-HEMT器件击穿特性
5. 器件小信号测试
利用Agilent E8363矢量网络分析仪对凹槽栅MIS-HEMT器件进行小信号测试,并通过同轴电缆和微波探针连接到待测器件,待测器件栅宽为2×50µm。利用IC-CAP软件套装和GPIB线连接控制Agilent B1500半导体特性分析系统对器件施加直流偏置,漏压偏置在5V,改变栅压偏置测量小信号S参数。最大增益点栅压偏置条件下器件S参数和频率特性如图8所示,随着测试频率增大叠层介质凹槽栅MIS-HEMT器件的输入端口反射系数S11和输出端口反射系数S22增幅很小,保持在-5dB以内,,说明器件输入输出端口阻抗较小;器件正向传输系数S21随频率增大而减小,这是由于高频信号下器件电流增益压缩引起的,1-17GHz频段内正向传输系数保持在5dB以上;反向传输系数S12很小,保持在-12dB以下。利用器件正向电流增益参数H21和最大资用功率MAG曲线的线性外推,得到电流增益截止频率fT和最高振荡频率fmax分别为24GHz和102GHz。
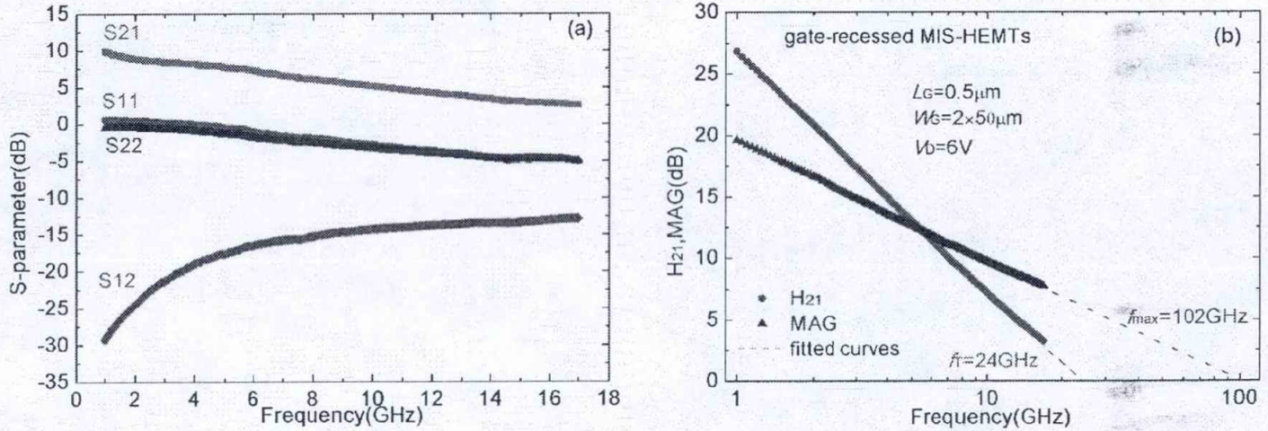
图8 凹槽栅MIS-HEMT器件小信号S参数和fT/fmax提取曲线

图9 凹槽栅MIS-HEMT器件fT/fmax随栅压偏置的变化关系
图9给出了器件截止频率和最高振荡频率随栅压偏置的关系,设定频率特性最高的栅压偏置点为0V栅压参考点,分别使栅压偏置向正/反方向漂移0.5V。随着栅压偏置向正向移动,最高振荡频率迅速减小至72GHz,截止频率也单调递减至22GHz;栅压偏置从最佳偏置处向关态方向(栅压减小)移动时情况类似,最高振荡频率和介质频率分别减小至91.9GHz和21.2GHz。在1V的栅压偏置变化范围内,凹槽栅MIS-HEMT器件的截止频率保持在20GHz以上,最高振荡频率保持在70GHz以上,说明器件具有较好的小信号增益线性度。
6. 器件微波功率测试

图10 凹槽栅MIS-HEMT器件的输入输出端口阻抗在史密斯圆图上的分布
利用负载牵引测试系统对凹槽MIS-HEMT器件的微波功率特性进行了在片测试,测试频率为5GHz,选用器件的栅宽为2×50µm,设定栅压偏置使器件工作在AB类状态下。器件输入端口阻抗S11和输出端口阻抗S22随频率的变化关系如图10所示,随着测试频率增大,器件输入/输出端口感抗迅速减小,输入端口电阻增大使正向电流增益减小,输出端口电阻从212Ω减小至54Ω。5GHz频点处器件输入端口阻抗和输出端口阻抗分别为Z0*(0.220-j2.383)和Z0*(1.352-j3.731),特征阻抗Z0=50Ω。功率测试之前,通过待测器件和测试系统之间连接的输入输出阻抗调谐TUNNER将输入/输出端阻抗匹配至50Ω。
漏极工作电压为28V时器件的连续波微波功率特性曲线如图11(a)所示,凹槽MIS-HEMT器件的线性增益为11.27dB,在输入功率为16.45dBm时器件功率附加效率PAE达到最大值36.03%,输出功率和功率增益分别为3.94W/mm和9.51dB,在5dB功率增益压缩点处输出功率达到4.75W/mm。本文通过采用二次谐波调制技术进一步提高了器件的微波功率输出特性,如图11(b)所示,二次谐波抑制技术使MIS-HEMT器件的最大输出功率和功率附加效率分别提高到了5.32W/mm和40.7%。同样栅压偏置条件下,将漏极工作电压提高到48V时器件的微波功率输出曲线如图5.31所示,与28V工作电压下测试结果相比,采用二次谐波抑制前后的线性增益分别增大到了12.57dB和14dB,最大输出功率分别提高到了6.19W/mm和741W/mm,但是由于器件静态工作偏置点向A类方向漂移,使得其功率附加效率峰值分别降低到了24.6%和32.0%。通过调整器件的静态工作偏置点使其工作在B类或者关态,可以进一步提高叠层介质凹槽MIS-HEMT器件的功率附加效率,获得高效微波大功率器件。

图11 28V工作电压下Al2O3/AIN/AIGaN/GaN凹槽MIS-HEMT器件的微波功率特性:(a)未采用谐波调制技术,(b)采用二次谐波调制技术
