工程师圆队通过空气退火步骤,修补了Al2O3层内和周围的缺陷,从而改善了金属氧化物半导体HEMT的性能。
将InAIN/GaN HEMT在300℃下空气中退火12小时,跨导线性和亚阔值斜率都得以提高。然而,研究人员在这项工作中的最大意义,不是器件性能的改进,而是使用阴极荧光法对氧相关缺陷的曝光和分类,这是一种基于电子束探测样品并测量所发射光谱的技术。
该技术可能吸引许多追随者,因为InAIN/GaN HEMT中的氧化膜减小了高的泄漏电流。Al2O3由于其很好的特性成为深受欢迎的选择:非常宽的带隙、高的介电常数和高的击穿电压。
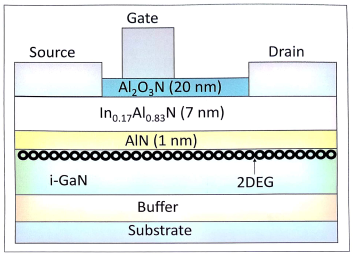
阴极荧光暴露Al2O3中氧相关的缺陷水平和Al2O3/InAlN界面的电子态
为了防止Al2O3降低跨导和阻碍RF性能,该层必须不能太厚。实现这一点,需要采用原子层沉积形成。
Al2O3的另一个要求是其与InAlN界面处的低电子状态密度,实现这一点可以实现稳定的阈值电压和栅极控制。确保低的态密度并不容易,目前的器件通常受制于低的漏极电流,高的栅极泄漏,正向偏压下的跨导大幅度减少,以及严重的电流崩溃。
为了研究这些问题,团队使用空气退火的Al2O3进行了InAlN/ GaN HEMT的性能评估。退火旨在控制Al2O3内部的缺陷水平和Al2O3/InAlN界面的电子状态。
制备的HEMT栅极长度为0.5微米,栅极宽度为50微米,栅极-漏极长度为10微米。原子层沉积为300℃下20nm厚的Al2O3薄膜。
在以前的研究中,该团队研究了几种不同的方法来改善Al2O3中的缺陷水平和Al2O3/InAlN界面的电子状态。技术包括沉积后和金属化后在各种温度下,在不同的气体中和持续时间的退火。
“目前,金属化后的300℃下空气退火12小时,得到了最好的结果,”研究人员解释说。这些条件用于提高最新器件的性能。
对于控制对比和退火器件的测量表明,退火在2V的栅极电压下,将最大漏极电流从小于900mA/mm增加到超过1100mA/mm,并将开态电阻从7Ωmm减小到5.3Ωmm。退火也改善了亚阈值摆幅:从127mV/dec下降至75mV/dec。
对原子层沉积生长的蓝宝石上Al2O3薄膜的阴极荧光研究精确定位出了退火的好处。它产生了阴极荧光光谱中峰值的下降,这与俘获一个和两个电子的氧空位相关。这表明退火减少了Al2O3薄膜中氧空位的数量。
有趣的是,在氮气中退火后,并没有观察到这种行为。这促使研究员假设空气退火增强了Al2O3薄膜中悬挂键包括氧空位的弛豫和钝化。
空气退火的另一个影响是Al2O3薄膜的10%收缩,导致了张应力的增加。这种收缩增强压电场,并对随退火的面电阻减小负责。
研究员认为仍然需要解决的一个问题是,与等效的AlGaN GaN相比,他们HEMT的电压偏移相对较大。
