
式中x为AlxGa1-xN材料中的Al组分,即AlGaN材料中的AlN的百分比,则AlGaN的自发极化强度和压电极化强度可以根据这个组分通过Vegard定律由AlN和GaN的极化参数通过线性函数插值近似得到。因此,AlGaN材料的压电极化强度PSP(AlxGa1-xN)和自发极化强度PPE(AlxGa1-xN)都随着Al组分x的增大而增大,则AlGaN/GaN界面处的净极化正电荷密度σ也会随之增大,根据电荷平衡原理,在异质结界面处会感应产生出跟正的极化电荷密度σ同样大小的带负电荷的电子。
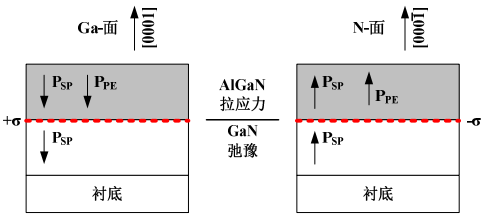
图1 受到拉应力时沿Ga面和N面生长的AlGaN/GaN异质结结构的极化矢量方向
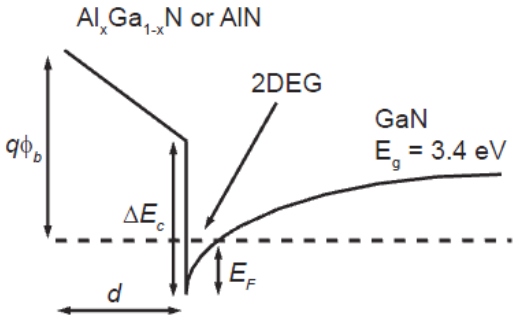
图2 AlGaN/GaN(AlN/GaN)突变异质结的导带底示意图
如下图2所示,为AlGaN/GaN(AlN/GaN)异质结的导带底能带示意图。因为AlGaN与GaN材料的禁带宽度不同,AlGaN的禁带宽度高于GaN,使二者的导带底存在一个带阶差,这个导带的带阶差加上上面分析的界面处的大量正电荷会使导带底能带弯曲,能带弯曲使异质结结面处形成一个二维势阱。这个二维势阱将会把之前讨论的极化诱生电子限制其中,这些电子在势阱中只能沿着平行于突变结界面的平面内作二维运动,因此被称为二维电子气(2DEG)。所以,在Al(Ga)N/GaN突变异质结结构中,即使不对AlGaN势垒层进行任何掺杂,凭借数量巨大的极化正电荷,所感应得到的2DEG的面密度也能高达2×1013cm-2。
则对于AlGaN/GaN HEMT,考虑到金属栅极与AlGaN势垒对栅极下方沟道的肖特基结耗尽作用,其异质结界面的2DEG的面密度ns可以用下式表示:

其中,x为AlGaN的Al组分;σ(x)为异质结界面处两个材料极化强度抵消之后剩下的净极化正电荷面密度;tbar为势垒层的厚度;ε0为真空中的介电常数;εr为AlGaN的相对介电常数(可由AlN和GaN的介电常数通过线性插值得到);EF为处于平衡态时GaN材料中的费米能级;∆EC(x)为AlGaN与GaN由于禁带宽度不同而形成导带底的带阶差;qϕb(x)为金属栅极与AlGaN材料所形成的肖特基势垒的高度,由栅极金属的功函数和AlGaN材料的功函数(可由AlN和GaN的功函数通过线性插值得到)决定。
值得一提的是,由于AlGaN/GaN异质结可非故意掺杂,所以掺杂引起的电离杂质散射对2DEG的迁移率的影响不大。同时2DEG被限制在势阱中只能沿着平行于异质结界面的平面进行二维移动,而GaN体材料中的电子会向三个方向移动,所以2DEG的迁移率远高于体电子的迁移率(约为2倍以上)。而当AlGaN/GaN HEMT器件工作时所受的栅极电压偏置较大时,AlGaN势垒的能带被拉低,处于异质结界面的2DEG将会通过隧穿或者热激发直接越过势垒进入AlGaN势垒层中移动。而AlGaN势垒是由GaN和AlN两种不同合金材料构成,则位于AlGaN势垒中的电子将会受到合金无序散射的影响会使迁移率大幅下降。因此,可以在AlGaN和GaN之间加入一层极薄(1~2nm)的AlN插入层,AlN插入层可以进一步拉高界面处的导带带阶,再者AlN本身为绝缘材料,所以上述提到的2DEG渗透到AlGaN势垒层中使迁移率下降的效应将受到抑制,变相地提高了2DEG的迁移率。
