体材料中电子在三维空间内散射,散射几率大迁移率较低。而当电子被窄量子阱压缩成二维电子气后,形成分裂的二维子能带,如二维特性较强,子带间的能量差大,带间跃迁几率小,电子只能在二维平面内散射,迁移率增大。
由于宽带隙材料施主电离的电子转移到非掺杂的窄带材料的一侧,电子受到的散射作用会减弱,因而电子的迁移率会显著的提高,由此而使得即使在宽带材料很高掺杂的情况下,也可以获得较高的电子迁移率。相比于传统器件,器件性能会有很大提高。
AlGaN/GaN HEMT仿真中主要考虑AlGaN/GaN界面产生的极化电荷,由此引发高的2DEG。AlGaN/GaN HEMT器件不同于其他材料最显著的地方就在于极化效应产生的高浓度2DEG,而像GaAs HEMT则是利用不同能带宽度的半导体材料接触,相同掺杂类型的不同材料相接触,电子在能带宽度窄的一侧积累,通过故意高浓度掺杂能带宽的半导体材料和低浓度掺杂能带宽度窄的半导体材料,使电子在能带窄的半导体材料中积累,而能带窄的半导体材料由于低掺杂,则电子迁移率高。通过这个导电电子与掺杂材料分离提高器件性能。
AlGaN/GaN HEMT也是Nn同型异质结结构,但高密度导电电子积累不是通过AlGaN层高掺杂得到的,而是利用强的极化效应束缚电子形成的。AlGaN/GaN HEMT中的AlGaN/GaN同型异质结对导电沟道电子浓度的贡献相对于极化效应产生的电子浓度是很小的,如图2a和3.2b分别是未计入极化效应和计入极化效应的电子浓度。异质界面上的大能带带阶和强极化电荷形成高势垒和沟道中的强二维电子气。极化电荷使界面上能带产生一个突变如图1b,电子气产生的电场提高了沟道右边的能带,形成一个三角阱。
仿真中设置AlGaN一侧的掺杂浓度是n型1×1016、厚度为30nm、Al含量为0.27,而GaN层采用背景掺杂浓度n型1×1015、厚度为2.6µm,源到漏极的宽度为3µm、栅极在1.2-1.8µm处。图1c所示是未计入极化效应AlGaN/GaN异质结能带图,图中能带宽的一侧是AlGaN层,能带窄的一侧是GaN层,两种材料相接触能带弯曲很小,在AlGaN/GaN异质结的GaN电子积累一侧,导带弯曲很小,相应GaN窄能带一侧的电子积累就非常少,如图2a所示,异质结界面处的电子浓度是很低的。而图1a和b是计入了极化效应AlGaN/GaN异质结的能带图,图中GaN导带弯曲程度相比图1c导带的变化量要大得多,由极化效应产生的导带大的弯曲量产生很深的量子阱,对电子有很强的束缚作用,从而形成了高浓度的2DEG。
图2b可以看出,计入极化效应后GaN界面一侧的峰值电子浓度超过了1×1020,比未考虑极化效应的AlGaN/GaN异质结产生的电子浓度(峰值1×1015.29)要高出好几个数量级。因此AlGaN/GaN HEMT异质结中的2DEG主要来源于极化效应,合理的利用极化效应可以提高HEMT的性能。
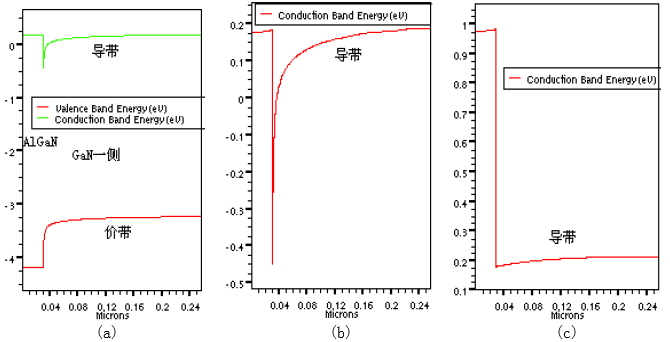
图1 (a)计入极化效应异质结完整能带
(b)计入极化效应AlGaN/GaN异质结导带
(c)未计入极化效应AlGaN/GaN异质结导带
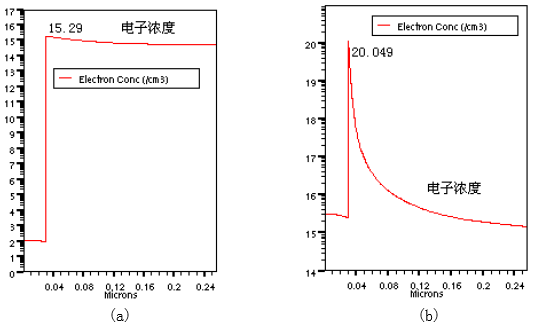
图2 (a)未计入极化效应AlGaN/GaN异质结电子浓度
(b)计入极化效应AlGaN/GaN异质结电子浓度
异质结界面上的大能带带阶和强极化电荷形成高势垒和沟道中的强二维电子气如图3所示。极化电荷使界面上能带产生一个突变,电子气产生的电场提高了沟道右边的能带,形成一个三角阱。图3表示导带与电子浓度的关系,电子浓度主要集中在AlGaN/GaN异质结界面很窄的区域内,形成高密度的2DEG。而传统AlGaAs/GaAs异质结只有通过掺杂才能产生2DEG,这正是逊色于AlGaN/GaN的最大的地方。
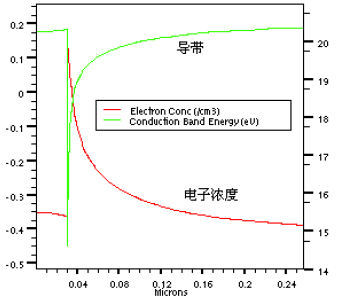
图3 电子浓度相对于导带的浓度分布情况
图4a是AlGaN/GaN异质结极化效应产生的薄层极化电荷,极化电荷集中在界面很窄的区域内,在异质结界面产生很强的极化电场如图4b。AlGaN/GaN异质结极化电场集中在一个很窄的距离内,而且其值非常大,对其中的电子产生很强的束缚作用,抑制电子三维方向的运动,只在阱内电子可以自由移动,形成很强的二维电子气。极化效应强烈的调制AlGaN/GaN异质结的能带结构,加强对二维电子气的二维空间束缚,提高了二维电子气的面电子密度。由2DEG形成HEMT的导电沟道,在栅极没有外加电压的情况下,沟道依然存在,因此属于耗尽型器件。图5是不同栅极电压下漏极电流输出特性,横坐标对应漏源电压,纵坐标表示漏极输出电流,电流的单位是A。由图可以看出,随着栅极电压变负,输出电流会不断减小,图中只给出了栅压为1V,0V,-2V,-5V的输出漏电流,电流随电压的变化基本是线性的。
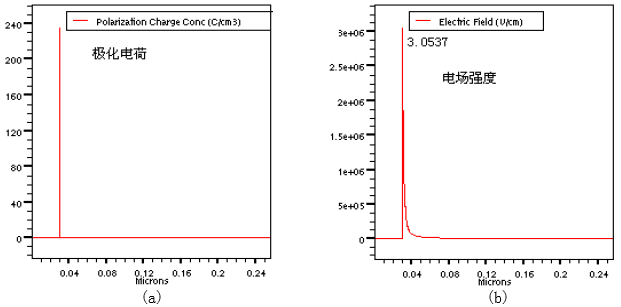
图4 (a)AlGaN/GaN异质结极化电荷图 (b)极化效应产生的电场强度
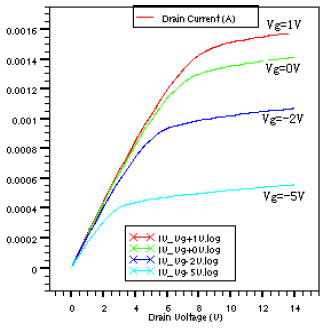
图5 不同栅极电压下的漏电流
