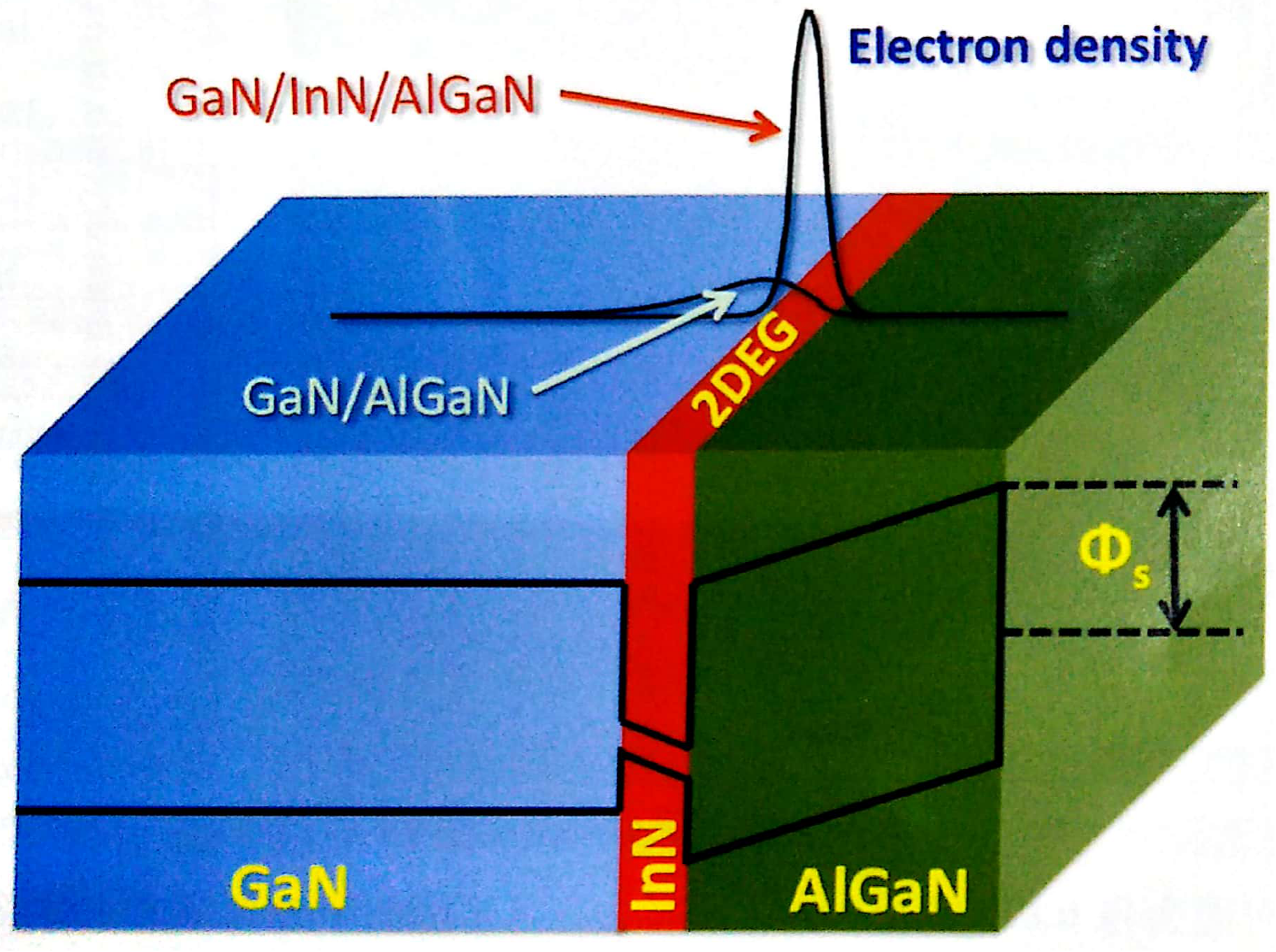
在AIGaN/GaN HEMT中插入InN单原子层可以产生高度局域化的二维电子气,其表面势垒高度用Φs表示。
由于InN材料的电子迁移率要远高于GaN材料,因此该团队的研究人员决定对这种新型器件进行探索和研究。
为了评估在HEMT中加入单层InN层后的优势,位于美国西海岸该团队的Duo根据薛定谔-泊松方程解法进行了根本性能上的电子结构计算。以对宏观器件进行模拟。用薛定谔-泊松解法可以模拟许多特性,比如二维电子气的局域化程度等。
但是为了能获得多个微观参数,比如InN层中电子的有效质量等,进行这种根本性能上的计算将是十分必要的。他们将这种计算方法与一种采用先进的混合功能的密度函数理论相结合,获得了对电子结构的精确计算结果。
但这需要进行海量计算,相比于传统方法对密度函数的计算,它所需的计算量将会是之前的二十倍。只有采用超级计算机才能够实现这样的计算。
他们研究了一种新的器件结构,它是由260nm厚GaN层、4nm厚Al0.34Ga0.66N层以及在其间插入一个0.36nm厚InN单原子层所组成。假设InN层是生长在GaN层上,那么会存在一个很大的双轴压缩应变,并在C轴方向伴有相应的晶格驰豫现象。
与传统GaN HEMT电子密度区的扩展宽度至少能够达到3mm相比,在InN插入层结构中的电子电荷具有更强的局域化性能,根据其测量曲线的半高宽(FWHM)可得知其电子扩展宽度只有1nm。
人们对电子气的本质属性已经进行了深入的探究。计算结果还表明,对于具有一个固定势垒高度、插入InN层的HEMT来说,它在很薄的AlGaN层中会形成一种具有很高密度的二维电子气。如果AlGaN层的厚度还是保持在4nm,那么在插入InN单原子层后,其二维电子气的密度就会更高,这就意味着晶体管对于栅电压的变化将会变得更加敏感。
在HEMT处于关断状态时,所施加的负偏压会降低其表面势,并阻断电子从表面态向界面区域的输运。该团队的模拟结果显示,当表面势垒高度达到3.5eV时,在传统器件的界面处会有少量二维电子气的残余,但是对于插入了超薄InN层的新型器件来说,在它的表面势为3.0eV时,其二维电子气密度就已经骤降到了零。
进一步的计算还获得了面上电子的有效质量,发现它只有体材料中电子有效质量值的94%,比GaN材料的电子有效质量要小30多倍,这意味着二维电子气中的电子将会有更高的迁移率。要证明这种新型HEMT器件的预期优秀性能还需要通过实际器件的制作和测试。
