在常规AlGaN/GaN异质结构中,为了提高功率密度,就应该提高2DEG面密度和迁移率的乘积。增加势垒层Al组分能够增大面密度,但是由于三元合金AlGaN势垒层对AlGaN/GaN异质结界面处的二维电子气有强烈的合金无序散射作用,因此2DEG迁移率会降低。L.Shen等人首次提出了AlGaN/AlN/GaN的结构来提高2DEG迁移率,这种结构是在势垒层和沟道层之间插入AlN薄层(~1nm),从而使得沟道上方的势垒高度显著上升,提高了AlGaN/GaN异质结界面处的导带断续ΔEc,使2DEG面密度略有增加。更为重要的是,二元合金AlN插入层能够降低AlGaN/GaN界面处的合金无序散射,从而提高迁移率。因此,目前AlGaN/GaN异质结构中在势垒层和沟道层之间常常插入AlN层来提高迁移率。
对于常规的AlGaN/GaN单异质结构,沟道层和缓冲层均为GaN。但是对于AlGaN/GaN/AlGaN双异质结构,沟道层为GaN,缓冲层为AlGaN,因此AlGaN缓冲层对沟道中的二维电子气存在合金无序散射作用,而且缓冲层Al组分越高、沟道层厚度越小,这种散射作用就越强,从而使2DEG迁移率降低得越明显。为了减弱AlGaN缓冲层对沟道电子的合金无序散射作用,借助在沟道上方插入AlN薄层提高迁移率的这种思想,我们提出在AlGaN/GaN/AlGaN双异质结构中,在GaN沟道层和AlGaN缓冲层之间插入AlN层来进一步提高2DEG迁移率。
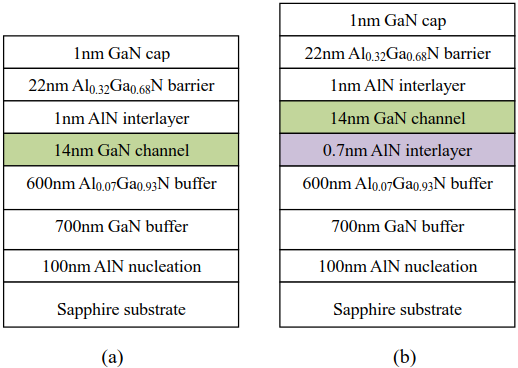
图1 (a)无AlN插入层的双异质结构示意图,(b)有AlN插入层的双异质结构示意图
通过低压MOCVD设备在蓝宝石衬底上生长出了含有AlN插入层的双异质结构材料,结构示意图如图1所示。图(a)为没有AlN插入层的双异质结构示意图,沟道厚度为14nm,样品编号为DH3;图(b)为在GaN沟道层和AlGaN缓冲层之间插入0.7nm AlN层,沟道厚度仍然为14nm,样品编号为DH4。两个样品除了沟道下方有无AlN插入层的区别之外,其他结构均相同。
为了比较沟道下方有无AlN插入层结构的能带分布,通过自洽求解一维薛定谔/泊松方程仿真得到如图2所示的结果。可以看出,由于顶势垒层和沟道层之间1nm AlN插入层的存在,两种结构沟道上方的势垒高度显著提高。另外,样品DH4在沟道下方插入0.7nm AlN薄层,沟道下方势垒高度显著上升,由0.81eV提高到2.78eV,进一步增强了载流子限域性,使沟道中的2DEG更好地限制在较深的势阱中。因此在沟道下方插入AlN层,不仅能够降低合金无序散射对载流子迁移率的限制作用,同时也提高了沟道载流子的限域性,起到了双重作用。
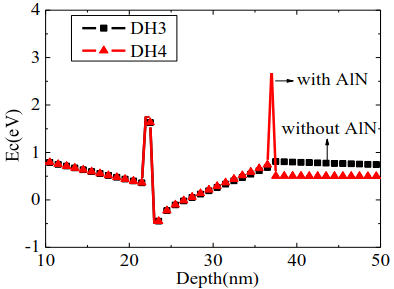
图2 有无AlN插入层结构的能带图比较
2. 样品电特性研究
为了研究两个样品的电特性,我们使用非接触Hall效应测试仪和非接触方阻测试仪对其进行测试,室温下两样品的测试结果如表1所示。可见,虽然面密度和方阻性能变差,但是插入AlN层后,2DEG迁移率在原有基础上提高到1862cm2/Vs,实现了我们追求迁移率提高的目的。合金无序散射对势垒层Al组分和2DEG面密度较为敏感。对于双异质结构来说,不仅在沟道上方的AlGaN/GaN界面处存在合金无序散射,由于缓冲层选用AlGaN,仍然存在Al原子和Ga原子的无序分布,因此在沟道下方的GaN/AlGaN界面处也存在合金无序散射,尤其是当沟道厚度较小时这种散射更为严重。样品DH4中在沟道层和缓冲层之间引入AlN插入层后,沟道下方势垒高度升高,AlGaN缓冲层对沟道中二维电子气的合金无序散射作用减弱,从而提高了2DEG迁移率。
表1 室温下样品电特性测试结果
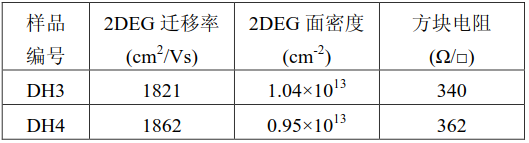
在本实验中,没有AlN插入层的双异质结材料迁移率已经很高,达到了1821cm2/Vs,沟道下方插入AlN层后迁移率有所增加,但是相对来讲增加幅度并不是很大。我们认为,如果将AlN插入层引入到沟道厚度较小的双异质结中或者迁移率不太高的双异质结中,2DEG迁移率将会有很大程度的增加。
