Cree、triQuint以及日本的Sumitomo(Eudyna)等多家公司早在2011年就推出50V工作GaN HEMT微波功率器件,工作频率覆盖了P波段到S波段。然而国内GaN 50V功率管技术研发一直比较滞后,苏州能讯2014年底推出的50V脉冲工作GaN微波功率管,最大输出功率仅有200W左右。
为实现高效率、高现行功率的GaN器件,南京电子器件研究所对宽带、高线性、高效率功率器件技术方向进行了尝试。本文报道了开发的50V工作电压的高功率密度GaN HEMT技术,通过对外延材料结构设计、器件结构仿真设计,提高器件击穿电压。采用2胞合成,输出匹配电路设计提高器件输出功率。最后给出了器件直流和微波测试结果。
1. 外延材料结构的设计
图1给出了研制的AlGaN/GaN HEMT的材料结构示意图。通过利用moCVd(金属有机化合物气相淀积)技术在半绝缘的SiC衬底上外延得到,材料包括ALN成核层、GaN缓冲层、ALN插入层、AlGaN势垒层和GaN帽层。AlGaN势垒层厚度设计为25nm,铝含量为28%。1nm ALN插入层用于提高器件电子迁移率,同时进一步降低材料方阻,提高器件功率密度。GaN帽层用于降低器件峰值电场,从而提高器件击穿电压,降低器件漏电。GaN外延材料XRD(002)、(102)摇摆曲线半高宽分别为118s、200s,电子迁移率2100cm2/(V·S)。
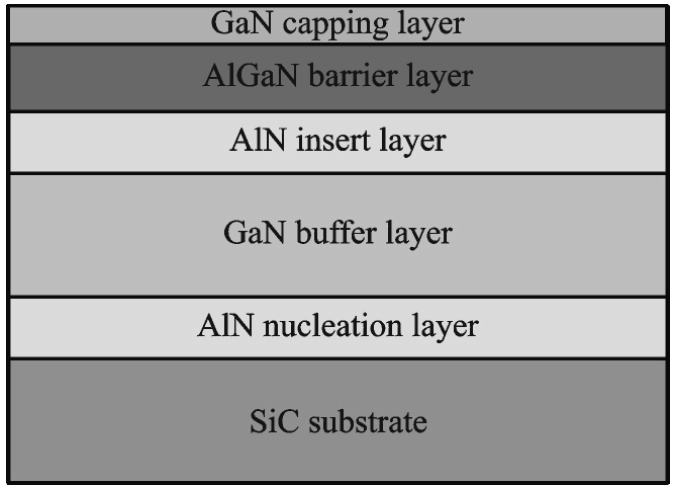
图1 AlGaN/GaN HEMT示意图
2. 器件及电路设计
2.1 器件结构仿真设计
为了满足器件50V工作要求,器件极限击穿电压必须保证150V以上。本文研究了在相同器件尺寸下,通过优化V型栅角度提高器件击穿电压。图2为不同V型栅角度对应的栅漏间峰值电场的仿真计算,通过降低栅脚倾斜角度从90°到45°,可有效降低峰值电场,器件击穿电压可以提高30%以上,有利于实现器件的高电压工作。
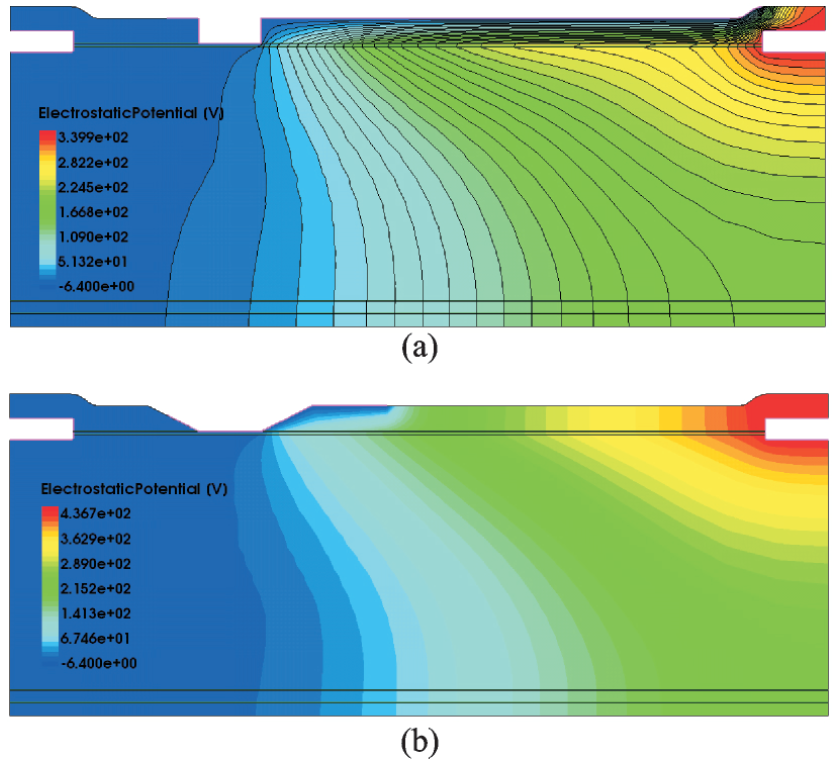
图2 同V型栅结构栅漏间电场强度仿真结果:(a)90°V型栅;(b)45°V型栅
2.2 预匹配电路设计
电路匹配技术是实现大功率器件工作的核心之一,可以使管芯各部分在信号幅度与相位上实现平衡,提升管芯输入输出阻抗。而实现阻抗变换的电抗匹配网络有高通、低通以及带通等形式,一般说来大功率放大器的电路匹配多选用低通网络。本文在预匹配电路设计中也选用低通网络,以满足覆盖低频段的应用要求。同时因为单胞管芯输出功率大,芯片的输入输出阻抗低,根据实际需要,将带内输入阻抗预匹配至10Ω,带内输出阻抗预匹配至3Ω,方便用户的应用。图3所示为输出匹配电路和仿真结果。
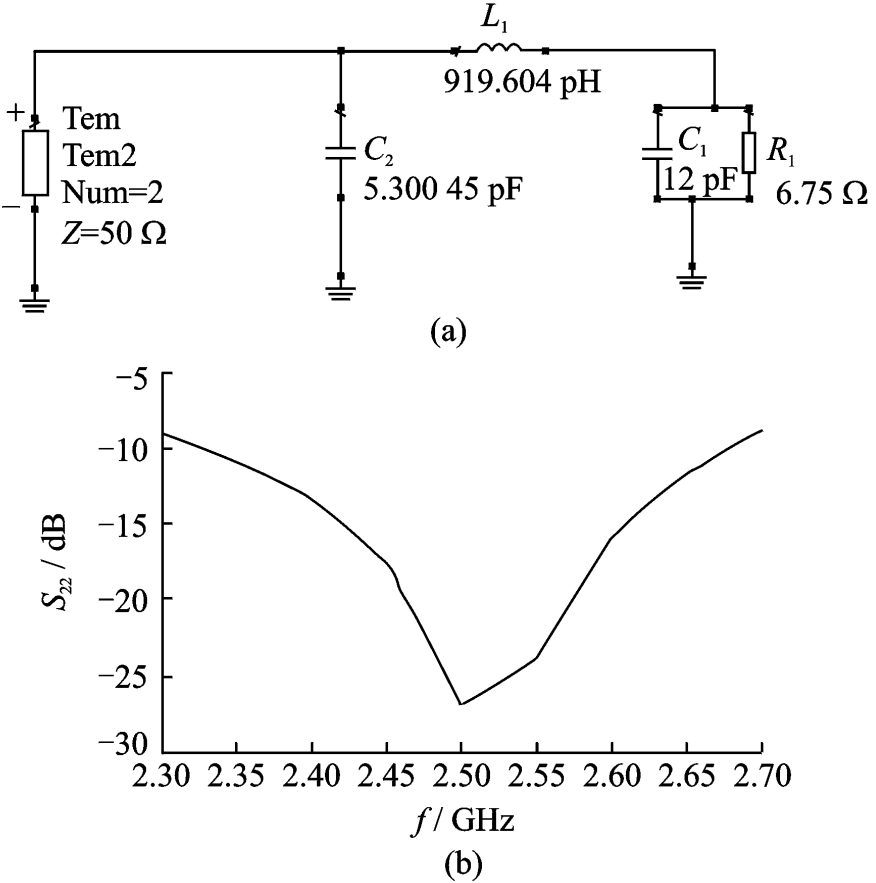
图3 (a)输出预匹配电路;(b)仿真结果图
3. 器件制作
器件的制作是在南京电子器件研究所101.6mm(4英寸)GaN工艺线上、基于0.5μm HEMT标准工艺(GaN50P)进行的,器件工艺沿用了工艺线GaN HEMT标准工艺中高平整度欧姆接触工,通过光刻、蒸发、剥离形成Ti/AL/Ni/Au欧姆电极,然后通过860℃合金形成欧姆接触,欧姆接触电阻值为0.4Ω·mm。栅介质生长以后,通过Stepper光刻形成栅脚。为了降低电场强度及漏电,器件采用低损伤、低角度V型栅刻蚀工艺来实现45°倾角、0.5μm栅长的V型栅结构。然后通过干法挖槽、NiAu肖特基势垒、源场板等工艺实现GaN HEMT的制作。
4. 器件的直流及微波特性
4.1 单胞器件直流特性
单胞20mm器件的饱和漏电流Idss为0.7A/mm、栅偏置Vgs=+2V时的最大电流Imax为1.2A/mm。图4为大栅宽器件在不同温度下的栅极电流。通过V型栅工艺及NiAu高势垒肖特基接触,150V下栅级的漏电控制在15μA/mm,并且从25℃到250℃器件栅级漏电上涨小于2个量级,保证了器件良好的热稳定性。
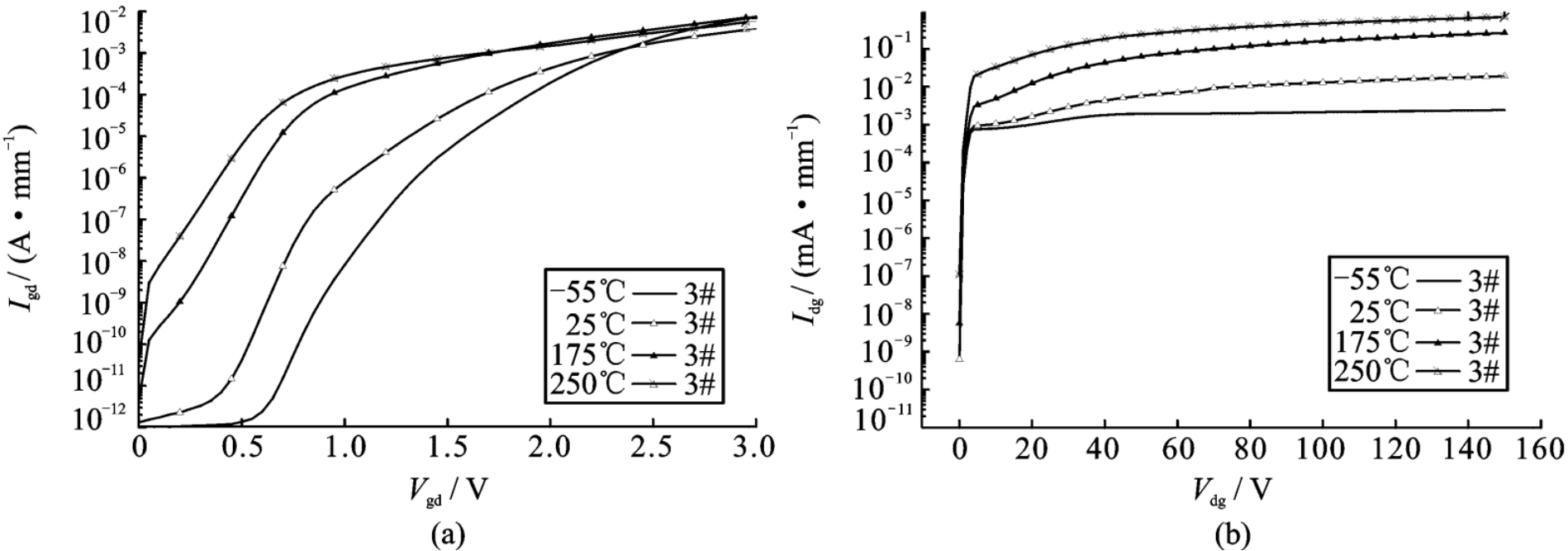
图4 不同温度下栅极电流:(a)栅极正向电流;(b)栅极反向漏电
图5为器件在不同温度下加速寿命实验,器件直流加电条件为Vd=50V,Id=140mA/mm,功耗为7W/mm,结温分别325、300、275℃,通过Arrhenius方程外推器件在150℃结温下平均稳态工作寿命超过4×106h。
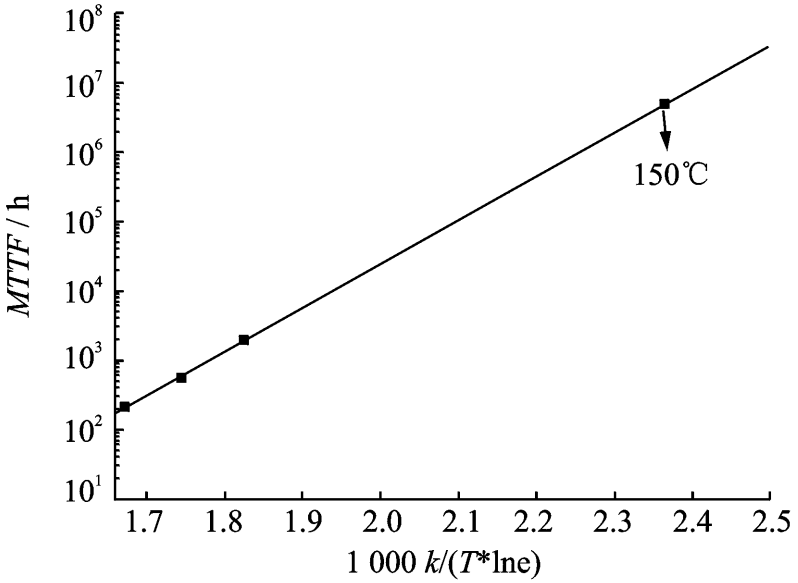
图5 器件平均稳态工作寿命
4.2 器件微波特性
表1显示了20mm栅宽器件负载牵引(Load-pull)测试系统结果:器件在2.7~2.3GHz下功率附加效率(PAE)为68%,器件输出功率为51dBm,功率增益17dB,IMD3(三阶交调)@PAR=5dB。
表1 20mm栅宽器件负载牵引测试结果
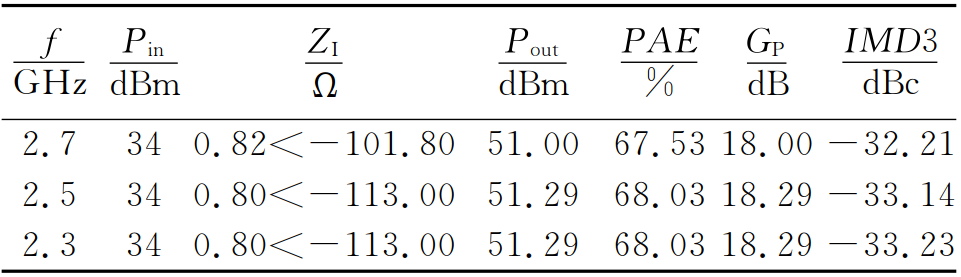
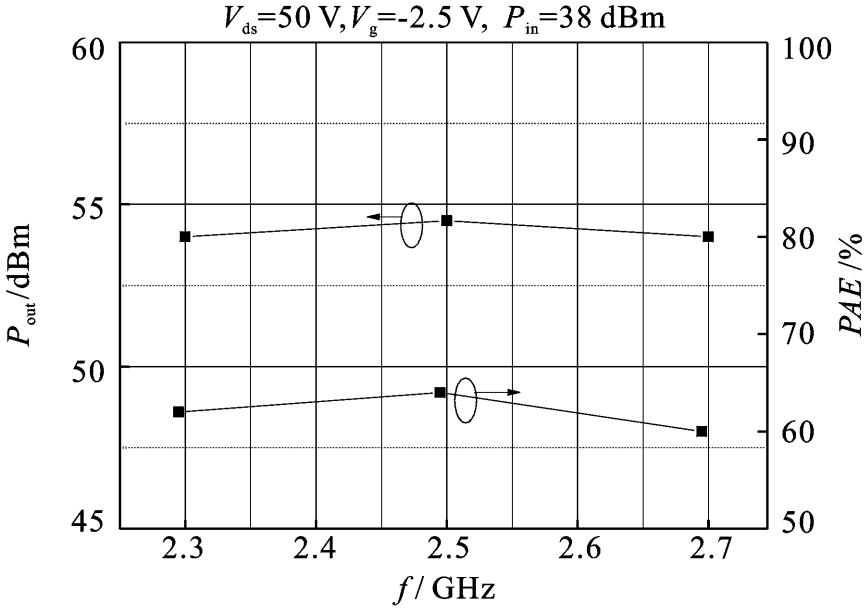
图6 输出功率与附加效率测试结果
图7为20mm栅宽功率管在4G-LTE系统整机验证结果,测试条件为脉宽100μs,占空比10%,Vds=50V,2.6GHz下三载波、100MHz视频带宽器件ACPR>-30dBC@PaR=5dB,满足4G-LTE移动通信需要。

图7 4G-LTE ACPR验证
表2为器件在2.3~2.7GHz典型性能和国外同类产品比较,器件漏极效率、增益以及饱和功率达到Cree公司同类产品水平,器件性能可以满足未来基站2G/3G/4G多频段多载波应用需要。
表2 为器件典型性能和国外同类产品比较
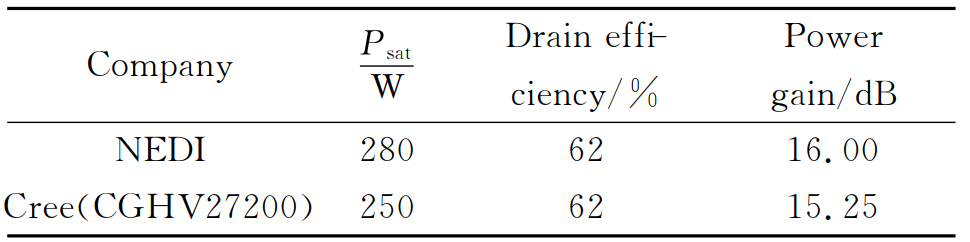
5. 结论
报道了基于0.5μm工艺、50V工作S波段大功率GaN HEMT器件,通过采用NiAu势垒,降低器件栅极漏电,优化V型栅,降低了峰值电场,提高器件击穿电压30%以上。GaN HEMT器件设计采用双场板结构,采用2胞合成,每胞栅宽为20mm,在2.3~2.7GHz带内输出功率280W,功率附加效率>64%。,满足工程化应用需要。该研制结果充分显示了GaN HEMT微波功率器件在未来移动通信中高线性、高效率、超宽带等性能优势,应用前景广阔。
