氮化镓GAN单晶体生长方法
1. 氢化物气相外延法(HVPE, Hydride Vapor- Phase Epitaxy)
这种方法最初用于GaN外延生长,因其生长速率过高(30~100μm/h),外延层厚度很难精确控制,而在薄膜工艺中逐渐被淘汰,但不失为生长GaN厚膜的一种好方法。利用这种方法,可以在异质衬底上外延生长数百微米厚的GaN层,然后用研磨或腐蚀法去掉衬底,即可获得独立支撑的GaN单晶片。
在HVPE过程中,高纯Ga首先在800~900℃的源区反应舟中通过与HCl气体的反应形成氯化物,即
2HCl(气)+2Ga(液)→2GaCl(气)+H2(气)
然后,GaCl与NH3分别用载气携带从不同方向输入生长室,在900~1100℃左右的衬底表面通过反应沉积并结晶出GaN,即:
GaCl(气) +NH3(气)→GaN(固)+HCl(气)+H2(气)
由于GaCl的饱和蒸气压较低,很容易在低温器壁凝结,因而采用此法宜用热壁反应装置。这也是GaCl要采用原位合成、即产即用的主要原因。GaN的HVPE生长系统示意图如图1所示。
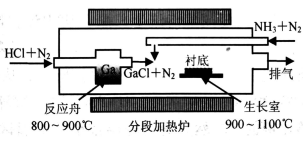
图1 GaN的HVPE生长系统示意图
HVPE方法的主要缺点是反应气体对设备有一定腐蚀性,因而对生长晶体的纯度有严重影响。不过,强腐蚀性气体的存在对晶体生长也有一定好处,那就是能够去除生长表面过量的Ga,抑制富Ga材料和相分离Ga滴的形成。HVPE方法由于生长速率很高,又使用异质衬底,因而生长晶体的缺陷密度往往很高,典型样品的缺陷密度高达1010/cm2,而且在外延层厚度超过20μm后出现裂纹。将HVPE与 MOCVD技术中采用的横向覆盖外延生长法(ELOG, Epitaxy of Lateral Over- Growth)相结合,可以有效克服这个问题,生成低缺陷密度的厚GaN外延层(最高可达500μm)。
ELOG法是一种降低异质厚外延缺陷密度的有效办法。该法使用已生长有同质薄外延层的衬底为衬底,但须在薄外延层上预淀积掩蔽膜(例如SiO2),并刻出图形窗口,形成栅格状掩膜,如图2所示,然后在其上进行二次外延。二次外延只能从窗口内的一次外延层表面开始,掩膜表面因难以成核而不会有薄膜沉积。但当二次外延层在窗口内长到与掩膜齐平时,就会在继续沿竖直方向生长的同时在掩膜上横向延拓生长,并很快连成一片而将其覆盖,而且在其后的生长过程中还将保持横向生长模式。这种生长因为符合“准自由”生长条件,且其生长方向与一次外延层中位错的攀移方向相垂直,因而在生长过程中形成的缺陷密度大幅度下降。测试结果证明,二次外延层与一次外延层的缺陷密度可有数量级的差别。
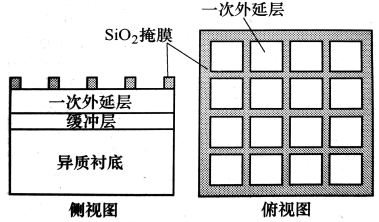
图2 ELOG法使用的衬底示意图
用HVPE法制备GaN单晶衬底的工艺比较简单,生产效率相对较高,是目前生长GaN体材料实用化程度最高的一种方法。目前已有Cree等多家企业开始小批量生产HVPE自支撑GaN单晶衬底,晶片直径可达50mm。同时,利用HVPE法生长GaN晶锭的研发工作也在这些企业和一些研究单位展开,成为GaN体单品生长技术的一个重要研发方向。
HVPE法也可以用来生长其他Ⅲ-N化合物及其固溶体 InGan等。不过,AlN和AlGaN的HVPF制备因AlCI在高温下与石英器皿有强烈化学反应而报道较少。
2. 高压氮气溶液生长法( HNPSG, High Nitrogen Pressure Solution Growth)
从熔体中生长GaN的困难在于N在Ga熔体中的溶解度很低,而GaN在熔化之前的较高温度下又很容易分解。所以,从熔体中生长GaN晶体的关键是提高N在Ca熔体中的溶解度。 HNPSG法通过提高氮气压力,在高温Ga熔体中溶入足够比例的N,然后通过降温或引入低温区形成N的过饱和Ga溶液,从而实现GaN单晶的液相生长。高压在此法中不但提高了N在Ga溶液中的溶解度,也起到了阻止GaN高温分解的作用。此法的生长温度一般为1300~1700℃,相应的N气压力为0.5~2.0GPa。进一步提高生长温度和压力可以提高熔体中的N/Ga比,譬如在6.0GPa氮气压力及2220℃的高温下,即可获得符合化学计量比的GaN熔体,这时即可通过缓慢降温使熔体结晶为GaN单晶。
用 HNPSDG法生长的GaN单晶品质较高,位错密度可达100/cm2以下。但此法需要高温高压条件,对设备要求苛刻,温度和压力的综合控制难度较大,目前还只能生长直径10mm左右的单晶薄片。
3. 助溶剂法(熔盐法)
与SiC液相外延时为了提高C在Si熔体中的溶解度而添加过渡金属Sc相类似,在Ga熔体中掺入Na、Li、K、Sn等金属或其化物,由于N在这些金属熔体或其盐熔体中的溶解度要比在Ga中的溶解度高得多,因而也可提高N在熔体中的浓度。这样,在较低的温度和氮气压力下即可进行GaN晶体的液相生长。其生长温度一般为600~800℃,氮气压力6~8MPa,添加剂的摩尔比一般为0.3~0.7。用NH3代替N2作为N源,可使生长压力降低。采用混合助溶添加剂,可以改善GaN生长晶体的品质。
4. 提拉法
提拉法是最经典的人工晶体生长方法。2000年,美国和俄罗斯的科学家首次报道了用石墨作籽晶从含N的Ga熔体中拉制较大尺寸GaN单晶体的消息。他们借助于助溶剂,在压力不超过2个大气压,温度不超过1000℃的条件下,以大约2mm/h的生长速率,成功制备了直径20mm,长15mm的GaN晶锭。为了实现和保持熔体中足够高浓度的N,除了添加助溶剂,用NH3或N2甚至它们的等离子体作为晶体生长的背景气氛,也是十分必要的。美国TDI公司还在熔体表面施加一定强度的电场(直流、交流或脉冲)来促进N在Ga熔体中的溶解。利用此法,他们在2001年10月宣布生长出世界上第一个直径35mm的GaN体单晶,其生长温度为1100℃,氮气压力为2个大气压,生长速率约为1mm/h。
GaN薄膜制备
HVPE法是最先用来生长GaN等Ⅲ-N化合物及其固溶体薄膜的方法,后因生长速率过快而难以控制,逐渐被分子束外延法(MBE)和金属有机物化学气相沉积法( MOCVD)所取代。其中,使用MBE制备Ⅲ-N化合物及其固溶体薄膜的时候,还开发了应用等离子体增强、电子回旋共振、超声喷射等活化氮源的新工艺,代表着当前Ⅲ-N化合物及其固溶体薄膜制备的发展方向;而 MOCVD则是目前公认的生长Ⅲ-N化合物及其固溶体薄膜的最佳方法。不过,就目前情况而言,即便是 MOCVD也还在一定程度上存在着生长温度偏高、生长缺陷偏多、生产效率偏低等不足,有待改进。
GaN等Ⅲ-N化合物及其固溶体薄膜制备的最大困难还是缺乏同质衬底。异质衬底使用最普遍的是蓝宝石,尽管它与Ⅲ-N化合物的晶格失配与热失配率都不低,与GaN的晶格失配率将近15%,必须使用过渡层;同时蓝宝石衬底不导电,难以制作纵向电极,而且解理也比较困难。但是,与GaN晶格失配较低的AlN和6H-SiC目前价格太高,难以广泛进入商业应用。其他材料,如ZnO、MgO,LiGao2(尖晶石)等与GaN的晶格失配也很低,可选作衬底,只是也存在这样那样的问题。
