典型的GaN制备工艺步骤:
·衬底清洗:(H2SO4:H2P04=3:1)中刻蚀约20min,去离子水冲洗,N2气吹干;
·衬底预热:800℃,暴漏在氨流中5-15min完成氨化;
·缓冲层AlN沉积:衬底温度800℃,铝源温度1070℃,氮源氨气的流量16SCCM;
·生长i-GaN:衬底温度降到700℃,镓源970℃,氨气流量35SCCM(5*E16cm-3);
·生长隔离层AlGaN:衬底温度800℃,Ga源温度970℃,Al源温度1070℃,氨气9SCCM,它可以阻止施主层掺杂的硅原子扩散进入沟道界面,同时提供N-AlGaN的生长条件;
·生长N-AlGaN:硅源温度1230℃。
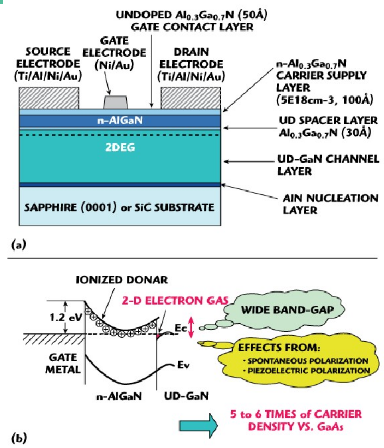
GaN HEMT器件的研制包括以下主要工艺步骤:
(1)标准清洗工艺,采用有机、无机溶液清洗去除材料沾染的油脂、颗粒和氧化层,在此过程中可辅助超声清洗的方法,清洗之后在热氮气吹扫下用甩片机甩干。
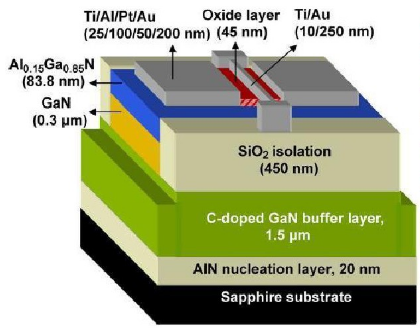
(3)器件隔离工艺,器件隔离工艺是为了使圆片上的各个器件在电学上相互隔开,互不影响。离子注入能量很高,为保护器件有源区,需要事先淀积一层SiN做保护层,离子注入区由光刻形成,注入离子为B+。
(4)栅工艺,由光刻形成栅条窗口,再由电子束蒸发多层金属,通过剥离来完成栅的制作。
当然,经过多年的技术发展, GaN HEMT器件结构不断改进,目前的GaN HEMT器件工艺远比上述工艺步骤复杂。
