为了抑制栅极泄漏电流,AlGaN/GaN HEMT常引入栅下绝缘介质,构成金属-绝缘体-半导体(MIS)结构,这样能大大提高器件的栅压摆幅、微波功率性能以及器件的可靠性。采用MIS结构的AlGaN/GaN MIS-HEMT的发展趋势是采用高介电常数K值的绝缘介质材料,这是因为根据平行板电容的原理,相同厚度的绝缘介质条件下,其介电常数K值越高,栅极电容越高,栅极对沟道的控制能力越强,与栅电容成正比的直流跨导越大。但是这种高栅极电容又会对器件fT带来负面的影响。
针对这一问题,本文提出了一种可提高器件频率特性的具有复合栅介质层的AlGaN/GaN MIS-HEMT,在AlGaN/GaN MIS-HEMT中生长由不同介电常数的两层绝缘介质横向组成的复合栅介质层,使得栅下沟道在不同栅介质层界面产生电场峰值,在电场峰值处存在电子漂移速度的峰值,使电子在沟道整体的漂移速度增加,同时低介电常数栅介质层使栅电容减小,使器件的频率特性提升;而不同栅介质层界面产生的电场峰值使栅极漏边沿的电场峰值减小,能减小栅极漏边沿电场集聚导致的热电子效应、电流崩塌效应的影响。
1. 复合栅介质层AlGaN/GaN MIS-HEMT工作原理
本文将从复合栅介质层AlGaN/GaN MIS-HEMT与常规AlGaN/GaN MIS-HEMT栅级下方沟道横向电场分布以及栅下电子漂移速度的对比来解释复合栅介质层AlGaN/GaN MIS-HEMT的工作原理。
图1为复合栅介质层结构的AlGaN/GaN MIS-HEMT的结构图,具体结构和材料参数见表1。
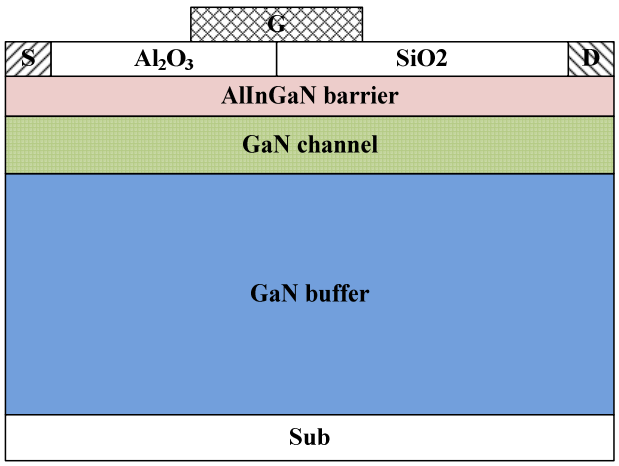
图1 复合栅介质层AlGaN/GaN HEMT结构图
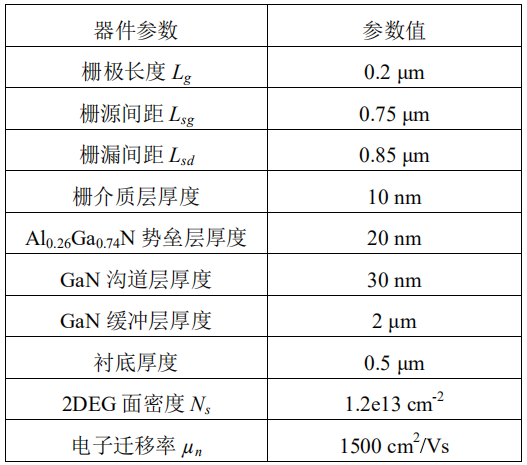
表1 复合栅介质层AlGaN/GaN MIS-HEMT结构和材料参数表
由于复合栅介质层AlGaN/GaN MIS-HEMT的栅下绝缘材料的介电常数K值不同,在高K和低K值的绝缘材料界面处,垂直于界面方向的电位连续,但相应的电场强度由于介电常数的不同存在一个非连续性的跃变,通过电场高斯定律,2种材料的电场关系可由下式表示:
ε1E1n=ε2E2n (1)
其中ε1和ε2分别为高K和低K介质的介电常数,E1n和E2n分别为高K和低K介质材料中垂直于界面方向的电场强度,这一电场强度的跳变将对下方半导体材料沟道中的电场分布产生影响,对界面正下方横向沟道电场起到一个抬升的作用,出现一个横向的电场尖峰。
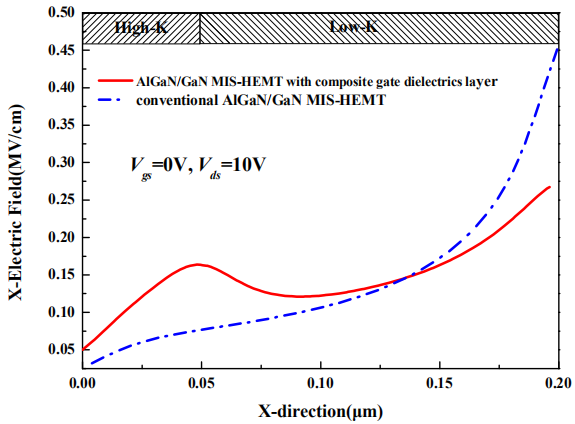
图2 复合栅介质层AlGaN/GaN MIS-HEMT栅下沟道横向电场分布
图2为复合栅介质层AlGaN/GaN MIS-HEMT栅下沟道横向电场分布,此时栅极电压Vgs=0V,漏极电压Vds=10V。如之前分析的一样,复合栅介质层中Al2O3和SiO2界面间产生一个电场峰值,同时相较于常规AlGaN/GaN MIS-HEMT,栅极漏边沿的电场峰值大幅减小,使栅极漏边沿电场集聚引起的热电子效应、电流崩塌效应减小,有助于提高器件的可靠性。
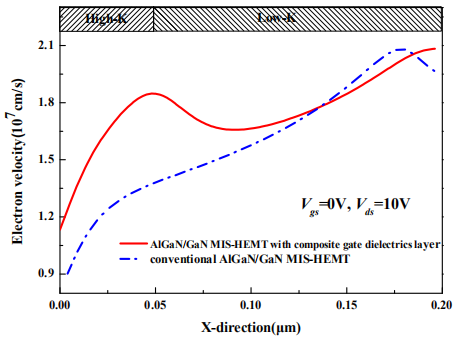
图3 复合栅介质层AlGaN/GaN MIS-HEMT栅下沟道电子速度分布
图3为同偏置下的复合栅介质层AlGaN/GaN MIS-HEMT栅下沟道电子漂移速度分布,在图2所示的电场峰值处,出现电子漂移速度的峰值,说明电子在栅极源端的初始速度得到提高,使得电子在栅极下方整体的平均漂移速度得到提升,提高了沟道的传输效率。
2. 复合栅介质层对AlGaN/GaN MIS-HEMT电学特性的影响
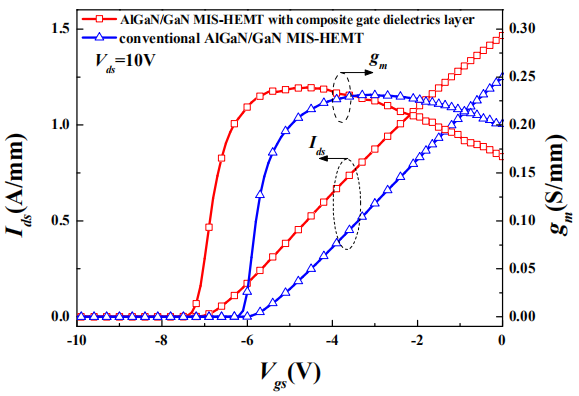
图4 复合栅介质层AlGaN/GaN MIS-HEMT转移特性
图4为复合栅介质层AlGaN/GaN MIS-HEMT与常规结构转移特性对比,漏极电压Vds固定在10V,栅极电压Vgs从-10V扫到0V。复合栅介质层AlGaN/GaN MIS-HEMT的阈值电压Vth为-7V,而常规结构为-6V,这是由于栅控能力与单位面栅电容成正比,而复合栅介质层中低K介质层存在使单位面积栅电容减小;但是在同样的过驱动电压(Vgs-Vth)下,二者的漏极电流Ids相同。同时,复合介质层AlGaN/GaN MIS-HEMT的峰值跨导gm,max为239mS/mm,相比常规AlGaN/GaN MIS-HEMT的峰值gm,max为231mS/mm,在单位面积栅电容减小的条件下,跨导并没有下降,反而略有上升,这是上一节所提到的复合栅介质层改善沟道电子传输效率的结果。
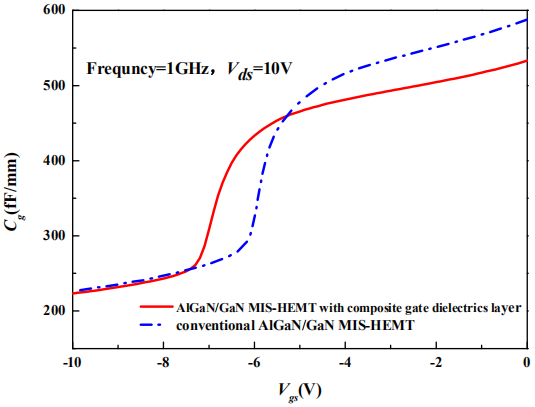
图5 复合栅介质层AlGaN/GaN MIS-HEMT的C-V转移特性
图5为复合栅介质层AlGaN/GaN MIS-HEMT与常规结构转移特性对比,漏极电压固定为Vds=10V,扫描频率为1GHz。由于低K栅介质层的存在,复合栅介质层AlGaN/GaN MIS-HEMT的栅极电容Cg为533fF/mm,相比常规结构的588fF/mm,下降了9.4%。
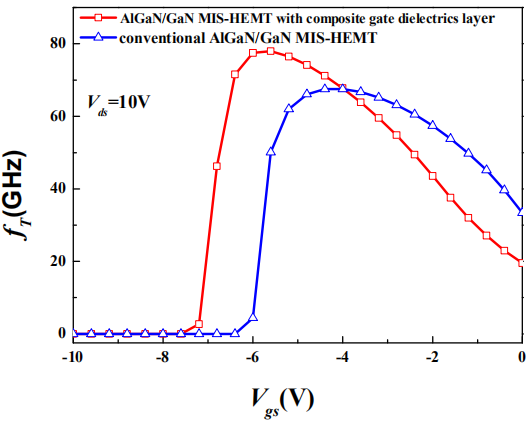
图6 复合栅介质层AlGaN/GaN MIS-HEMT的频率特性
图6为复合栅介质层AlGaN/GaN MIS-HEMT与常规结构的频率特性对比,漏极电压固定为Vds=10V,可见2个器件的fT分别在Vgs=-5.6V和 Vgs=-4 V 时取到最大值,其中复合栅介质层AlGaN/GaN MIS-HEMT的峰值fT为78GHz,相比常规结构的67.5GHz,提高了17%,这是由于fT可简单地用fT=gm/(2π·Cg)来表示,fT的提升主要得益于栅电容的减小。
