1. 复合势垒层GaN HEMT短沟道效应抑制机理
复合势垒层的AlGaN/GaN HEMT结构由两种不同Al组分的AlGaN材料构成,Al组分相对较低的AlGaN材料嵌入在Al组分相对较高的AlGaN材料中间,并位于栅极与漏极之间。由于两种AlGaN材料的Al组分不同,它们与GaN沟道层的极化强度不同,导致其下方沟道的2DEG浓度不同,因此构成了LDD(low-density drain)结构,能够有效地调节横向沟道电场分布,使器件击穿电压得到提高,同时由于未使用场板结构,也不会引入额外的电容。
另外, 将低Al组分的AlGaN材料从栅漏区域移到栅极正下方区域,左边沿与栅极源边沿对齐,右边沿不超过栅极漏边沿,此时由于Al组分的不同,栅下GaN沟道的导带底呈阶梯式分布,由于势垒的下降使沟道载流子的漂移速度增加,产生漂移速度的峰值与电场的峰值,调节栅下沟道电子输运效率,并使栅下电势更多地分布在器件漏端,以减小DIBL效应。图1为抑制短沟道效应的复合势垒层的结构图,具体结构和材料参数见表1。
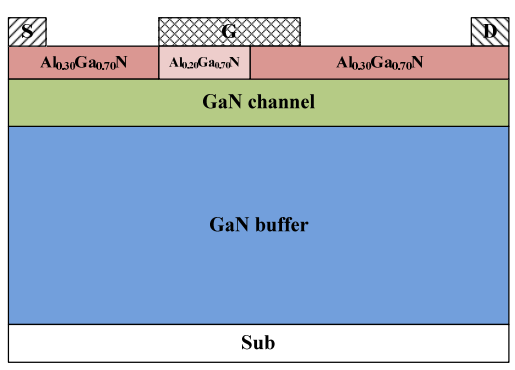
图1 抑制短沟道效应的复合势垒层AlGaN/GaN HEMT结构图
表1 复合栅介质层AlGaN/GaNMIS-HEMT结构和材料参数表
表1 复合栅介质层AlGaN/GaNMIS-HEMT结构和材料参数表
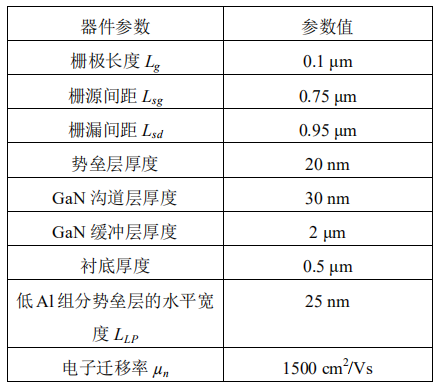
抑制短沟道效应的复合势垒层AlGaN/GaN HEMT与常规AlGaN/GaN HEMT除了势垒层构成外,其他材料与结构参数完全相同。抑制短沟道效应的复合势垒层AlGaN/GaN HEMT的复合势垒层材料的分别为Al0.30Ga0.70N和Al0.20Ga0.80N,其中Al0.20Ga0.80N层左边沿与栅极源端对齐,水平长度LLP为25nm;常规结构的AlGaN势垒全部为Al0.30Ga0.70N。
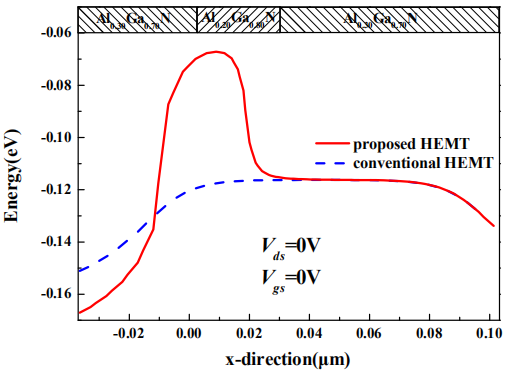
图2 抑制短沟道效应的复合势垒层AlGaN/GaN HEMT沟道层横向导带示意图
图2为零偏置下抑制短沟道效应的复合势垒层AlGaN/GaN HEMT沟道层横向导带示意图。由于AlGaN材料的禁带宽度为AlN和GaN材料禁带宽度通过线性插值而来,因此当势垒层Al组分不同时会使栅下沟道层处的导带底形成一个台阶形的势垒分布,电子在通过栅下沟道时会通过该势垒而获得加速。
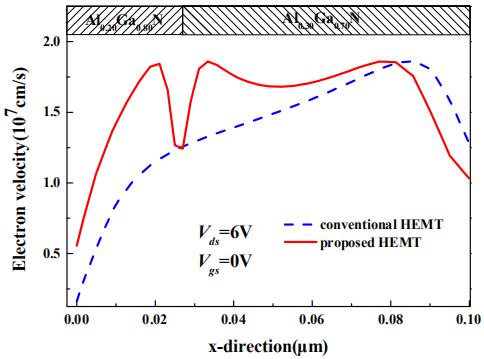
图3 抑制短沟道效应的复合势垒层AlGaN/GaN HEMT沟道层横向导带示意图
图3为抑制短沟道效应的复合势垒层AlGaN/GaN HEMT沟道层电子速度分布图,此时Vds=6V,Vgs=0V。如上图1分析的,由于通过一个的势垒下降,电子漂移速度在复合势垒的界面处存在一个峰值,使电子在整个栅下的平均漂移速度得到提高。
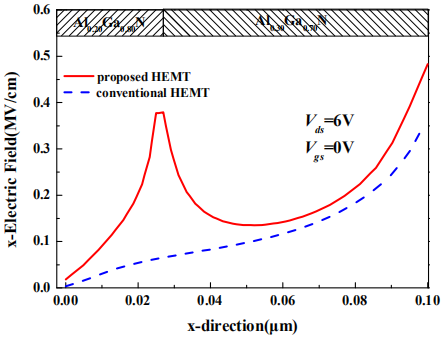
图4 抑制短沟道效应的复合势垒层AlGaN/GaN HEMT沟道层横向电场分布图
图4为抑制短沟道效应的复合势垒层AlGaN/GaN HEMT沟道层横向电场分布图,此时Vds=6V,Vgs=0V。由于电子漂移速度的峰值使沟道横向电场在复合势垒层界面存在电场峰值,这个电场峰值使栅下电势分布更平均,而不是只落在栅下漏端。
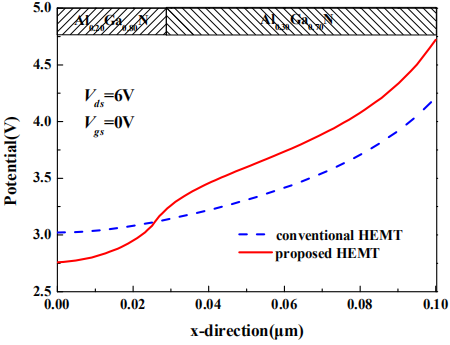
图5 抑制短沟道效应的复合势垒层AlGaN/GaN HEMT沟道层横向电势分布图
图5为抑制短沟道效应的复合势垒层AlGaN/GaN HEMT沟道层横向电势分布图,由于图3中的电场峰值存在,电势分布呈阶梯分布,说明电势更多地落在了栅极的漏端而不是整个栅极上,使漏至势垒下降效应(DIBL)的影响下降,达到减轻短沟道效应的作用。通过(1)式,取Vds,linear=0.5V,Vds,sat=6V,所得的常规GaN-HFET的DIBL值为50.2mV/V,抑制短沟道效应的复合势垒层AlGaN/GaN HEMT的DIBL值为27.3mV/V,相比常规结构下降了45.5%,说明对DIBL的抑制作用明显。

2. 抑制短沟道效应复合势垒层 AlGaN/GaN 器件的电学特性
对抑制短沟道效应的复合势垒层AlGaN/GaN HEMT的直流特性和频率特性进行仿真说明抑制短沟道效应的复合势垒层对AlGaN/GaN HEMT器件特性的影响。

图6 抑制短沟道效应的复合势垒层AlGaN/GaN HEMT与常规结构转移特性对比
图6为抑制短沟道效应的复合势垒层AlGaN/GaN HEMT与常规结构转移特性对比,由于复合势垒层结构在栅下的势垒层中引入低 Al 组分势垒层,使栅下沟道2DEG 减少,使复合势垒层AlGaN/GaN HEMT的阈值电压相较常规结构向正向漂移,将二者实际的栅极电压归一化,取(Vgs-Vth)为横轴,得到二者的转移特性几乎重合,同时抑制短沟道效应的复合势垒层AlGaN/GaN HEMT的跨导略有提高。
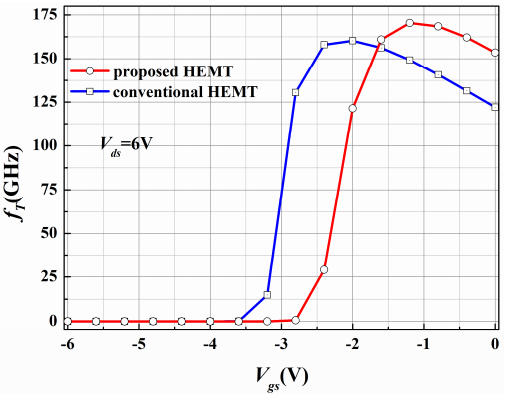
图7 抑制短沟道效应的复合势垒层AlGaN/GaN HEMT与常规结构C-V特性对比
图7为抑制短沟道效应的复合势垒层AlGaN/GaN HEMT与常规结构频率特性对比,Vds=6 V。抑制短沟道效应的复合势垒层AlGaN/GaN HEMT的峰值 fT在Vgs=-1.2 V 处取得为 170.4 GHz,相比常规结构的160.2 GHz(在 Vgs=-2V处取得),提高了6.4%,主要也是得益于跨导的提高和栅电容的减小。
