本文提出的AlGaN/GaN MIS-HEMT就是基于这种GOI结构,通过极化工程来耗尽栅下沟道的2DEG,以实现增强型工作。
1. 基于GOI技术的增强型AlGaN/GaN MIS-HEMT器件建模
图1为基于GOI技术的增强型AlGaN/GaN MIS-HEMT器件结构图,具体结构参数见表1。
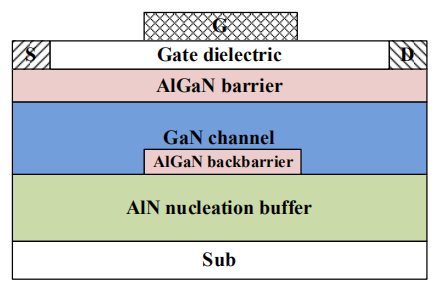
图1 基于GOI技术的增强型AlGaN/GaN MIS-HEMT结构图
表1 复合沟道层AlGaN/GaN MIS-HEMT结构和材料参数表

基于GOI技术的增强型AlGaN/GaN MIS-HEMT与基于GOI技术的常规器件除了采用AlGaN背势垒层外,完全相同。AlGaN背势垒的Al组分与AlGaN势垒层的Al组分相同,其生长在AlN成核缓冲层上,位于栅极正下方区域,与栅极完全对齐。采用MIS结构,主要是增强型结构需要在栅极上加上较高的正偏压,传统的肖特基结构在正偏压会开启导通,所以为了提高栅压的应用范围采用了MIS结构。
2. 基于GOI技术的增强型AlGaN/GaN MIS-HEMT电学特性
基于GOI技术的增强型AlGaN/GaN MIS-HEMT原理主要是由于AlN成核层结构多为非晶结构,本身不具备极化效应,因此可在AlN成核层上生长一层具有极化效应AlGaN背势垒,来达到实现极化工程,耗尽耗尽栅极下方沟道2DEG的效果,以实现增强型工作。AlGaN势垒层与GaN沟道层的界面由于极化效应会产生净的正极化电荷,GaN沟道层与AlGaN背势垒的界面会产生净的负极化电荷,通过调节AlGaN背势垒和AlGaN势垒层的Al组分,当二者Al组分相同时,正的极化电荷和负的极化电荷数相同,达到电荷平衡,使栅极下方沟道处2DEG耗尽,实现增强型工作。
这样实现的增强型结构基于GOI工艺实现相对简单,相比薄势垒结构能达到更高的阈值电压和最大饱和漏电流,同时无需掺杂,避免了掺杂所带来的缺陷等影响。相比氟离子注入、凹栅结构等后工艺实现方法,本发明避免了对完成后的器件造成损伤,提高了器件可靠性。
图2为零偏置下基于GOI技术的增强型AlGaN/GaN MIS-HEMT器件栅下垂直方向的导带图,可见基于现有的常规GOI技术的GaN MIS-HFET的沟均在费米能级EF以下,表现为常开型器件;而本发明提供的增强型GaN MIS-HFET的沟道导带底在费米能级EF以上,说明其势垒层和复合沟道层的极化强度相抵消,能够实现常关型工作。
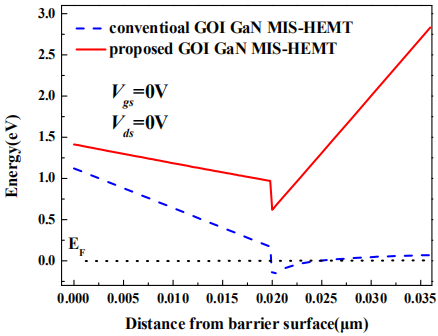
图2 基于GOI技术的增强型AlGaN/GaN MIS-HEMT栅下垂直方向的导带
图3为基于GOI技术的增强型AlGaN/GaN MIS-HEMT的转移特性,其中Vds=5V,Vgs从0V扫到5V。在引入AlGaN背势垒层之后,通过转移特性外推得到的阈值电压VT为1.8V,说明器件实现了增强型工作。
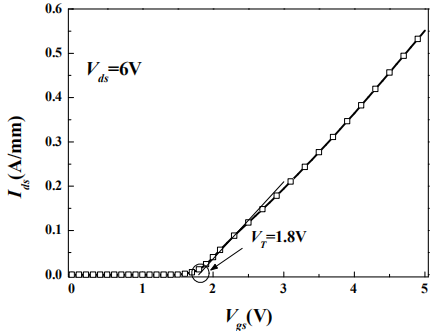
图3 基于GOI技术的增强型AlGaN/GaN MIS-HEMT的转移特性
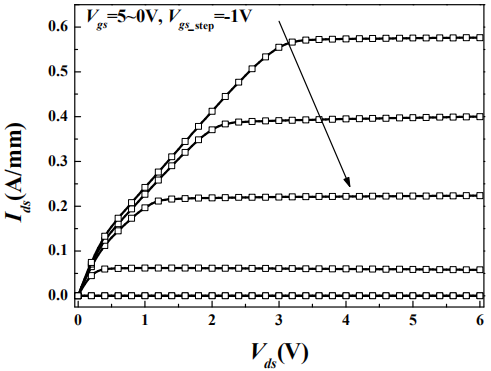
图4 基于GOI技术的增强型AlGaN/GaN MIS-HEMT的输出特性
图4为复合沟道层AlGaN/GaN MIS-HEMT的输出特性,其中Vds从0V到6V,Vgs从0V变化到5V,步长为1V。可见,复合沟道层AlGaN/GaN MIS-HEMT的最大饱和漏极电流为570mA/mm,满足应用的需要。
