本文在6H-SiC衬底上插入了高温AlN缓冲层和3层梯度AlxGa1-xN(x=0.8,0.5,0.2)缓冲层,并通过改变AlGaN缓冲层的生长温度和氨气流量的方法做了两组对比实验,显著改善了GaN薄膜中的应力状态,获得了高质量的GaN外延层。实验中对GaN外延层的晶体质量、表面形貌以及光学性质进行了相关表征。结果表明,随着外延层中张应力的降低,GaN外延层的晶体质量、表面形貌以及光学性质都有了显著提高。
1. 实验
本文采用金属有机物化学气相沉积系统(MOCVD,Aixtron)在6H-SiC衬底上制备GaN外延层。三甲基镓(TMGa)、三甲基铝(TMAl)和氨气(NH3)作为镓源、铝源和氮源,氢气(H2)作为载气。样品结构如图1所示。外延生长之前,首先在1150℃下用H2对样品进行热处理300s,随后在1080℃和10kPa压力条件下生长100nm的AlN缓冲层,在AlN缓冲层上制备3层梯度AlxGa1-xN缓冲层(Al0.8Ga0.2N、Al0.5Ga0.5N和Al0.2Ga0.8N厚度均为50nm),最后在AlGaN缓冲层上生长1.5µm厚的GaN外延层。为了验证梯度AlGaN缓冲层对GaN薄膜结晶质量和膜内应力的影响,在保证AlN缓冲层和GaN外延层生长条件一致的前提下,我们通过改变AlGaN缓冲层的生长温度和氨气流量做了两组对比实验(实验系列Ⅰ和Ⅱ)。在实验Ⅰ中,在氨气流量为133.8mmol/min的条件下,S1、S2和S3三个样品的Al-GaN缓冲层生长温度从1090℃升高到1110℃。
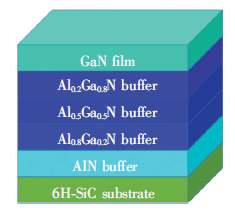
图1 样品结构示意图
在实验Ⅱ中,在实验Ⅰ中最优的AlGaN生长温度条件下,S4和S5样品的氨气流量从44.6mmol/min变化到223.1mmol/min。生长参数如表1所示。
表1 两组实验的生长参数
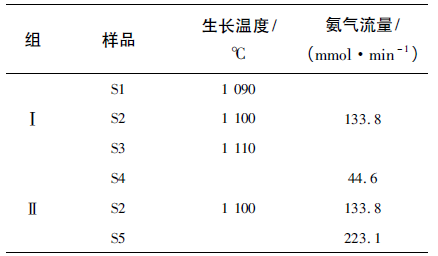
3. 结果与讨论
众所周知,(0002)面的摇摆曲线半峰宽与薄膜内的螺位错密度相关,(10`12)面的摇摆曲线半峰宽与薄膜内的刃位错密度相关,根据下列公式可以计算样品的位错密度:

表2 样品的摇摆曲线半峰宽和位错密度

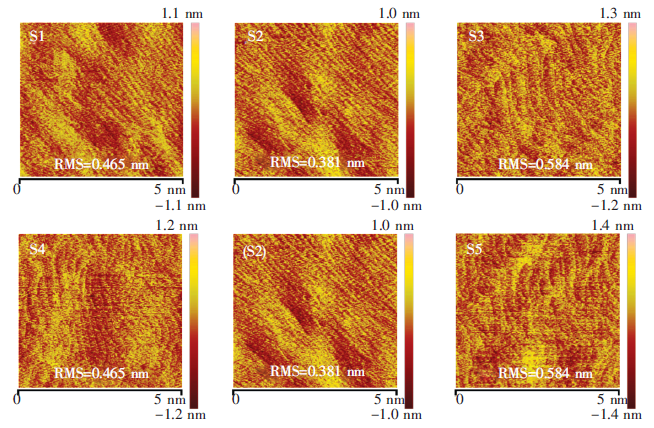
图2 不同AlGaN生长条件下GaN薄膜的AFM照片
图3为样品的光致发光谱。从图中可以看到,每个样品都存在一个365nm附近的近带边发光峰和一个550nm附近的黄带发光峰。近带边发光峰和黄带发光峰的强度比值(INBE/IYL)反映样品的光学性质。通过对比发现,样品的光致发光谱的变化趋势(图3)与样品结晶质量的变化趋势相同(表2)。当AlGaN缓冲层生长温度为1100℃、氨气流量为133.8mmol/min时,样品的光学性质最好(INBE/IYL比值最大)。目前对于GaN薄膜的黄带发光峰的来源存在不小的争议,很多研究组都认为碳杂质、碳杂质相关的复合以及薄膜中的刃位错密度都与GaN薄膜内黄带的来源有关。通过实验发现,当薄膜中刃位错密度降低时,INBE/IYL比值增大,样品的光学特性变好,这个结论也恰好印证了前文提到的GaN薄膜中的黄带发光峰与膜内刃位错密度的相关这个理论。
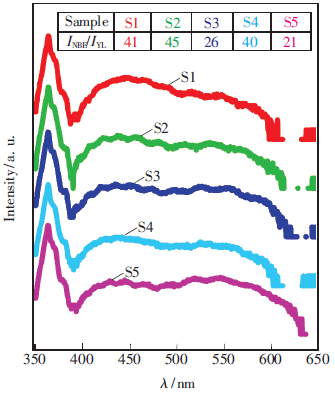
图3 不同AlGaN生长条件下GaN薄膜的PL谱
由于GaN薄膜和SiC衬底间存在一定的晶格失配和较大的热失配,所以在降温过程中,会引入较大的张应力,进而对材料性能、器件性能以及可靠性等造成显著影响。如何降低GaN薄膜中的应力是GaN材料研究的重要课题。为了表征不同AlGaN缓冲层生长条件对GaN薄膜应力的影响,我们对样品进行了常温拉曼光谱测试。
在拉曼光谱中,GaN E2(high)模的振动频率对膜内的双轴应变十分敏感。如图4(a)所示,若E2(high)模的振动频率发生红移则表明薄膜内部受到张应力,若E2(high)模的频率发生蓝移则表明薄膜受到压应力。当GaN薄膜内部应力完全弛豫时,对应的E2(high)模的频率为568.0cm-1。如图4(b)所示,各个样品的E2(high)模的频率分别为566.561,566.961,565.384,565.534,565.332cm-1。通过公式(3)可以计算出薄膜中的应力值:
Δω=kσ, (3)
其中,Δω为GaN E2(high)振动频率的变化值,k为线性系数(-3.4cm-1/GPa),σ为应力。根据公式计算出各个样品的应力,分别为0.42,0.31,0.77,0.73,0.78 GPa,如图4(c)所示。从以上数据可以得出,所有样品均处于张应力状态。Taniyasu等人曾指出薄膜内的刃位错密度是导致张应力产生的因素之一,这跟我们的研究结果是相同的,即薄膜内刃位错密度越低(表2),薄膜中的张应力越小(图4)。
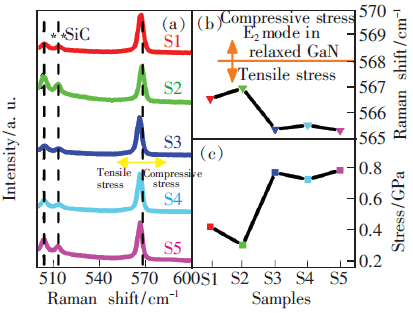
图4 不同AlGaN生长条件下的GaN薄膜的拉曼位移(a)、峰位移动(b)和应力值(c)。
4. 结论
采用金属有机物化学气相沉积系统在SiC衬底上生长了GaN薄膜,并研究了梯度AlGaN缓冲层的生长条件对GaN外延层性质的影响。通过两组对比实验发现,在1100℃、氨气流量为133.8mmol/min条件下生长AlGaN缓冲层,GaN(0002)和(10`12)面的摇摆曲线半峰宽值最小,分别为191arcsec和243arcsec,薄膜螺位错密度和刃位错密度分别为7×107cm-2和3.1×108cm-2。在最优的AlGaN生长条件下,GaN表面粗糙度为0.381nm,光学质量最佳。拉曼光谱数据分析表明,通过优化AlGaN缓冲层生长条件可以降低薄膜内的张应力。当薄膜内张应力降低时,样品的晶体质量、表面形貌和发光特性均有所改善。
