采用MOCVD外延生长时,可以通过改变成核层的生长参数,例如生长压力、载气类型以及生长温度等,在GaN层中引入较高密度的ETD。这堅ETD在GaN缓冲层中起电子陷阱和对背景电子的补偿作用,通过这些减少导带电子浓度的作用可实现高阻GaN材料。这就是GaN材料中引入结构缺陷实现高电阻率材料的方法。然而,研究表明,GaN缓冲层中的高穿透位错密度(TDDs)可能会导致反向偏置栅漏电流的增加,GaN材料中的陷阱和TDD也会降低AlGaN/GaN HEMT器件的可靠性。因此,人们迫切希望有一种更可靠的实现高阻GaN材料的方法,这种方法既不太降低材料结构的完整性,又能获得满足使用要求的高阻GaN材料。这种方法即是在GaN材料中通过有意掺杂引入电子陷阱或受主能级的方法。这种方法的关键是选择合适的杂质。有人在GaN缓冲层中有意接入Fe,Mg,C等受主杂质,并进行了相关研究。发现Mg的杂质激活能较高,需要较高浓度的掺杂,容易导致GaN晶体质量的恶化,并且Mg掺杂存在“记忆效应”;C掺杂虽然不存在“记忆效应”,但只有在低压低温条件下才有利于C杂质的掺入,这同样会降低GaN外延材料的结晶质量;Fe的激活效率远高于Mg,不需要太高的掺杂浓度,也不会严重影响材料的性能,因此,Fe是较为合适的形成高阻GaN材料的杂质。本文选用Fe作为受主杂质,补偿GaN/蓝宝石衬底界面处的n型区,提出了在GaN/蓝宝石衬底附近调制掺杂GaN缓冲层的方法。
为了研究Fe掺杂浓度对GaN材料电阻的影响,我们用MOCVD技术生长了图1所示的Fe掺杂单层GaN材料样品。用2英寸C面(阳001]晶向)蓝宝石作为衬底材料,三甲基镓(TMGa)和高纯氨气(NH3)分别用作镓(Ga)源和氮(N)源,二茂铁(Cp2Fe)作为铁(Fe)掺杂源。生长过程中以H2作为载气。

图1 Fe掺杂单层GaN材料样品结构示意图
在蓝宝石衬底上生长单层GaN的时序图如图2所示。
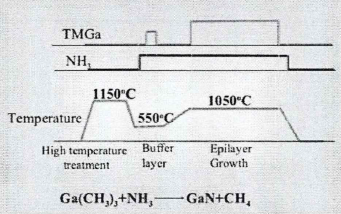
图2 在蓝宝石衬底上生长单层GaN的时序图
首先在H2气氛下升温并保持在1150℃约3min,对蓝宝石衬底进行高温处理;然后将温度降至约550℃生长约50nm的低温GaN成核层;接着升温至1050℃,生长单层GaN,生长速率为1µm/h。在生长该GaN单层时,采用Fe调制掺杂的方法,即起初生长的150nm GaN接Fe,然后关掉Fe掺杂源,再生长1.8µm的GaN外延层。最后得到图1所示的单层GaN材料样品结构。
为了研究不同Fe掺杂浓度对GaN材料电阻率的影响,我们通过改变Fe源的流量,生长了相同结构但不同Fe掺杂浓度的样品。在蓝宝石衬底上共生长了6炉单层GaN材料样品,Fe源的流量依次为0sccm、11sccm、55sccm、110sccm、220sccm和300sccm。
2. Fe掺杂单层GaN材料的性能表征
本部分内容对上文所生长的单层GaN材料样品的电学性能、表面形貌、掺入的Fe原子浓度和结晶质量等进行了分析表征,得到了高质量Fe掺杂高阻GaN材料生长的工艺条件,为Fe掺杂高阻缓冲层AlGaN/GaN HEMT结构材料的生长和器件制备打下了基础。
生长的第1炉样品为非有意掺杂样品,单层GaN材料的生长速率为3.49µm/h(0.97nm/s),生长50min;GaN层厚度为2.91µm。样品号分别为BR301、BR302和BR303。对样品BR302,垂直于定位边取上、中、下三个点,分别测量该三点GaN层的(002和(102)X射线衍射峰的半高宽(FWHM),并表示为(002)衍射峰FWHM@(102)衍射峰FWHM,则结果如图3所示。

图3 非有意掺杂GaN样品BR302上三点的(002)和(102)的FWHM
可见三点(002)衍射峰FWHM在218.2arcsec和229.0arcsec之间,(102)衍射峰FWHM在377.6arcsec和413.2arcsec之间。Hall效应测量结果表明,该非有意掺杂GaN样品为n型,背景电子浓度为3.09×1016cm-3,电子迁移率为224.3cm2/V·s,方块电阻为2429欧姆/方块(Ω/sq)。显微镜观测表明,样品表面境面光亮,观测不到任何特征。下面,我们将从此炉样品的测试结果出发,对比研究不同Fe流量的掺杂对样品性能的影响,旨在得到高结晶质量的Fe掺杂高阻样品的生长工艺条件。
生长的第2炉样品为有意掺杂样品,Fe源的流量为11sccm,有意Fe掺杂层的厚度为200nm,样品号为BR304、BR305和BR306。对BR305样品进行X射线衍射测试,所得结果如图4(a)所示。由图可见,样品上三点XRD(002)衍射峰的FWHM在202.0arcsec和209.7arcsec之间,(102)衍射峰的FWHM在317.9arcsec和372.2arcsec之间。

图4(a) Fe掺杂GaN样品BR305上三点的(002)和(102)的FWHM;Fe掺杂源的流量为11sccm
对第2炉生长的三个样品进行了方块电阻测试,三个样品BR304、BR305和BR306的平均方块电阻分别为2078、1993和2008Ω/sq,其中测得的样品BR305的方块电阻分布图如图4(b)所示。三个样品的平均方块电阻均约为2000Ω/sq,远未达到高阻材料的要求。

图4(b) 样品BR305的方块电阻测试结果
生长的第3炉样品的Fe源的流量为55sccm,样品号为BR307、BR308和BR309。对样品BR307进行X射线衍射测试表明,样品上三点XRD(002)衍射峰的FWHM在205.7arcsec和238.7arcsec之间,(102)衍射峰的FWHM在344.5arcsec和350.9arcsec之间。对三个样品进行了方块电阻测试,测试结果表明BR307、BR308和BR309的平均方块电阻分别为4938、4989和5248Ω/sq。可见,第3炉样品的方块电阻与第2炉相比,有所增加。样品BR309的表面形貌显微镜照片如图5所示,样品表面镜面光亮,未观察到任何特征。

图5 样品BR309的表面形貌显微镜照片;Fe源流量为50sccm
为了进一步提高Fe掺杂GaN材料的方块电阻,在生长第4炉样品时,将Fe掺杂源的流量增加到了110sccm。第4炉三个样品的样品号分别为BR310、BR312和BR313。样品BR312上三点XRD(002)衍射峰的FWHM在229.3arcsec和238.2arcsec之间,(102)衍射峰的FWHM在317.7arcsec和334.9arcsec之间。对三个样品进行了方块电阻测试,测试结果表明BR307、BR308和BR309的平均方块电阻分别为10636、10265和11516Ω/sq。
生长第5炉样品时,Fe掺杂源的流量増加到220sccm,三个样品的样品号分别为BR313、BR314和BR315。样品BR315上三点XRD(002)衍射峰的FWHM在229.1arcsec和239.7arcsec之间,(102)衍射峰的FWHM在395.1arcsec和404.0arcsec之间。用方块电阻仪测得的BR313、BR314和BR315的平均方块电阻分别为556542、548807和424867Ω/sq。样品由方块电阻测试仪得到的样品BR313的方块电阻分布如图6(a)所示。

图6(a) 样品BR313的方块电阻分布图(b)划出的3个小方块样品
该炉样品的平均方块电阻在105Ω/sq的数量级,超出了方块电阻测试仪的量程,可能测量误差较大。为了准确得到该炉样品的方块电阻值,沿垂直于样品BR313的主定位边的方向划出3个小方块样品,如图6(b)所示,用电压-电流(I-V)法测试这3个小方块样品的电阻,测得结果如表1所示。
表1 用I-V法测得的样品BR313的电阻率

表2 用I-V法测得的样品BR31和BR320的电阻率
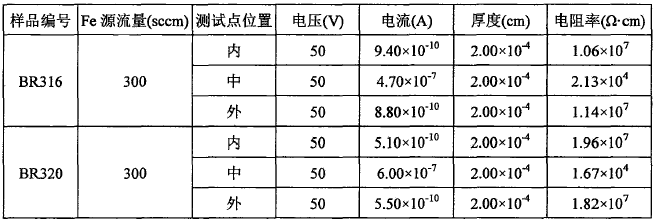
表3 样品BR317和BR320的XRD衍射峰FWHM测试结果


图7 SIMS测得的BR317样品中Fe、O、C杂质的深度分布图:Fe掺杂源的流量为300sccm,样品的电阻率为1.06×107Ω·cm
为了清晰起见,仅给出了从样品表面到2µm深度处的分布。SIMS测试结果表明,在GaN/蓝宝石界面处O杂质浓度高达8×1020cm-3,这可能是由蓝宝石衬底中的O扩散引起的。此高O原子浓度的薄层可能在界面附近引入附加导电电荷,导致缓冲层泄漏电流增加。在GaN/蓝宝石界面处,C杂质原子也具有较高的浓度,达1019cm-3的量级。SIMS测试结果还表明,当Fe掺杂源的流量为300sccm时,在GaN/蓝宝石界面处Fe杂质浓度高达1019cm-3;从2µm深度处到样品表面附近,Fe杂质原子浓度明显高于O杂质原子浓度。在样品表面,由于吸附等原因,C杂质和O杂质的浓度依然较高。表2给出的样品电阻率的测试结果表明,浓度高达1019cm-3的Fe足以补偿GaN的剩余电导率,使GaN材料的电阻率达到107Ω·m,呈现半绝缘特性。根据以上7炉生长实验的实验结果,可得Fe掺杂GaN材料的(002)和(102)XRD衍射峰FWHM与Fe掺杂浓度之间的关系如图8所示,电阻率与Fe掺杂浓度之间的关系如图9所示。我们获得了Fe掺杂高阻GaN材料,电阻率达到107Ω·m的数量级,方块电阻达到1011Ω/sq的数量级,已能满足制备Fe掺杂缓冲层GaN基HEMT器件的要求。下面,我们将用此Fe掺杂高阻GaN缓冲层研制GaN基HEMT结构材料。

图8 Fe掺杂GaN材料的(002)和(102)XRD衍射峰FWHM与Fe掺杂浓度么间的关系
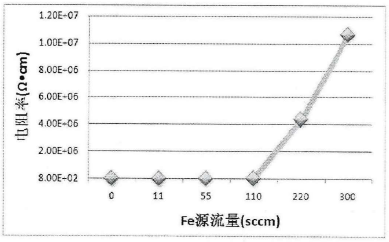
图9 GaN材料电阻率与Fe掺杂浓度之间的关系
