生长图1所示的GaN基HEMT结构材料,所用衬底为蓝宝石衬底,生长步骤如下:
(1)首先在约50℃低温生长一层厚度为50nm的GaN成核层;
(2)然后升温到1050℃生长一层150nm厚的Fe调制掺杂GaN层,Fe源流量为300sccm;
(3)接着关闭Fe掺杂源,生长1.8µm厚的GaN层;
(4)改变生长条件,生长90nm厚的高迁移率GaN层;
(5)生长约1nm厚的ALN插入层;
(6)生长约23nm的AlGaN势垒层,Al组分设计为0.24;
(7)最后生长一层约3nm的非有意掺杂GaN帽层。
高迁移率GaN沟道层和AlN插入层被用于进一步提高材料的2DEG迁移率为了研究比较Fe掺杂髙阻GaN缓冲层和非故意掺杂高阻GaN缓冲层对器件性能的影响,我们也生长了HEMT结构样品B,除高阻缓冲层外,样品B其它各层的厚度和生长条件设计与样品A完全相同。
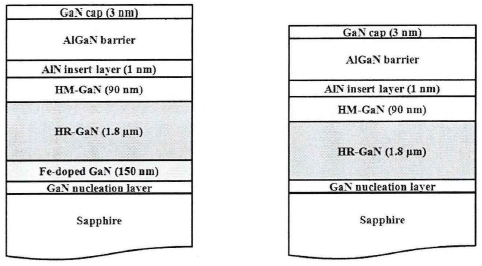
图1(a) HEMT结构样品A的结构 (b)HEMT样品B的结构
2. HEMT结构的XRD表征
为了确定两个样品中AlGaN势垒层中的Al组分,对样品A和B进行了三轴HR-XRDω-2θ扫描测试,测试结果如图2所示。经拟合计算样品A和样品B的Al组分分别为0.23和0.25。
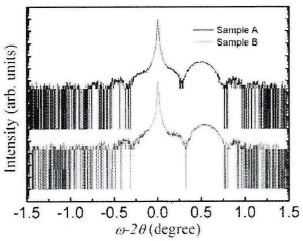
图2 样品A和B的三轴HR-XRD扫描ω-29曲线
为了确定样品A和B的AlGaN层的厚度,对其进行了XRR测试,测得的结果和拟合结果如图3所示。可见,两样品均有强周期性振荡(接近20个kiessig条纹)。经拟合计算得到样品A和B的AlGaN势垒层的厚度分别为22.5nm和23nm。
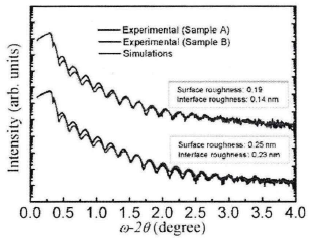
图3 样品A和B的XRR扫描曲线
从样品A和样品B的XRR测试结果,还可以经过拟合得到两个样品的表面粗糙度和AlGaN/GaN界面的粗糙度。经模拟得到样品A的表面和界面粗糙度分别为0.19和0.14nm,样品B为0.25和0.23nm。表明生长的两个样品都都具有优良的界面和表面平整度,为2DEG迁移率的提高和后续的器件工艺提供了良好条件。
为了分析高阻GaN缓冲层的晶体质量,分别对样品A和样品B的(001)和(102)X射线衍射峰的半高宽(FWHM)进行了测试,测试结果如图4和图5所示。

图4 样品A和样品B的(0002)面的FWHM图5样品A和样品B的(10-12)面的FWHM
螺型位错密度(SDDS)对(0002)面的FWHM影响很大,SDD和ETD都对(10-12)面的FWHM影响很大。样品A和样品B的SDD的计算值分别为7.87×107cm-2和1.46×108cm-2。样品A和样品B的ETD的计算值分别为9.9×108cm-2和7.78×109cm-2。与非故意掺杂高阻GaN缓冲层相比,Fe掺杂高阻GaN缓冲层中的刃位错密度低了接近一个数量级。因此可见,Fe掺杂高阻GaN缓冲层具有更好的结晶质量。据此推测,Fe掺杂高阻GaN缓冲层上的HEMT器件应该具有更好的性能。
3. HEMT结构的AFM测试结果
为了分析样品A和B的表面形貌,用原子力显微镜(AFM)分别对两个样品的表面进行了观测,测得结果如图6(a)和图6(b)所示。样品A和样品B的均方表面粗糙度分别为0.227和0.256nm,与图3的XRR测试结果高度一致。另外,从图6(a)和图6(b)可明显看到两个样品表面清晰的原子台阶。图中的小黑点为位错,可明显看到样品A中的位错少于样品B中的位错。

图6(a) HEMT结构样品A的表面原子力显微镜照片 (b) HEMT样品B的表面原子力显微镜照片
4. HEMT结构的方块电阻
用方块电阻测试仪对样品A和B的方块电阻及方块电阻均匀性进行了测量,测量结果如图7(a)和(b)所示。测得样品A和B的方块电阻(RSH)分别为348Ω/sq和373Ω/sq,片内不均匀性分别为0.71和1.63。

图7(a) HEMT结构样品A的方块电阻测试结果 (b)HEMT结果样品B的方块电阻测试结果
5. HEMT结构的霍尔测量结果
为了获得HEMT结构样品的2DEG浓度和迁移率,我们对两个样品分别进行了室温(300k)霍尔测试,测得样品A的2DEG面密度为8.07×1012cm-2,迁移率为2503cm2/V·s;样品B的2DEG面密度为8.15×1012cm-2,迂移率为1926cm2/V·s。样品A(Al组分为0.23,势垒层厚度22.5nm)相对于样品B(Al组分为0.25,势垒层厚度为23nm)具有较低的2DEG面密度,可能与其具有更小的Al组分和更薄的AlGaN势垒层有关。样品A的2DEG迁移率高于样品B,可以解释为位错、界面粗糙度、合金无序、极性光学声子和声学声子等散射减少的综合作用。我们还进行了理论研究,发现降低ETD可以有效提高μ2DEG。
