处于底层的缓冲层的结晶质量在很大程度上反映了异质结外延材料的结晶质量,缓冲层中的位错会在后续的生长过程中继续向上延伸,甚至穿透表面,对材料的结晶质量、表面形貌、电特性等造成极大影响,进而使器件特性恶化。因此,优化缓冲层的结晶质量就显得尤为重要。XRD摇摆曲线测试发现,含有7%Al组分AlGaN缓冲层的(0002)和(102)半宽分别为289arcsec、556arcsec,高于GaN缓冲层的(0002)和(10-12)半宽,说明双异质结构中Al0.07Ga0.93N缓冲层的结晶质量较差。
为了提高Al0.07Ga0.93N缓冲层的结晶质量,减小位错密度,本文提出了采用双层材料的缓冲层结构,即GaN+AlGaN缓冲层,如图1所示。生长过程为采用MOCVD设备在c面蓝宝石衬底上生长100nm AlN成核层,在其上生长700nm GaN缓冲层再生长600nm Al0.07Ga0.93N缓冲层,紧接着生长沟道层、插入层、势垒层及帽层,样品编号为DH2。为了进行比较也生长了以1.3µmAl0.07Ga0.93N为缓冲层的双异质结材料,样品编号为DH1。迄今为止,与AlGaN外延层相比,GaN外延层的生长工艺条件更为成熟,结晶质量更好,位错密度更低。因此,利用GaN结晶质量更好的特点在其上外延较低Al组分的AlGaN层能够减小缓冲层中的位错密度。
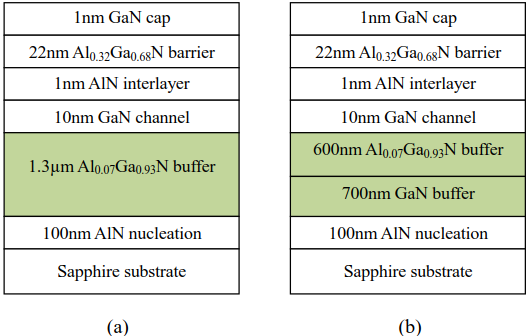
图1 不同缓冲层结构示意图,(a)AlGaN缓冲层(DH1),(b)GaN+AlGaN缓冲层(DH2)
2. 样品的XRD研究
样品DH1和DH2的区别仅在于缓冲层结构的不同,通过XRD对两个样品进行(0002)面ω-2θ扫描,结果如图2所示。
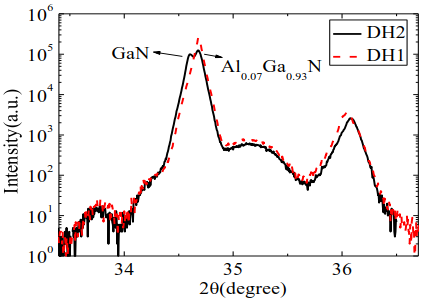
图2 样品(0002)面的XRD(ω-2θ)扫描结果
图2中除了Al0.32Ga0.68N势垒层和AlN成核层的峰位之外,样品DH2的ω-2θ扫描结果中出现了双峰,即GaN和Al0.07Ga0.93N的峰位,分别位于34.605°和34.680°。样品DH1中由于只存在1.3µm Al0.07Ga0.93N缓冲层,故ω-2θ扫描结果中仅有一个Al0.07Ga0.93N峰位,位于34.685°,与样品DH2中的Al0.07Ga0.93N峰位基本重合。样品DH2中双峰的出现说明GaN层和其上生长的Al0.07Ga0.93N层界面清晰,生长结果较好。
图3是由XRD测得的两个样品(0002)面和(10-12)面的摇摆曲线,为了便于比较和观察曲线的半高宽(FWHM),我们将两样品摇摆曲线的角度和强度均进行了归一化处理,从而得到如图3所示的摇摆曲线。从图3(a)可以看出,样品DH2(0002)面的摇摆曲线同样出现了双峰,分别为GaN和Al0.07Ga0.93N的峰位。经过拟合得到样品DH2中GaN缓冲层和Al0.07Ga0.93N缓冲层(0002)面的半高宽分别为165arcsec和158arcsec,高于样品DH1中纯Al0.07Ga0.93N缓冲层(0002)面的半高宽102arcsec。图3(b)中,经过拟合样品DH1和DH2(10-12)面的半高宽分别为1195arcsec和788arcsec。因此,采用GaN与Al0.07Ga0.93N双层缓冲层后,虽然(0002)面半高宽有所增大,但是(10-12)面半高宽大大减小。
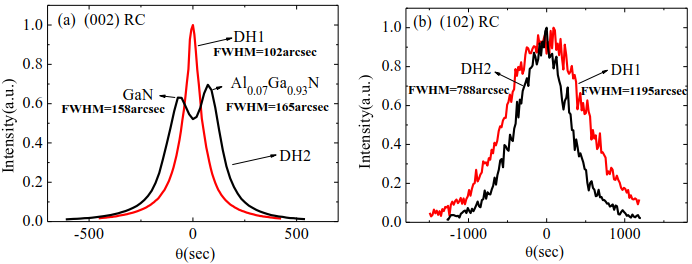
图3 样品的(0002)和(10-12)面的摇摆曲线
由于X射线衍射的摇摆曲线的半高宽能够反映晶体的结晶质量,对于理想的晶体来说,各晶面衍射峰的FWHM值非常小。但是,实际生长过程中外延层存在的非均匀应变和位错分布等会加宽摇摆曲线的半高宽,其中位错是造成半高宽增大的主要因素。因此我们可以用XRD测量得到的摇摆曲线的FWHM值反映位错密度,(0002)面和(10-12)面的半高宽分别能够反映样品中螺位错和刃位错密度的大小。双层缓冲层虽然使螺位错密度增大,但是仍然处于可接受的范围,更为重要的是刃位错密度明显减小,基本上与蓝宝石衬底上采用GaN缓冲层的常规单异质结材料的结晶质量达到同一水平。因此,整体上来说采用GaN和Al0.07Ga0.93N两层缓冲层结构能够有效提高材料的结晶质量。
为了确定该实验中双层缓冲层样品DH2内部的应变状态,用XRD扫描该样品(10-15)面的倒易空间图,如图4所示。GaN缓冲层、Al0.07Ga0.93N缓冲层、Al0.32Ga0.68N势垒层以及AlN成核层的峰位都清晰可见,而且仍然出现了GaN缓冲层和Al0.07Ga0.93N缓冲层的双衍射花样,两者的连线垂直于qx轴,说明两层缓冲层是完全应变的。另外,Al0.32Ga0.68N顶势垒层与缓冲层也是完全应变的。

图4 双层缓冲层样品DH2(10-15)面的RSM图
3. 样品的表面形貌和电特性研究
为了研究不同缓冲层结构对材料表面形貌的影响,我们用原子力显微镜(AFM)对两种样品进行测试,AFM能够在纳米量级直观、高分辨地表征材料的表面特性。图5(a)、(b)分别为样品DH1和样品DH2的表面形貌图,扫描范围为5×5µm2。从图中可以看出,与样品DH1相比,样品DH2表面的原子台阶更清楚,表面黑点也明显减少。样品DH1和DH2的表面均方根粗糙度RMS分别为0.286nm和0.281nm,表面起伏分别为4.042nm和2.571nm。外延层中底层的位错线会在后续的生长过程中继续向上延伸,甚至穿透表面,AFM形貌图中的黑点就表示了部分穿透表面的缺陷。采用双层缓冲层以后,底层GaN缓冲层中的位错密度较低,向上延伸的位错线就较少,从而使得整个材料的表面粗糙度减小,黑点数目减少,表面形貌变好。

图5 (a)样品DH1的表面形貌,(b)样品DH2的表面形貌
通过XRD和AFM测试后我们发现,采用双层缓冲层结构的样品DH2结晶质量提高,位错密度减小,表面粗糙度减小,这就会使材料中2DEG的电特性增强,如表1所示。使用非接触Hall效应测试仪得到样品DH2的2DEG迁移率达到了1752cm2/Vs,远远高于仅使用AlGaN缓冲层的样品DH1的迁移率(1508cm2/Vs)。同时结晶质量提高后,样品DH2的2DEG面密度增加到1.06×1013cm-2,方阻降为354Ω/□,方阻均匀性也提高到1.95%,反映了整个外延材料均匀性的提高。
对位错的研究显示,材料中的刃位错会影响AlGaN/GaN界面2DEG的迁移率。在刃位错处,刃口上的原子共价键不饱和,易于俘获电子成为受主中心,在带负电的位错线周围形成了一个圆柱形正空间电荷区,这些正电荷是电离了的施主杂质,而这个圆柱形空间电荷区就是引起载流子散射的附加势场,位错散射概率与位错密度有关。由于样品DH2的刃位错密度大大降低,这就导致对载流子的位错散射减弱,迁移率提高。同时,AFM测试结果表明表面粗糙度减小,因此界面粗糙度散射降低也对迁移率的升高有一定作用。
表1 室温下样品的电特性测试结果