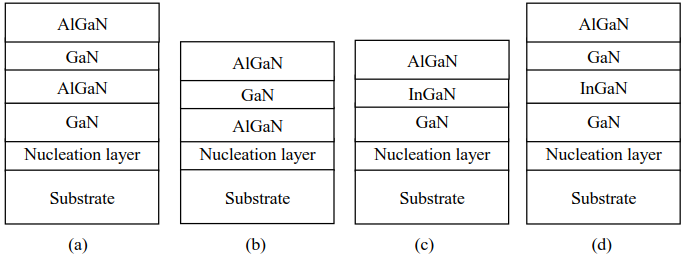
图1 四种常见的GaN基双异质结构示意图
本文将通过自洽求解一维薛定谔方程/泊松方程对这四种AlGaN/GaN双异质结构的能带图和载流子分布进行仿真,分析各种结构的机理和优缺点。
1. AlGaN/GaN/AlGaN/GaN双异质结构
该双异质结构在常规AlGaN/GaN异质结构的沟道下方插入一薄层AlGaN背势垒层,由于GaN与AlGaN之间的带隙差和极化效应,沟道下方的势垒高度显著提高,载流子限域性明显提高,抑制了沟道中的2DEG溢出到缓冲层中,其能带结构如图2所示。
由于强的极化效应,分别在两个AlGaN/GaN异质结界面处形成了两个量子阱(主量子阱和次量子阱),载流子将主要分布在这两个量子阱之中,形成双导电沟道(分别为主沟道和寄生沟道)。在高温、高压等条件下,寄生沟道中少量的二维电子气很容易溢出到GaN缓冲层中成为低迁移率的三维电子,影响器件的关断特性和输运特性,使得器件I/V特性曲线线性区变差,因此寄生沟道的存在是AlGaN/GaN/AlGaN/GaN双异质结构最大的缺点。
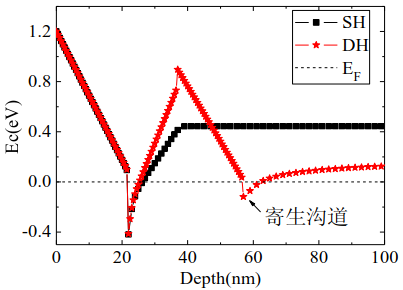
图2 AlGaN/GaN/AlGaN/GaN双异质结构与能带图
通过自洽求解一维薛定谔/泊松方程仿真发现,AlGaN背势垒层的Al组分和厚度对载流子的限域性和密度有着显著的影响。随着背势垒层Al组分的提高和厚度的增加,主沟道的载流子限域性逐渐增强,主沟道中的2DEG面密度逐渐减少,更为严重的是寄生沟道2DEG面密度逐渐增加,这会对材料和器件性能带来不利影响。因此在AlGaN/GaN/AlGaN/GaN双异质结构的设计中,需要对主沟道2DEG限域性和寄生沟道载流子密度进行折中考虑,得到适合的背势垒层Al组分和厚度。
为了抑制寄生沟道的产生,国际上常用渐变Al组分的方法。将背势垒层的Al组分从高到低渐变直到GaN缓冲层,这样可以显著减小寄生沟道中2DEG的密度,提高材料和器件性能。
2. AlGaN/GaN/AlGaN双异质结构
虽然采用渐变Al组分方法可以大大减小AlGaN背势垒双异质结构中寄生沟道载流子的密度,但是并不能完全消除。AlGaN/GaN/AlGaN双异质结构直接在AlN成核层上生长较厚的AlGaN缓冲层,不仅完全消除了寄生沟道的影响,载流子限域性也显著提高。为了获得更高的2DEG密度,就需要提高势垒层Al组分。但是当势垒层Al组分大于40%时,由于晶格失配过大而容易导致裂纹的产生。在AlN上直接生长的AlGaN缓冲层厚度达到几百纳米甚至微米量级的时候,其晶格就会完全弛豫,在其上生长的GaN沟道层受到压应变,因此AlGaN势垒层Al组分可以做的更高,已有报道采用AlN作为势垒层的AlN/GaN/AlGaN双异质结构。
图3为AlGaN/GaN/AlGaN双异质结构的能带图和2DEG分布图,其中仿真采用的AlGaN顶势垒Al组分为32%,厚度为22nm,沟道厚度为10nm,AlGaN背势垒Al组分为7%。可见,背势垒7%的Al组分就可以显著提高沟道下方的势垒高度,2DEG被限制在一个较深的势阱中,阻止2DEG溢出到缓冲层。传统的AlGaN/GaN异质结沟道靠近衬底一侧的势垒高度大约只有0.07eV,而当该双异质结构背势垒Al为7%时,该势垒高度就达到了0.62eV。而且,随着背势垒Al组分的增加,该势垒高度显著增加,2DEG量子阱越来越窄,载流子限域性越来越高。由于生长在较厚的AlGaN缓冲层之上的GaN沟道层受到压应力,减弱了材料表面附近AlGaN/GaN异质结中的压电极化,因此该双异质结构2DEG密度略低于常规的AlGaN/GaN异质结构。
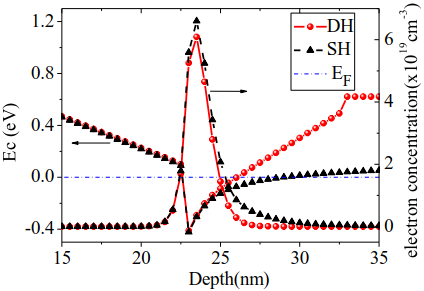
图3 AlGaN/GaN/AlGaN双异质结构能带和2DEG分布示意图
近年来,AlGaN/GaN/AlGaN双异质结构由于其优良特性得到了广泛关注,这种结构的材料与HEMTs器件特性也取得了很大进步,被认为是较为理想的双异质结构,因此这种结构也是本文的研究重点。然而,高Al组分、厚AlGaN缓冲层的材料生长仍然不易获得,其结晶质量依然较差。
3. AlGaN/InGaN/GaN双异质结构
传统的AlGaN/GaN异质结构采用GaN作为沟道材料,AlGaN势垒层厚度越薄,越能抑制短沟道效应的发生。但是AlGaN越薄,也会导致很多问题,如2DEG密度降低、电流崩塌现象等。为了在两者之间达到平衡,人们提出了InGaN沟道双异质结。由于InGaN具有更窄的禁带宽度,AlGaN/InGaN界面具有更大的导带断续和更强的压电极化效应,而且InGaN中压电极化占主要地位,所以导致AlGaN/InGaN/GaN双异质结构的极化电荷密度更大,能够获得更高的2DEG密度。据报道,在相同条件下,在AlGaN/GaN界面处嵌入InGaN沟道层,2DEG的密度比传统的AlGaN/GaN异质结提高了50%。另外,AlGaN/InGaN界面处大的导带断续造成很深的电子势阱,从而使2DEG限域性显著增强,图4为AlGaN/InGaN/GaN双异质结构的能带图与载流子分布图。

图4 AlGaN/InGaN/GaN双异质结构的能带图与载流子分布图
由图4可见,在传统的AlGaN/GaN异质结界面插入厚度为20nm、In组分为10%的InGaN作为沟道层时,双异质结中势阱和GaN缓冲层之间形成了一个很高的势垒,这一势垒有效提高了2DEG的限域性。同时,由于更大的导带断续和更强的压电极化,双异质结具有更高的2DEG密度。虽然理论上InGaN沟道比GaN沟道的性能更为优越,如更高的2DEG迁移率和面密度,但是由于InN的分解温度(~500℃)明显低于GaN的生长温度(~1050℃),生长过程中容易造成In的析出,而且InGaN的生长速率比GaN慢得多,因此很难获得高结晶质量、高In组分的InGaN材料。InGaN沟道中较高的缺陷密度严重影响了2DEG迁移率,已有报道InGaN沟道双异质结材料的2DEG迁移率仅为820cm2/Vs。正是由于生长困难使得InGaN材料的优越性能并不能完全体现出来,这也是众多研究者一直以来需要克服的困难。
4. AlGaN/GaN/InGaN/GaN双异质结构
为了克服AlGaN/InGaN/GaN双异质结构中InGaN沟道层较差的结晶质量给2DEG迁移率带来的不利影响,提出了采用InGaN作为背势垒的AlGaN/GaN/InGaN/GaN双异质结构,其能带图如图5所示。
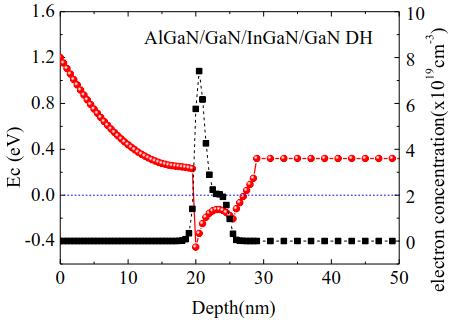
图5 AlGaN/GaN/InGaN/GaN双异质结构能带图与载流子分布图
由于InGaN层的压电极化方向与AlGaN相反,使得InGaN插入层和GaN缓冲层界面处的导带断续增大,2DEG沟道下方的势垒高度升高,2DEG限域性增强,从而阻止了载流子溢出到缓冲层。另外,由于极化效应在GaN沟道层和InGaN背势垒层界面处也形成了一个非常小的次沟道,该沟道中的载流子限域性较差,很容易运动到主沟道中参与导电。与AlGaN/GaN/AlGaN/GaN双异质结构不同,InGaN背势垒双异质结构中的两个沟道是相互连通的,整个导电沟道被扩展,次沟道并没有给材料和器件的电特性带来不利影响。由于这种结构依然采用GaN作为主沟道层,2DEG的迁移率并没有恶化。但是,InGaN插入层的厚度要求比较薄,以达到较高的背势垒高度,以及防止In的析出。
