与其它场效应管、晶体三极管等器件不同,HEMTs器件制造工艺更为简单。除了在每步工艺之前有表面清洗和处理等工艺之外,AlGaN/GaN HEMTs器件制造工艺主要包括台面隔离刻蚀、漏源区欧姆接触、肖特基栅接触,以及后续的表面钝化和加厚电极。图1为HEMTs制备工艺流程示意图。下边对这几种主要的工艺步骤分别介绍。
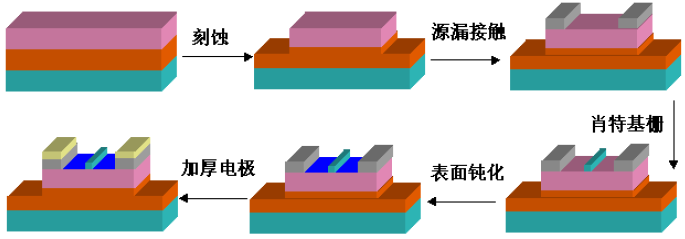
图1 HEMTs制备工艺流程示意图
(1)刻蚀
刻蚀是实现有源区隔离的常用方法,也是半导体器件制备中很重要的工艺步骤,分为湿法刻蚀技术和干法刻蚀技术两种。在湿法刻蚀的过程中,通常使用特定的溶液与需要被刻蚀的薄膜材料进行化学反应,进而除去没有被光刻胶覆盖区域的薄膜,以完成转移掩膜图案到薄膜上面的目的。湿法刻蚀的优点是工艺简单,可以控制刻蚀溶液的化学成分,刻蚀的选择性好,但是会形成各向同性的刻蚀效果,无法满足对加工精细线条的要求。由于GaN材料的性质极稳定,其键能达到了8.92eV,在室温下不溶于水、酸和碱,在热的酸碱溶液中溶解速度非常缓慢,因此采用湿法刻蚀技术的刻蚀速率非常慢、可控性也较差,实践中多采用干法刻蚀技术。干法刻蚀是利用等离子体激活的化学反应或者是利用高能离子束轰击完成去除物质的方法。在干法刻蚀中,纵向上的刻蚀速率远大于横向的刻蚀速率。与湿法刻蚀相比,干法刻蚀技术具有各向异性、可对多种材料进行刻蚀、均匀性和重复性好、易于实现自动连续生产等优点。常用的干法刻蚀技术有Cl基反应离子刻蚀(RIE)、Cl基感应耦合等离子体刻蚀(ICP)、Cl基电子回旋共振等离子体刻蚀(ECR)等,其中ICP技术以其廉价的等离子体和高的刻蚀速率等特点受到了更多的关注。
(2)漏源区欧姆接触
漏源区欧姆接触质量的好坏决定着器件的接触电阻、电流密度、最高工作温度以及大功率性能等,因此也是制备高性能AlGaN/GaN HEMTs器件的关键工艺。通过电子束蒸发Ti、Al、Ni、Au、Pt、V等金属与AlGaN形成接触,然后在N2气氛下高温退火利用合金制作欧姆接触,选用的合金材料和退火温度对形成的欧姆接触特性有重要的影响。由于Ti的功函数很低,经过高温退火后,AlGaN中的N开始向Ti中进行扩散,反应生成TiN,同时使AlGaN中产生了大量起施主作用的N空位,形成n+层,从而使电子易于隧穿形成欧姆接触。通常在Ti/Al之上再覆盖一层Au加以保护,这是由于虽然Al能防止AlGaN中Ga的外扩散所导致的施主浓度降低,但Ti和Al容易被氧化而形成高阻氧化层,反而使接触电阻增大。中间的阻挡层常用W、Mo、Pt等。目前,常用的金属淀积工艺有电子束蒸发和磁控溅射等,常用的欧姆接触合金材料主要有:Ti/Al/Ni/Au,Ti/Al/Pt/Au和Ti/Al/Ti/Au等。
(3)肖特基栅接触
在AlGaN/GaN HEMTs器件中,栅漏电是低频噪声的主要来源,栅反向击穿电压决定着器件的工作电压和功率容限[4.7][4.8],因此栅极肖特基接触的质量好坏是决定器件性能的主要因素之一。GaN与金属形成的肖特基势垒主要是由功函数差决定,通常选用功函数较高的金属(Ni、Pd、Au等)来形成较高的肖特基势垒,也可以通过一定的表面处理和适当温度的退火来提高肖特基特性。Ni/Au是最常用于AlGaN/GaN HEMTs制造的肖特基接触金属。
(4)钝化
表面钝化能有效的抑制电流崩塌现象的出现,使得器件有更好的微波功率特性。淀积钝化层还能减少势垒金属延伸电极产生的寄生电容,削弱环境气氛对器件电特性的影响。目前钝化工艺常采用PECVD的方法,钝化的介质常选用SiNx、SiO2等材料。
2. AlGaN/GaN/AlGaN双异质结构HEMTs的制造工艺流程
通过第三章对各种AlGaN/GaN/AlGaN双异质结的材料分析后,我们得出AlGaN缓冲层双异质结构具有很好的材料性能。虽然缓冲层和沟道厚度优化后的双异质结构表现出了更为优越的性能,但都是在蓝宝石衬底上生长。因此我们选择生长在半绝缘SiC衬底上的样品(编号为DH)来制作器件,为了对比常规异质结构与双异质结构的器件性能区别,我们也选择了常规单异质结样品(编号为SH)制作器件。两个样品除了缓冲层材料不同外,其他结构均相同。
样品DH和SH的HEMTs结构示意图如图2所示,由第三章的材料测试结果可知,样品DH和SH的2DEG迁移率分别为1713cm2/Vs、1605cm2/Vs,2DEG面密度分别为8.48×1012cm-2、1.07×1013cm-2,方块电阻分别为372Ω/□、309Ω/□。
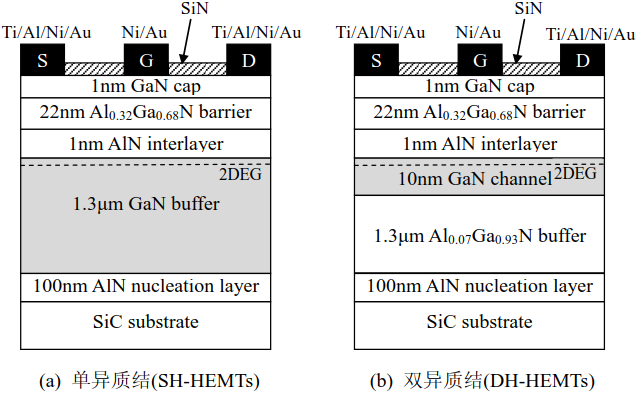
图2 AlGaN/GaN单、双异质结HEMTs结构示意图
在样品DH和SH上制作的HEMTs器件工艺流程完全一致,主要过程为:采用ICP干法刻蚀技术实现台面隔离,电子束蒸发Ti/Al/Ni/Au实现漏源区欧姆接触电极,在N2气氛中、温度为850℃快速热退火30s,淀积肖特基栅金属Ni/Au,最后用PECVD淀积氮化硅钝化层。制作完成的器件栅长LG=0.5μm,栅宽WG=100μm,栅漏间距LGD和栅源间距LGS均为1μm。
