1. 输出特性和转移特性
图1为AlGaN/GaN/AlGaN双异质结HEMTs器件(DH)和常规单异质结HEMTs器件(SH)的输出特性曲线和转移特性曲线。如图1(a)所示,输出特性曲线中栅极电压测试范围从-6V至2V,间隔1V,源极接地,漏压扫描范围为0~10V。从图中可以明显看出,双异质结HEMTs器件的电流密度小于常规异质结HEMTs器件。在栅压VG=2V时,双异质结HEMTs和常规单异质结HEMTs器件的漏极饱和电流密度分别为940mA/mm和1230mA/mm。图1(b)转移特性曲线中,漏压VD=10V,从图中可以看出双异质结器件跨导仍然小于常规异质结器件的跨导,跨导峰值分别为-2.2V时的220mS/mm和-3.22V时的240mS/mm。另外,单异质结器件的漏极电流在栅压为-4.66V时迅速增加,而双异质结器件漏极电流在栅压为-3.25V时迅速增加,反映出两种器件阈值电压Vth的差异。由于限域性的提高,双异质结材料的沟道变窄,再加上势垒层应变减小使得沟道中2DEG面密度降低,从而使双异质结HEMTs器件的饱和电流密度和跨导相对较低。双异质结沟道中较低的载流子密度,使其只需要一个不太大的栅极电压就可以耗尽沟道中的载流子,因此双异质结器件的阈值电压|Vth|更小。
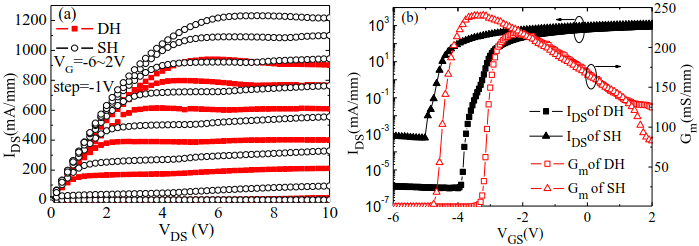
图1 双异质结HEMTs与常规单异质结HEMTs器件直流特性比较
(a)输出特性曲线;(b)转移特性曲线
(a)输出特性曲线;(b)转移特性曲线
虽然双异质结HEMTs器件的饱和电流密度和跨导均小于常规异质结器件,但对器件可靠性来说更为重要的是器件的关态漏电。如图1(b)所示,为了更加直观地分析两种器件关态漏电的大小,我们用对数坐标来表示漏极电流密度。当VGS=-6V、VDS=10V时,双异质结HEMTs器件和常规单异质结HEMTs器件的关态漏极泄漏电流分别为1.3×10-6mA/mm和7.5×10-4mA/mm,双异质结HEMTs器件的关态漏电比常规单异质结器件减小了将近两个数量级,这正是双异质结器件的优越性能之一。理论上,沟道关断后器件的漏极电流应该为零,但是由于载流子限域性较差以及缓冲层的不完全绝缘性,在高场下空间电荷区中的电子运动到缓冲层,造成软关断现象。由于双异质结中使用Al0.07Ga0.93N缓冲层,沟道下方背势垒高度显著提高,2DEG限域性增强,有效地抑制了沟道中的电子溢出到缓冲层中,从而减小了器件的关态漏电,提高了缓冲层隔离性能。
2. DIBL效应
为了提高GaN基HEMTs器件的工作频率,减小器件栅长是最有效的方法。但是当源和漏的耗尽区可以与沟道长度相比拟时,将发生短沟道效应,随着器件栅长的不断缩短,短沟道效应对器件性能的影响就会越来越严重。其中,漏致势垒降低效应(DIBL)就是在小尺寸器件中所出现的一种不良现象。沟道长度越短,DIBL效应越严重。DIBL效应往往与沟道长度调制效应同时发生,因为这些效应都是小尺寸场效应晶体管中容易出现的问题。
DIBL效应主要表现为当MOSFET器件的沟道很短时,漏PN结上的反偏会对源PN结发生影响,漏结与源结的耗尽层靠近,沟道中的电力线可以从源区穿越到漏区,并导致漏极势垒高度降低,从而使源区注入到沟道的电子数量增加,漏端沟道载流子浓度不再固定,漏极电流增加。可以用图2所示的半导体表面的能带图来说明,其中虚线表示VD=0的情形,实线表示VD>0的情形。对于长沟道MOSFET器件,漏端偏压能够改变有效沟道长度,但随着漏压的增大,漏端势垒高度保持常数。而在短沟道器件中,漏端势垒不再固定,漏压增大后,漏极势垒高度明显降低,就会使更多的载流子从源区注入到沟道中,因而导致电流显著增加。DIBL效应对短沟道器件的影响包括,阈值电压Vth发生漂移,亚阈电流IDsub与VDS有关,亚阈斜率S发生变化等。当沟道长度继续减小时,在亚阈区IDS-VGS曲线的斜率会减小,亚阈斜率S增大。达到极端情况时,即源和漏的耗尽层的宽度之和约等于沟道长度时,器件就会发生穿通,穿通的结果是在源和漏之间产生更大的漏电流,该电流是漏偏压的强函数,此时器件完全失去栅控,最终使器件无法截止。
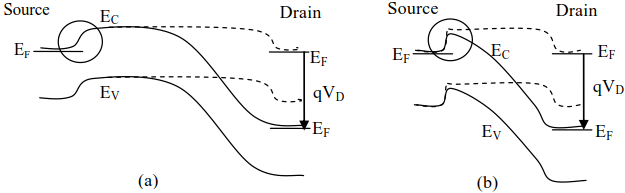
图2 半导体表面源到漏的能带图
(a)长沟道MOSFET;(b)短沟道MOSFET。后者表现出DIBL效应,虚线VD=0,实线VD>0
(a)长沟道MOSFET;(b)短沟道MOSFET。后者表现出DIBL效应,虚线VD=0,实线VD>0
DIBL效应不仅发生在短沟道MOSFET器件中,在后来的研究中发现GaN基HEMTs器件中也存在DIBL效应。图3所示为常规单异质结HEMTs器件和双异质结HEMTs器件在不同漏压下的转移特性曲线,测试漏压分别为5V、10V、15V、20V。DIBL系数定义为漏极电压的变化所引起的阈值电压的漂移量,即DIBL=ΔVth/ΔVD。从图中可以明显看到,随着漏源之间电压的不断增大,两种器件的转移特性曲线均向左移动,阈值电压都发生漂移。而且,常规单异质结HEMTs器件的转移特性曲线向左移动的偏移量更大,阈值电压漂移也更大,而双异质结HEMTs器件的阈值电压漂移量小得多。经过详细比较后得到,当漏源电压从5V增加到20V时,常规单异质结HEMTs器件的阈值电压漂移量高达1V,而双异质结HEMTs器件的阈值电压仅漂移了0.3V。因此,常规单异质结和双异质结HEMTs器件的DIBL系数分别为67mV/V和20mV/V,常规单异质结HEMTs器件的阈值电压漂移量是双异质结的3倍。

图3 不同漏压下的转移特性曲线,(a)常规单异质结HEMTs,(b)双异质结HEMTs
常规AlGaN/GaN单异质结构中沟道下方的势垒高度较低,2DEG限域性较差,如图4所示为常规异质结构中沟道电子注入缓冲层后导致能带结构的变化,在高的漏源电压下,常规单异质结HEMTs器件栅下方耗尽区中具有高能量的热电子更容易越过高度较低的势垒,进入GaN缓冲层,并且深入缓冲层深处,这就需要更高的栅压来关断器件,使得阈值电压更负。而双异质结HEMTs器件中沟道下方背势垒高度提高,载流子限域性增强,有效阻止了电子溢出到缓冲层,这就解释了双异质结HEMTs器件阈值电压漂移量较小的原因。这一点也可以通过图3中当栅压小于阈值电压的时候,常规单异质结器件的关态漏电更大来得到证实,与图1(b)结果分析结果一致。
当漏极电压为5V时,常规单异质结HEMTs器件与双异质结器件的关态漏电分别为0.099mA/mm和5.1×10-4mA/mm,相差两个数量级。当漏压从5V增加到20V,栅压VGS=-8V时,常规单异质结HEMTs器件的关态漏电从0.099mA/mm迅速增大到1.99mA/mm,增大了20倍,而双异质结HEMTs器件的关态漏电基本没有变化。对于常规的单异质结构,漏极电压越高,沟道中热电子具有的能量就越高,溢出到GaN缓冲层的几率越大,数量也越多,使得缓冲层漏电随着漏极电压的增大而增加。但是双异质结构中载流子限域性显著增强,即使在较高的漏极电压下,沟道下方较高的背势垒也能阻止沟道中的热电子溢出到AlGaN缓冲层,从而使得关态漏电并不随漏极电压的变化而变化。
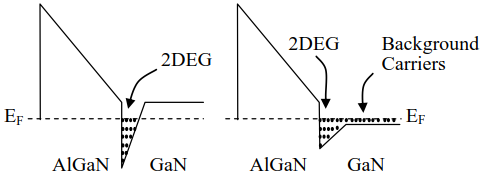
图4 常规单异质结构中沟道电子注入缓冲层前后能带结构的变化
(a)沟道电子注入缓冲层前的能带图;(b)沟道电子注入缓冲层后的能带图
亚阈斜率S定义为亚阈值区漏端电流增加一个数量级所需要增大的栅电压,反映了电流从关态到开态的转换陡直度,可表示为
 。由图3得出,当漏极电压VDS=5V、10V、15V、20V时常规单异质结HEMTs器件的亚阈斜率S分别为260mV/dec,310mV/dec,360mV/dec和520mV/dec,而双异质结HEMTs器件的亚阈斜率S分别为100mV/dec,114mV/dec,114mV/dec,119mV/dec。常规单异质结HEMTs器件的亚阈斜率S明显大于双异质结HEMT器件,而且常规异质结器件的亚阈斜率随着漏压增大而明显增大,双异质结器件的亚阈斜率随漏压变化较小,由此说明双异质结HEMTs器件的电流对栅控反应更为迅速,沟道关断特性更好,器件更容易关断,这正是由于双异质结构更好的载流子限域性所造成的。另外我们发现,虽然图3中得到常规单异质结器件和双异质结器件的关态漏电相差大约两个数量级,这与图1(b)所得结果一致,但是图1(b)中两种器件的关态漏电更小,这是由于测试时所选用的器件不同所造成的。短沟道器件中的DIBL效应不仅使器件的阈值电压降低,还会导致小尺寸器件的一系列问题,如电压增益下降、栅控能力减弱等,限制了器件向更小尺寸的发展和VLSI设计集成度的进一步提高,因此采用双异质结构减弱DIBL效应的影响也是双异质结HEMTs器件的优越性能之一,使几何上的短沟道器件能够保持电学上的长沟道特性。
。由图3得出,当漏极电压VDS=5V、10V、15V、20V时常规单异质结HEMTs器件的亚阈斜率S分别为260mV/dec,310mV/dec,360mV/dec和520mV/dec,而双异质结HEMTs器件的亚阈斜率S分别为100mV/dec,114mV/dec,114mV/dec,119mV/dec。常规单异质结HEMTs器件的亚阈斜率S明显大于双异质结HEMT器件,而且常规异质结器件的亚阈斜率随着漏压增大而明显增大,双异质结器件的亚阈斜率随漏压变化较小,由此说明双异质结HEMTs器件的电流对栅控反应更为迅速,沟道关断特性更好,器件更容易关断,这正是由于双异质结构更好的载流子限域性所造成的。另外我们发现,虽然图3中得到常规单异质结器件和双异质结器件的关态漏电相差大约两个数量级,这与图1(b)所得结果一致,但是图1(b)中两种器件的关态漏电更小,这是由于测试时所选用的器件不同所造成的。短沟道器件中的DIBL效应不仅使器件的阈值电压降低,还会导致小尺寸器件的一系列问题,如电压增益下降、栅控能力减弱等,限制了器件向更小尺寸的发展和VLSI设计集成度的进一步提高,因此采用双异质结构减弱DIBL效应的影响也是双异质结HEMTs器件的优越性能之一,使几何上的短沟道器件能够保持电学上的长沟道特性。