GaN材料的击穿场强达到了~3.5MV/cm,使其能更好地应用于高功率开关器件,但是开态传导损耗和关态击穿电压却限制了GaN基HEMTs器件的功率开关特性,因此在保持栅漏间距较小的条件下增大击穿电压是目前GaN基HEMTs功率开关器件发展的挑战之一。提高载流子限域性和缓冲层隔离效果对GaN基HEMTs器件的功率特性有着积极的作用,而且在高压工作环境下,缓冲层漏电比表面漏电对器件性能的影响更为严重,因此提高缓冲层隔离效果就显得尤为重要。
大多数情况下,GaN基HEMTs器件和其他场效应晶体管的击穿是由于栅耗尽区下方的电子电流流入到绝缘缓冲层中所引起的,即空间电荷注入到缓冲层中或电子溢出到缓冲层中,也称为缓冲层穿通效应。电子溢出到缓冲层以后会导致亚阈漏极泄漏电流的增大,最终使器件击穿。对于常规的GaN HEMTs器件,电子被沟道上方的AlGaN顶势垒层很好地限制,但是由于采用GaN缓冲层,沟道下方的势垒较低,载流子限域性较弱,电子很容易溢出到势垒较低的缓冲层中,即使在较低的漏压下器件也有可能被击穿。通常,抑制GaN HEMTs击穿现象发生的方法包括,在GaN缓冲层中进行p型掺杂,以及增加GaN缓冲层中的受主型缺陷密度。前两种方法都是在不改变材料结构的情况下进行的改进,另外一种方法就是采用新型的材料结构来提高击穿电压,如双异质结构,目前对于使用双异质结构提高击穿电压的报道也较多。2008年,德国的EldadBahat-Treidel等人在SiC衬底上制作的Al0.26Ga0.74N/GaN/Al0.1Ga0.9N双异质结HEMTs器件击穿电压达到了180V。2010年,他们将双异质结构与多栅场板结构(MGFPs)相结合将击穿电压提高到了700V。
本文分析的器件仍然是编号为SH和DH的两个样品,材料结构分别为AlGaN/GaN和AlGaN/GaN/AlGaN,衬底为半绝缘SiC,我们使用Agilent 1500A半导体参数分析仪,在栅压VGS=-8V时测试器件的关态击穿特性。通常定义漏极电流超过一定数值(如5mA/mm)时所对应的漏极电压为器件的击穿电压(Vbr)。
如图1所示为常规单异质结HEMTs和双异质结HEMTs器件的关态击穿特性,图中每种结构选取了四个器件得到一个较综合的结果,图中双异质结器件击穿后电流不再增大是由于测试时限流的原因,实际电流应急剧增大。从图中可见,器件关态时,随着漏压的增大,在一定电压附近两种异质结器件的漏极电流均急剧增大。若以漏极电流超过5mA/mm时的漏极电压定义为击穿电压,则常规单异质结HEMTs器件的击穿电压分布为48V、58.5V、58.5V、61.5V,平均56V;而双异质结HEMTs器件的击穿电压分布为97.5V、99V、102V、112.5V,平均102V,可见双异质结器件的击穿电压大约是单异质结器件的两倍。这是由于双异质结中沟道下方背势垒高度的提高有效抑制了2DEG溢出到缓冲层,减小了亚阈漏极泄漏电流,从而延迟了缓冲层穿通,使击穿电压显著增大。2008年,Eldad Bahat-Treidel等人通过模拟证实了关态时,在栅极电场的作用下传统单异质结器件GaN缓冲层中的电子浓度达到了~1015cm-3,而双异质结器件AlGaN缓冲层中电子浓度只有~107cm-3。两种结构击穿电压的不同也可以用过另外一种角度来解释,常规单异质结材料中的缓冲层为GaN,通过第三章的分析可知GaN缓冲层的结晶质量更好,其中的缺陷密度更低,因此缓冲层中电子迁移率更高,就会使整个材料的电导率更高,最终导致缓冲层漏电更大、击穿电压偏低,而采用AlGaN缓冲层的双异质结则相反。N空位和螺位错对缓冲层的电导率也有一定影响。
在漏源击穿测试之前和之后分别对器件进行直流特性测试,可以发现器件特性并没有恶化。当漏压恢复到低电位后,溢出到缓冲层的电子仍然可以恢复,也就是说漏源击穿属于软击穿,并不会对器件造成永久性的损伤。可见,使用AlGaN/GaN/AlGaN双异质结构提高击穿电压也是其优于常规单异质结构的特点之一,为了进一步提高击穿电压,提高缓冲层Al组分、采用场板结构等都是很好的方法。

图1 栅压VG=-8V时常规单异质结HEMTs和双异质结HEMTs器件的关态击穿特性
2. 栅漏击穿
上面是AlGaN/GaN HEMTs器件研究中更为常见的漏源击穿现象,除此之外,栅漏击穿是另外一种击穿现象。由于在我们的器件绝大部分都是漏源击穿,只有极个别器件是栅漏击穿,因此我们对栅漏击穿只做简单介绍。如图2所示为一个双异质结HEMTs器件的栅漏击穿测试结果,测试时栅压为-8V,当漏压增加到100V附近时,漏极电流和栅极电流迅速增大,而源极电流基本保持为0,为明显的栅漏击穿现象。
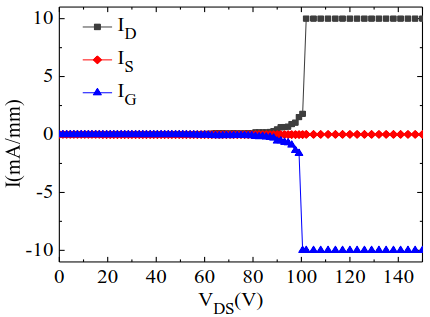
图2 双异质结HEMTs器件栅漏击穿测试曲线
器件栅漏击穿机制最普遍的解释是逆压电效应的影响。当AlGaN/GaNHEMTs器件的漏极偏压很高时,就会在栅边缘靠近漏区的地方产生一个很大的电场,那么势垒层中栅边缘靠近漏区的小区域内就会存在很大的机械应力,在电应力的作用下,如果AlGaN势垒层中积累的面内应力超过一个临界值,就会在栅边缘靠近漏区的高场区内产生晶体缺陷,这些能够导电的缺陷会使器件特性和可靠性严重恶化,最终导致器件发生栅漏击穿。我们认为,双异质结构中AlGaN缓冲层的引入使得生长在其上的GaN沟道层受到压应变,从而使顶势垒层的应变减小。与常规异质结相比,在相同的电压下,双异质结势垒层积累的应力较低,能够承受更高的电压,击穿电压也就更高。对于栅漏击穿,在高的电压下,栅边缘靠近漏极的高场区内由于应力的积累会产生晶体缺陷,对材料和器件造成永久性的损伤,因此栅漏击穿是不可逆转的。
