如图1所示,一般地,SG-TFET器件主要由AlGaN/GaN晶圆、欧姆漏极、肖特基源极栅极以及介质构成。与传统AlGaN/GaN异质结横向MISFET器件不同的是,SG-TFET的源极是肖特基金属,而栅极位于源极远离漏极的一侧并且深深地贯穿异质结。同时,引入高性能栅介质避免在形成栅凹槽过程中产生的缺陷对器件性能的负面影响。为了实现功率输运能力,一般地,AlGaN势垒层厚度可以在20nm左右,同时器件栅、源、漏三电极的长度需要在0.5μm以上,而介质厚度根据实际情况可以选择10-20nm。
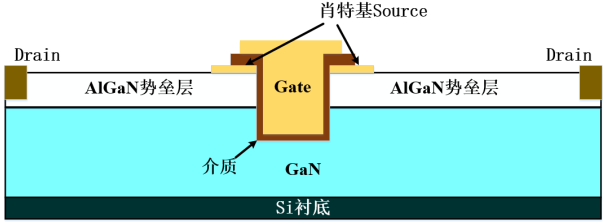
图1 SG-TFET结构示意图
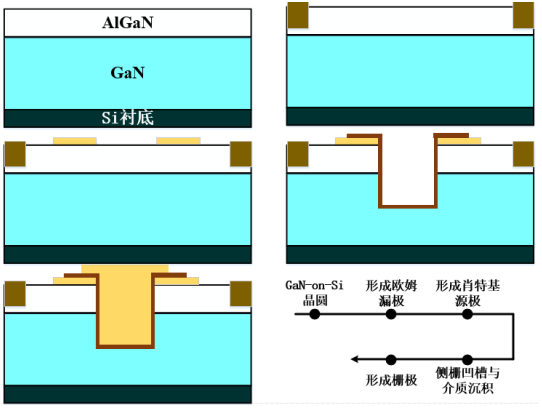
图2 SG-TFET制备流程
图2所示的是SG-TFET制备流程。整个工艺从硅基GaN异质结晶圆的制备与清洗开始。首先通过MOCVD或MBE等手段制备高质量的硅基GaN异质结晶圆片,再对晶圆片表面进行有机(丙酮、异丙醇溶液等)-无机(盐酸-双氧水、BOE溶液等)工艺清洗。之后光刻并显影出欧姆漏极的形貌,再利用电子束蒸发或磁控溅射形成Ti/Al/Ni/Au或其他欧姆金属堆层,并剥离、退火以形成高质量的欧姆接触。然后,同样地淀积肖特基源极,并利用金属做硬掩膜实施自对准干法刻蚀形成栅凹槽,紧接着进行干法刻蚀后处理(如退火或溶液处理)以及介质淀积。最后,形成栅金属淀积。其中,自对准刻蚀和刻蚀后处理对器件性能影响较大,需要通过实验确定合适的干法刻蚀菜单以及处理溶液配方。
2. SG-TFET开关机理
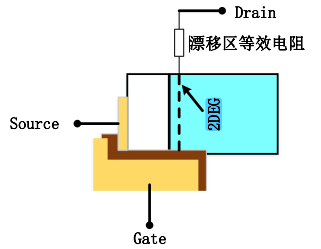
图3 SG-TFET器件关键部位等效示意图
SG-TFET器件实现开关功能的关键,即在于其肖特基源极对于漏极高压的反向阻断能力,以及栅极对反向阻断的肖特基源极-AlGaN结势垒的电场调制。图3是对SG-TFET实现场效应机理的关键部位示意图,栅极对于反偏的肖特基源极-AlGaN结势垒调制实现了SG-TFET的隧穿式导通。其开关前后能带分布如图4所示,其中q是电子电量,φs是金属-AlGaN结势垒高度,Ec是导带能级,Ef是静态费米能级,Efi是加上漏极电压后GaN内的费米能级(忽略漏极电压对AlGaN势垒层能带的影响)。当SG-TFET栅压为0V时,肖特基源极的反向阻断作用实现了器件增强型性能;当栅极电压为正时,AlGaN层内导带开始降低。随着栅压不断升高,栅极施加的有效调制电场不断增强,当势垒导带降低到一定值后,源极-AlGaN结的隧穿概率会暴涨,器件中通过电子隧穿效应形成的电流JT剧烈增强,器件导通。
从图4可以明显看出,影响SG-TFET器件性能的关键参数有源极金属功函数、AlGaN层Al组分、AlGaN层厚度、栅极介质厚度。当源极金属功函数增高时,φs也会增高,这会使得在其他参数相同的条件下,电子隧穿过源极金属-AlGaN结的概率剧烈下降,影响SG-TFET导通能力。另外,当AlGaN层Al组分增高时,AlGaN禁带宽度会同步增高,这同样也会降低电子隧穿概率而减弱SG-TFET性能。当AlGaN层厚度过高时,SG-TFET性能也会下降;而其厚度过低时,会减弱肖特基源极的反向阻断能力,使反向漏电升高。因此为了既提高SG-TFET电子调制隧穿性能,又降低反向漏电,需要综合考虑源极金属功函数和势垒厚度。最后,介质材料的选取与介质厚度会影响栅极施加的有效调制电场,这也会影响SG-TFET调制隧穿性能。
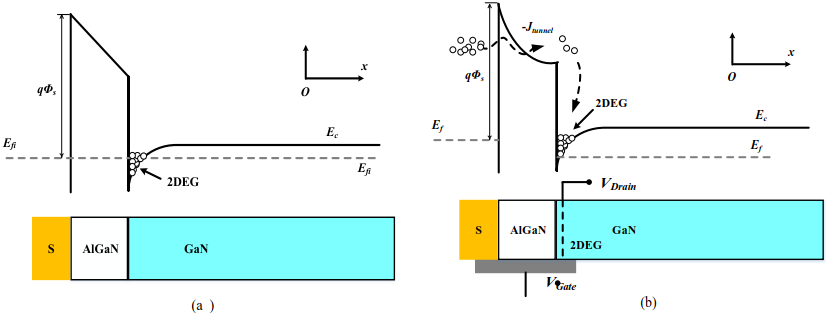
图4 SG-TFET开关模式能带分布。(a)初始状态;(b)导通状态
