需要特别提到的是,由于本文所进行的工艺开发是在中科院纳米所进行的,实验设备为OxfordICP180,实验中如刻蚀速率和表面粗糙度等实验结果只对实施实验的设备有意义。为了更科学地评价工艺,本文的工艺开发遵循自我对照原则,即以传统干法刻蚀结果为对照组,在此基础上进行工艺开发,提出更高性能的刻蚀工艺菜单。
ICP刻蚀的基本原理是在真空的环境中利用等离子体对GaN材料表面进行物理碰撞和化学反应以达到刻蚀目的。ICP刻蚀的设备需要在所刻蚀样品上方设置两个射频源以形成两个射频电场。其中一个称之为ICP功率源,用于将所导入的刻蚀气体等离子化;另一个称之为RF功率源,用于将所生成的等离子体导向刻蚀样品。
从以上原理可知,ICP刻蚀工艺的关键参数是刻蚀气体流量比、ICP、RF两个功率源的功率以及真空环境温度。其中刻蚀气体流量比决定了刻蚀过程是物理碰撞为主还是化学反应为主;ICP功率主要影响等离子体密度而RF功率主要影响等离子体向待刻蚀样品运动的能量;真空环境温度主要影响刻蚀过程中晶格的自整顿以及刻蚀生成物的状态。
目前,广泛应用于ICP刻蚀的气体系统是氯气(Cl2)与氯化硼气(BCl3)。在ICP源的作用下这两种气体被等离子化,其中Cl2等离子体能对GaN形成有效的化学反应以达到刻蚀目的,然而当GaN表面具有很容易形成的氧化层时,Cl2便无法进行化学反应。此时只能依靠BCl3气体的等离子体如BCl2-等大离子对GaN表面的氧化层进行物理碰撞。
根据以上的思路,首先对ICP与RF的功率进行优化。优化的指导思想是尽量降低ICP与RF源的能量,降低等离子体的密度与朝带刻蚀样品运动的速度并合理优化物理碰撞占刻蚀过程的比例。这样就能令刻蚀过程可控而对刻蚀区域表面损耗较低。其次提高刻蚀环境温度至150℃,这样能降低刻蚀生成物对表面的负面影响,且使某些生成物变成液体流向刻蚀表面的较低处以形成低处保护作用,有效地降低毛刺的生成。
表1所示的是保持ICP功率为100W不变,改变RF功率后等离子体对样品衬底的偏压实验值。表2所示的是保持RF功率为100W不变,改变ICP功率后等离子体对样品衬底的偏压实验值。
从表1与表2可以看出,降低RF功率能有效降低等离子体对刻蚀样品的偏压,而仅降低ICP功率对这个偏压的降低作用较小。下面,需要针对RF功率进行优化,保证RF功率尽量低且等离子体密度能达到可以刻蚀的最低值(即ICP腔体内起辉)。图1所示的是本节实验所用的设备在运行标准GaN刻蚀工艺,即图1(a),和静止状态,即图1(b),中刻蚀腔观察窗观察到的起辉状况。
表1 相同ICP功率不同RF功率下等离子体至底座的偏压

表2 相同RF功率不同ICP功率下等离子体至底座的偏压

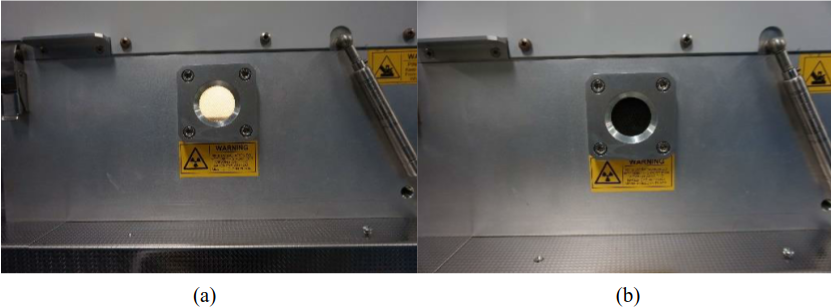
图1 OxfordICP-180的反应腔体中的起辉现象。(a)起辉;(b)未起辉
表3所示的是不同功率的ICP与RF功率源起辉实验的结果,从中可以看出只有序号为1和3的工艺菜单的起辉比较稳定且偏压较低。这说明降低ICP功率至50W以下时,RF功率应保持在10W以上才能有效起辉。下面根据这个实验结论对高温低功率ICP刻蚀进行工艺菜单开发。实验中的晶圆采用江西晶能初期生产的2寸片,AlGaN/GaN异质结势垒层含Al组分为0.3,厚度为20nm。
表3 低功率起辉实验结果

表4 传统刻蚀工艺菜单与AFM测试结果

(1)Recipe1:150℃;RF=10W;ICP=50W;Cl2/BCl3=4/10sccm;4min;
表5 Recipe1测试数据


图2 利用recipe1刻蚀后测试样品表面形貌
(2)Recipe2:150℃;RF=5W;ICP=50W;Cl2/BCl3=4/10sccm;4min;
表6 Recipe2测试数据

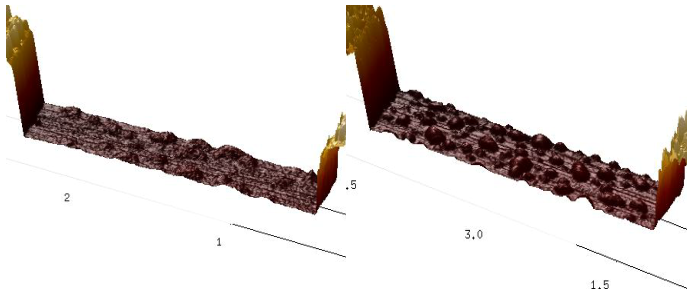
图3 利用recipe2刻蚀后测试样品表面形貌
(3)Recipe3:150℃;RF=10W;ICP=25W;Cl2/BCl3=4/10sccm;4min;
表7 Recipe3测试数据

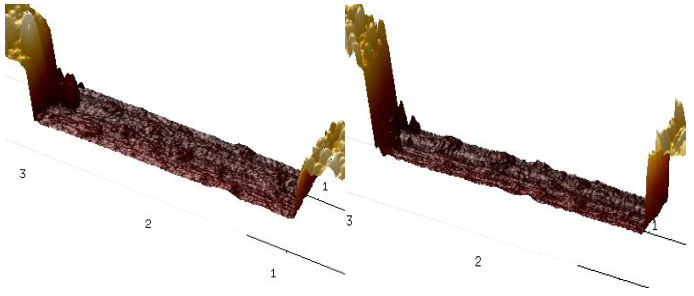
图4 利用recipe3刻蚀后测试样品表面形貌
(4)Recipe4:150℃;RF=10W;ICP=50W;Cl2/BCl3=4/6sccm;4min;
表8 Recipe4测试数据

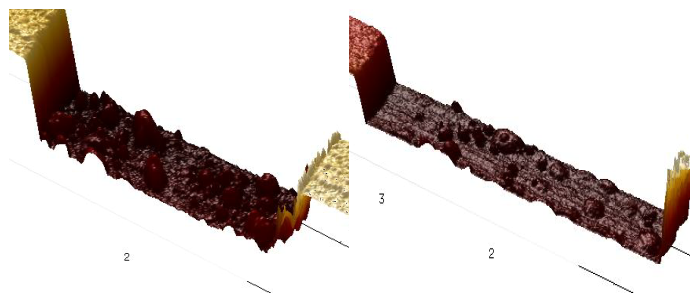
图5 利用recipe4刻蚀后测试样品表面形貌
(5)Recipe5:150℃;RF=15W;ICP=50W;Cl2/BCl3=4/10sccm;4min;
表9 Recipe5测试数据
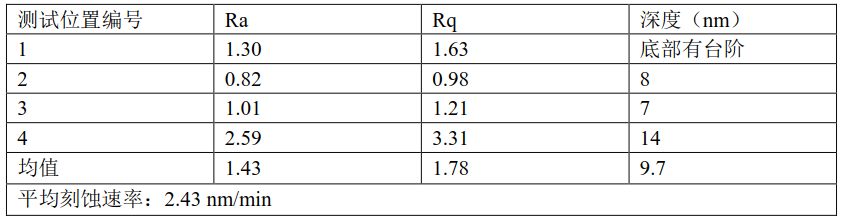
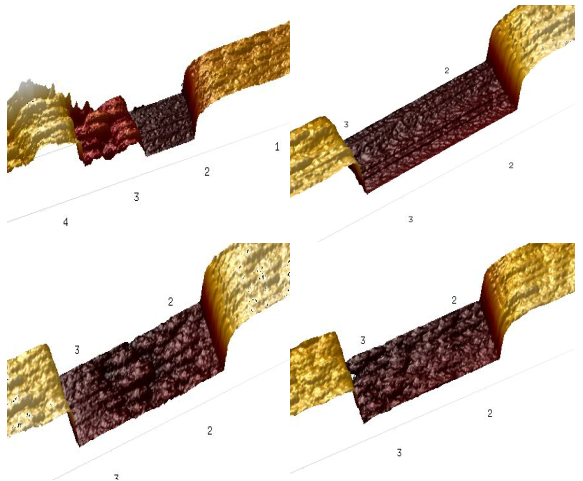
图6 利用recipe5刻蚀后测试样品表面形貌
经过高温低功率刻蚀实验和AFM测试,可以看到recipe5的刻蚀结果是最好的,无论表面平均粗糙度Ra还是表面均方根粗糙度Rq的测试均值都是所有菜单中最低的,因此可以认为recipe5即是兼顾了速度与精确度的刻蚀工艺菜单。其可以满足本章所提出的浅场板集成栅的快速制备。