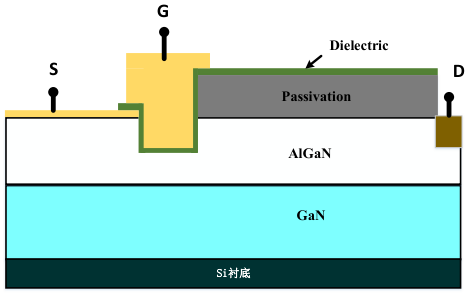
图1 GaN-on-Silicon浅场板集成栅功率MISFET结构示意图
当器件处于初始状态时,能带分布如图2所示。可见此时整个器件能带与SG-TFET相类似。
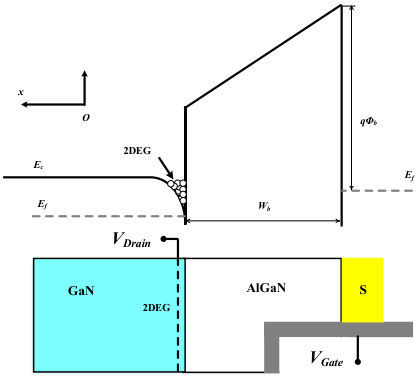
图2 浅场板集成栅隧穿结附近能带示意图
当栅电极开始有正向偏压并达到器件阈值电压时,器件导通。导通电流路径分为两段,其一是SG-TFET隧穿结,其二是浅场板集成栅调制碰撞电离区,其能带分布如图3所示。
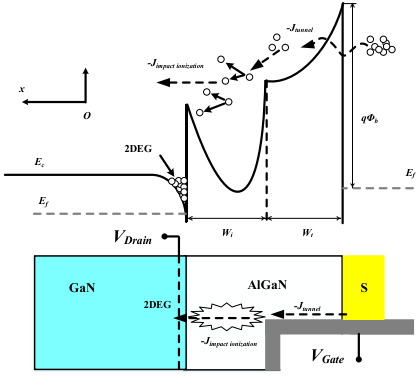
图3 浅场板集成栅隧穿结导通能带示意图
超过阈值的栅电压对隧穿结的有效调制使隧穿电流密度骤然增加,这种隧穿电流以FN隧穿机制为主。但由于导通状态必须满足电流连续性条件,这些隧穿过势垒一半区域的电子无法有效续流,这将极大地阻碍电子的继续隧穿过程。因此,只有当源极下方靠近栅极的部位在栅压调制下发生碰撞电离时,电流连续性条件得以满足,器件隧穿-碰撞电离机制耦合增强。这样在浅场板集成栅附近将形成高密度的电子聚集,并扩散进2DEG完成电流的输运。可见,这种电流输运主要由两步完成。这种前后两步输运的方式对于第一步中电子隧穿的概率可能有降低作用,但是在第二步中,由于碰撞电离效应使电子在很短时间内增加,这有效降低了导带能级,使得隧穿电流能够维持较高的密度,弥补了依靠概率进行电流输运这一机制对整个器件的电流输运能力的负面影响。
从分析也可得出,浅场板集成栅MISFET的导通主要受到三个因素影响:第一是源极金属功函数,这一参数对肖特基源极MISFET电流影响极大;第二是隧穿结势垒层厚度Wt,这对于隧穿结电流输运有较大影响;第三是碰撞电离区的宽度Wi,这一参数过低可能导致器件浅场板集成栅成为耗尽型结构而对电流输运有影响。
