采用常规工艺得到的GaN HEMT器件在零偏压下导电沟道依然存在,即为常说的耗尽型器件。对应地,若零偏压条件下器件处于关断状态,则将其称为增强型器件。由于对于诸如高速开关、高温GaN集成电路、射频集成电路(RFIC)和微波单片集成电路(MMIC)等应用领域而言,增强型HEMT都显得极为关键,所以关于增强型HEMT器件的研究也一直备受关注。但是,两者相比而言,增强型HEMT器件的制备工艺就复杂很多,这在很大程度上增加了对应电路的设计成本。然而增强型HEMT器件也具有相当明显的优势:首先,对于功率放大器而言,应用增强型HEMT不需要输入负向电压,这对电路简化和成本降低都大有裨益;其次,对于高功率开关应用,增强型HEMT可以极大地提高电路的安全性;再者,增强型HEMT的加入使得GaN基互补型数字集成电路成为可能。
需要重点说明一点,与常规GaN HEMT器件中各层材料厚度所不同的是,本文中用到的增强型和耗尽型器件其势垒层厚度均减薄为11nm,即属于薄势垒器件。此外,器件其他结构参数分别为:栅长Wg=50µm,栅长Lg=1µm,源漏间距Lsd=4µm,栅源、栅漏间距Lgs=Lgd=1.5µm,栅帽1.4µm。
图1(a)~(d)依次给出了薄势垒耗尽型和增强型器件在77K和300K下的输出曲线。从1(a)图可以看到,由于势垒厚度的减薄,在T=77K时,耗尽型器件输出曲线在整个栅压范围内均出现了明显的kink效应。但是对于增强型器件,从图1(b)可以看到,低温条件下,输出电流仅在较小正偏压下存在一定的kink现象,在较大偏压下输出曲线则表现出明显的上翘趋势。另外,从(c)图中可以看到,当温度升高到300K时,薄势垒耗尽型器件的输出曲线在饱和区出现了因自热效应而产生的负阻现象,同时kink效应则基本消失。对于增强型器件,当温度升至300K时,输出曲线的上翘幅度明显减小,电流趋于饱和。
目前,关于AlGaN/GaN HEMTs中kink效应的产生机理还没有一个统一的定论。部分研究者认为,kink效应是由碰撞电离过程中所产生空穴的不断积累引起的。但是,R.Cuerdo等人研究得到,当T<260K时,通过紫外照射或给栅压加短脉冲,AlGaN/GaN HEMT将出现kink效应,通过分析,他们认为紫外照射和刻蚀中引入的缺陷是引起kink的主要原因。

图1 增强型和耗尽型器件输出曲线
本文为了进一步研究GaN基HEMT器件中温度与kink效应的关系,对不同温度下薄势垒耗尽型和增强型HEMT器件件的输出曲线进行了测试,如图2所示。通过对图2(a)和(b)对比可以看到,两类器件输出曲线随温度的变化曲线存在明显差异,第一、对耗尽型器件,输出电流随温度的降低逐渐增大,而对于增强型HEMT,器件的输出电流却随温度的降低而减小;第二、当漏压大于产生kink效应的偏压后,随着漏压的增大,耗尽型器件饱和区电流曲线下弯,而增强型器件输出电流则持续保持上翘趋势。图2(c)给出了耗尽型器件kink突增量和温度之间的变化曲线,可以看到,两者之间呈近似线性变化。随着温度的降低,kink效应变得更加明显,当温度高于250K时,kink效应基本就消失了。另外,图(d)给出了增强型器件kink效应引起的电流增加量,首先需要说明的是,300K时所得到的值是电流上翘量而非kink效应增加量。其次,同样温度下,增强型器件的kink效应不如耗尽型器件明显。
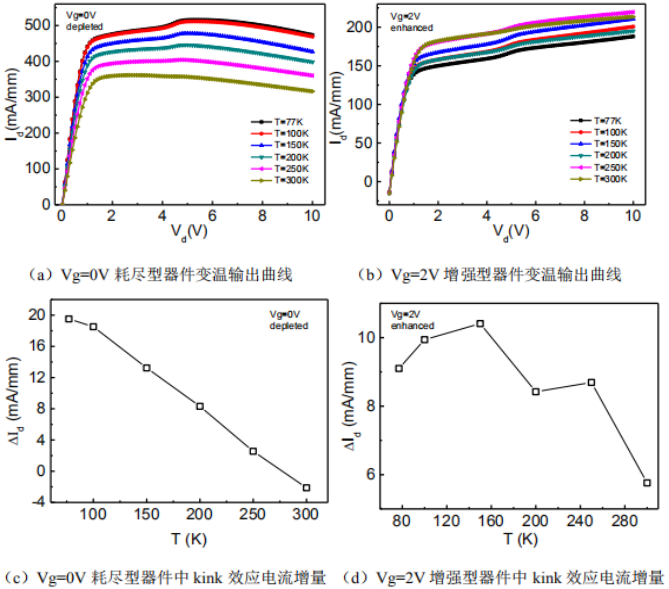
图2 不同温度下AlGaN/GaN HEMT器件输出曲线与kink效应
为了研究增强型HEMT器件和常规耗尽型HEMT器件低温下栅控能力的差异,我们对两类器件在不同温度下的转移和跨导进行了测试,测试结果在图3中给出。从3(a)和(b)可以看到,转移曲线随温度的变化规律与图2所示的输出曲线类似,随着温度的降低,耗尽型器件的电流逐渐增大,而增强型器件的电流在栅压小于2.2V时则表现出相反的变化规律。图3(c)和(d)对应地给出了两类器件的跨导曲线,可以看到,耗尽型器件的跨导随温度的降低而增大,而对于增强型器件,跨导在随温度的降低而增大的同时,最大跨导所对应的栅压出现了明显的右移。跨导随温度的变化规律可以从图4所示的最大跨导随温度的变化曲线可以更加清楚地看到,随着温度的不断降低,无论是常规耗尽型器件还是增强型HEMT器件,器件的栅控能力总体都呈增大趋势。
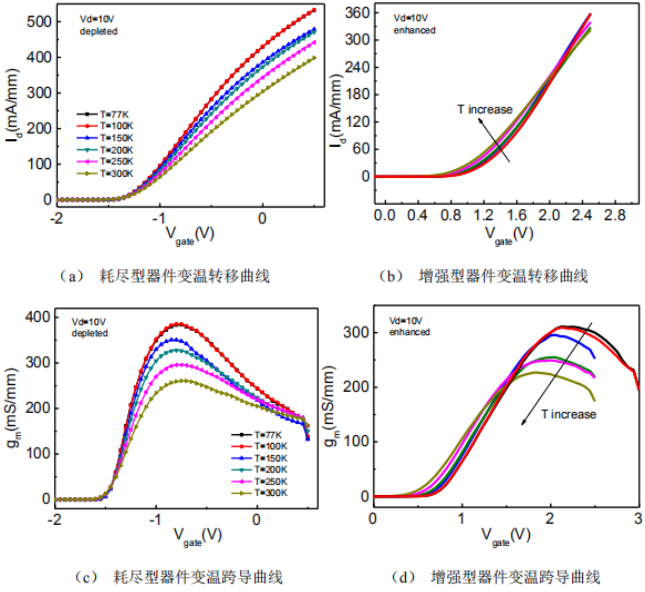
图 3 不同温度下AlGaN/GaN HEMT器件转移和跨导曲线
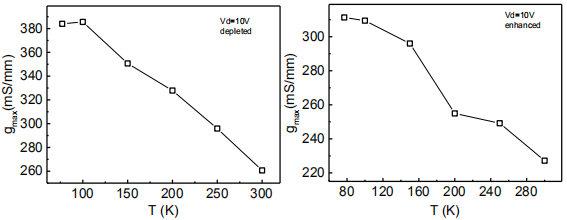
图4 最大跨导变温曲线(a)耗尽型器件(b)增强型器件
对图3所示的转移和跨导曲线进行处理,可以提取得到两类器件阈值电压随温度变化曲线,结果在图5中给出。从5(a)可以看到,对耗尽型器件而言,随着温度的降低,阈值电压先小幅度减小而后在150K在之后出现了转折。而对于增强型器件,我们发现随着温度不断降低,阈值电压不断增大,但是可以看到,低温下阈值电压的增大速率有所减缓。
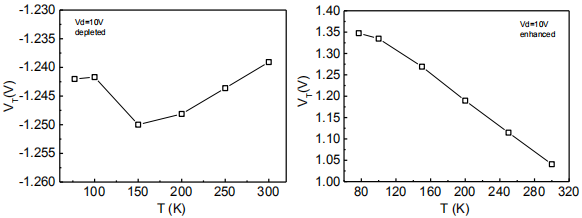
图5 阈值电压变温曲线(a)耗尽型器件(b)增强型器件
图6(a)和(b)分别给出了耗尽型和增强型器件在Vg=-10~2V在不同温度点下的栅电流曲线。可以看到,对于两类器件而言,当栅压Vg<0V时,除300K外,随着温度的升高,器件栅极反向漏电有微弱的增大,当栅压大于0V后,不同温度下的正向栅电流基本不变。
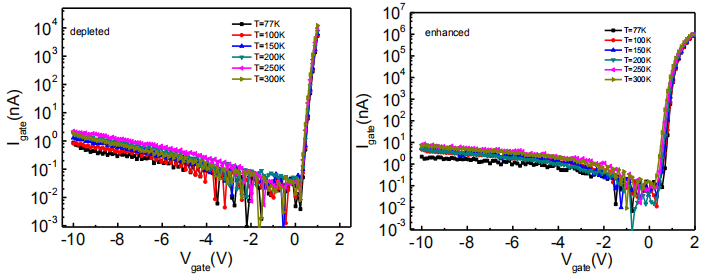
图6 栅电流变温曲线(a)耗尽型器件(b)增强型器件
2. 频率特性对比
我们分别针对薄势垒增强型和耗尽型异质结C-V环结构进行频率特性分析,图7中给出了T=77K两类器件在50KHz、100KHz、200KHz、500KHz和1MHz这五个频率点下的C-V曲线。从(a)图可以看到,耗尽型器件的C-V曲线没有明显的频散现象。但同时,从(b)中看到,对于增强型器件,有两个明显的特征:一是异质结界面处的台面随着测试频率的增大而右移,二是在器件靠近表面处出现了第二个台面,这是由于耗尽层边界到达金属/氮化物界面,载流子在界面积累形成第二个电容上升区域,同样地,第二个台面随频率增大也出现了右移,这都是由于随着测试频率升高,耗尽层宽度的变化跟不上交流信号频率,载流子的积累出现延迟,即C-V曲线台面出现了正漂。再者,对增强型器件,由于界面漏电增大,高频下界面电容出现了下降。
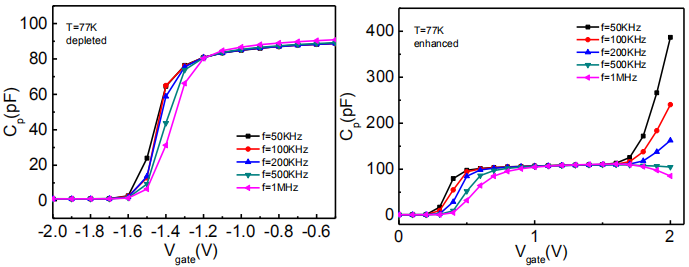
图7 (a)T=77K耗尽型器件变频C-V曲线 (b)T=77K增强型器件变频C-V曲线
为了研究两类器件C-V特性随温度变化的异同,图8(a)、(b)两图分别给出了f=100KHz频率条件下不同温度下耗尽型和增强型器件C-V曲线,可以看到,随着温度的降低,耗尽型器件的C-V曲线基本保持不变,但是对于增强型器件而言,从(b)图中可以看到,随着温度的降低,异质结C-V曲线的台阶出现了明显的右移,另外,77K的平台电容也出现了明显的增加。
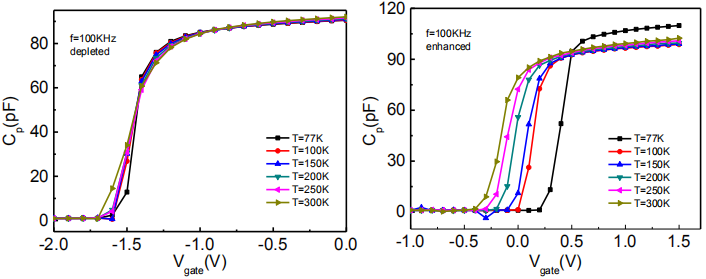
图8 (a)f=100KHz耗尽型器件变温C-V曲线(b)f=100KHz增强型器件变温C-V曲线
最后,对图8中的C-V曲线进行处理,得到了两类器件异质结界面的2DEG面密度随温度的变化曲线,如图9所示。对比图9(a)、(b)可以看到,相同温度下,同样尺寸的增强型器件2DEG面密度小于常规耗尽型器件。其次,在低温段,耗尽型器件中载流子面密度随温度升高有所增加,而当温度高于200K后基本保持不变。但是对于增强型器件,载流子面密度随温度的升高基本保持小幅度增加趋势。
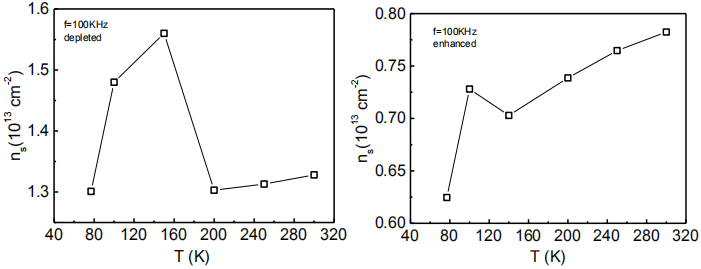
图9 载流子面密度随温度变化曲线
(a)耗尽型器件(b)增强型器件
