由于界面固定电荷没有充放电效应,所以利用回滞曲线或变频方法无法提供界面固定电荷信息,平带电压VFB漂移是常用的用于计算界面固定电荷的方法。本文首先结合能带结构建立了肖特基栅和绝缘栅HEMT器件的平带电压解析模型,然后考虑栅绝缘层和势垒层界面电荷对两个模型进行对比,提取出了MIS-HEMT和MOS-HEMT两种器件的有效界面电荷密度。
1. 平带电压解析模型

图1 AlGaN/GaN异质结构能带结构及电荷分布示意图
在半导体器件结构中,金属与半导体之间存在功函数差、界面存在电荷等原因都会使零偏置情况下沟道处半导体表面能带发生弯曲,即处于非平带状态。要想使半导体表面能带与体内齐平,需要外加偏置电压,称为平带电压。AlGaN/GaN异质结构的能带结构和界面电荷分布如图1所示,其中φs是表面势垒高度,Vb是势垒层内建电势,ΔEc是异质结界面导带带阶,qφF是GaN体内费米能级相对于导带底的位置,P1=P2是极化电荷,Nsd代表势垒层表面施主态。由于GaN帽层和AIN界面插入层只有1~2nm,在能带和电荷计算过程忽略其影响。功函数调制和极化效应使异质结界面能带弯曲,形成类三角形的势阱,势阱深度即对应于平带电压的绝对值,同时决定了界面2DEG面密度ns的大小。根据导带结构示意图可以得出Ni/AlGaN/GaN肖特基异质结构的平带电压与能带其他参数存在如下关系式,


图2 AlGaN/GaN绝缘栅异质结构能带及电荷分布示意图
图2给出了绝缘栅异质结构的导带即界面电荷分布示意图,与肖特基栅结构相比,绝缘层在导带变化中引入了额外的两个变量,绝缘层与势垒层间的带阶ΔEc2和绝缘层内建电势qΔVFB。理想情况下零偏时绝缘层两端没有电势差,但是绝缘层与势垒层之间存在界面电荷,引起绝缘层导带倾斜和器件平带电压漂移,绝缘栅异质结构平带电压可以表示为,


已经得出了肖特基栅和绝缘栅异质结构器件的平带电压公式,将两者进行对照即可提取出绝缘层界面电荷密度。第四章中拉曼测试表明表面绝缘层对异质结产生的应力很小,对极化电荷的影响可以忽略不计,所以将式(2)代入式(4)可以得到,

2. 界面电荷计算
上文已经建立了绝缘栅器件界面电荷计算的解析模型,接下来就是要确定器件平带电压及其他各项能带参数。本文通过1/(C/Cac)²~V及其微分曲线来推导器件平带电压,如图3所示,其中Cac表示积累区电容。随着偏置电压减小低于VFB,电容迅速降低,1/(C/Cac)2~V曲线在V=VFB处出现拐点,此拐点在微分曲线中对应于最大的下降斜率。可以注意到关态时微分曲线存在较大的振荡,这是因为关态电容在pF量级,受噪声影响较大。半对数坐标系中C-V曲线显示,在通常所认为的阈值电压(线性坐标系中C-V曲线拐点)以下,器件并没有完全关断,而是随着电压继续减小使背景电子不断耗尽,所以以前的文献中用公式(2)和(4)直接来表示阈值电压是不准确的。
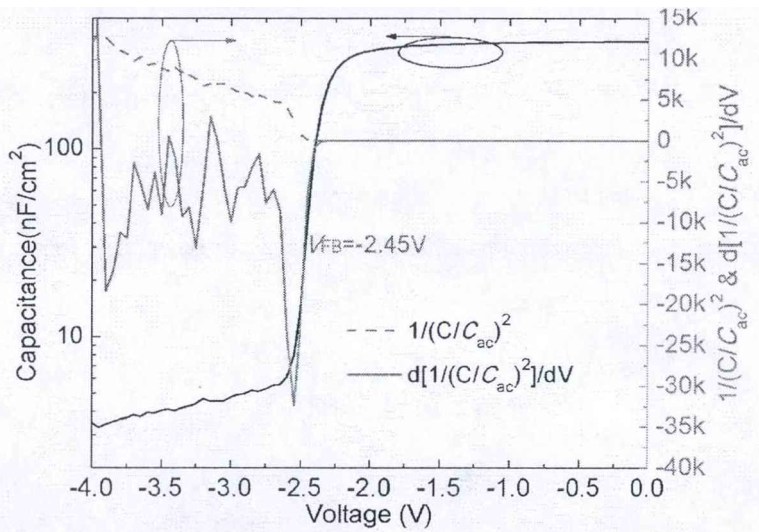
图3 AlGaN/GaN异质结构的C-V测试及平带电压推导曲线
利用电容及其微分曲线提取的AlGaN/GaN异质结构的平带电压为-2.45V,与C-V曲线的拐点相比正漂了0.05V。绝缘栅器件的平带电压推导曲线如图4所示,MIS栅和MOS栅结构的平带电压分别为-3.25V和-7.35V。对于三种栅结构的异质结器件,取Ni/AlGaN、Ni/AIN、Ni/Al2O3接触的表面势垒高度分别为0.95eV(通过I-V曲线拟合得到)、3.12eV、3.5eV,AlGaN/GaN、AIN/AlGaN、Al2O3/AlGaN之间的导带带阶分别为0.77eV、1.81eV、1.36eV,GaN体内费米能级位置qφF=0.3eV。将三种结构的平带电压和能带参数代入式(5),得到AIN/III-N和Al2O3/III-N界面及绝缘层电荷引起的平带电压漂移量分别为0.32V和-3.78V,界面有效电荷密度分别为-1.18×1012cm-2和8.98×1012cm-2。ALD沉积的Al2O3绝缘层界面电荷引起平带电压负漂,与通常的绝缘栅器件阈值电压负漂现象相一致,而且界面固定电荷密度高于8.98×1012cm-2;但是PEALD沉积的AIN绝缘层界面电荷却引起平带电压正向漂移,与通常绝缘层界面固定电荷引起阈值电压负漂这一预测不符,这是因为AIN与势垒层界面固定电荷极低,界面电荷电量以深能级界面态为主导。

图4 (a)MIS栅和(b)MOS栅异质结构的C-V测试及平带电压推导曲线
另外,根据上述研究结果还可以解释表面钝化层对2DEG饱和面密度的调制作用,Hall测试表明PEALD沉积AlIN表面层使2DEG密度降低,而ALD沉积的Al2O3提高了2DEG密度。2DEG密度与沟道能带弯曲程度即平带电压相关,拉曼测试表明表面钝化层对极化效应即势垒层能带倾斜影响不大,则2DEG的调制作用来源于V和AVFB两项。计算得到VoS、VoMIS、VoMOS分别为-0.12V、0.24V、1.07V,即不考虑绝缘层界面电荷影响时表面层能带调制使沟道能带弯曲程度减弱,对2DEG有耗尽作用。PEALD沉积AlN绝缘层界面带有效负电荷,对2DEG产生进一步耗尽作用,最终表现为PEALD沉积AIN表面层使2DEG浓度大幅降低;但是低密度2DEG使电子间相互散射作用减弱,而且界面固定电荷密度极低,2DEG远程电离杂质散射作用也减弱,大大提高了载流子迁移率。对于ALD沉积的Al2O3绝缘层,界面高密度的固定电荷密度对2DEG密度有提高的作用,补偿了能带调制对2DEG的耗尽作用,最终表现为2DEG提高;并且沟道电子散射和远程电离杂质散射作用增强使沟道载流子迁移率大幅度退化。