HEMT器件是三端电压控制器件,它有三个电极,分别是栅极、源极和漏极。栅极通常是肖特基接触电极,源极和漏极是欧姆接触电极。通过调节外加栅极电压(相对于源极),可以调控沟道中的二维电子气(2DEG)密度,从而实现栅极电压和漏极电压对漏极电流(输出电流)的控制。其工作原理可以用沿着垂直于异质结结面方向的一维线性电荷模型来定量描述。所谓电荷控制模型是指在无漏极电压时,栅极电压对2DEG密度的控制作用。典型AlGaN/GaN HEMT的结构示意图如图1所示。由于栅极、源极和漏极均制作在器件的上表面,2DEG所形成的电流在沟道中水平流动,故称为横向结构器件。该器件结构可通过异质外延生长技术(如MOCVD技术)或外延结构转移技术制备在不同的衬底材料上,如SiC衬底、蓝宝石衬底、Si衬底、GaN衬底、金刚石衬底或其它合适衬底材料上,图1中略去了具体的衬底材料。如果不考虑三个电极,在图1中,在纵向(垂直于异质结结面方向)方向上从衬底材料向上,依次是高阻GaN缓冲层材料、非故意掺杂AlGaN势垒层材料、N型掺杂AlGaN势垒层材料。
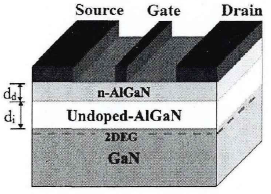
图1 AlGaN/GaN HEMT结构示意图
2DEG位于Undoped-AlGaN/GaN异质结界面GaN—侧的沟道中。通常,为减少AlGaN势垒层中的合金无序对沟道中2DEG的散射作用,在Undoped-AlGaN/和GaN层之间插入一薄层(厚度约为1nm左右)的AlN材料;为了保护AlGaN层免受氧化,在n-AlGaN表面还会生长一层3nm左右的GaN帽层材料。在图1中,为简单起见,略去了AlN插入层和GaN帽层,这样处理并不影响一般地对AlGaN/GaN HEMT器件的工作原理进行讨论。2. AlGaN/GaN HEMT器件的工作原理
与图1相应的AlGaN/GaN HEMT结构的导带能带图如图2所示。

图2 AlGaN/GaN HEMT结构的导带能带图
AlGaN/GaN HEMT器件中的2DEG的密度可通过求解有外加栅极电压时的泊松方程和薛定愕方程得到。在全耗尽近似下,即栅极下面的肖特基结的耗尽区和AlGaN/GaN异质结的耗尽区交叠时,通过求解泡松方程可得到AlGaN区的耗尽层电荷分布。若阱中电荷等于AlGaN区的耗尽电荷,则沟道中的2DEG面密度与栅极电压的关系如下:
 (1)
(1) (2)
(2) (3)
(3)
I=Wqns(x)v(x)=const (4)
其中W为栅极宽度,V(x)为电子沿沟道方向的漂移速度。(1)在栅极电压一定(Vgs>Vth)时,随着Vds的增大,源漏电流会在电场的作用下逐渐增大,若满足Vds<Vgs-Vth,电流随漏极电压的増长关系近似为线性,器件工作在线性区。假设迁移率μn为常数,则:

(2)当Vgs>Vth,且Vds=Vgs-Vth时,式(6)所表示的漏极电流达到最大值(与抛物线的顶点相对应),该最大值为:
Idmax=β(Vgs-Vth)2/2 (7)
通常将Vds=Vgs-Vth时的漏极电压Vds的值,称为与Vgs相应的膝点电压。膝点电压是HEMT器件线性区和饱和区的分界点,通常膝点电压越小越好。(3)当Vgs>Vth,且Vds>Vgs-Vth时,器件工作在饱和区,电子漂移速度达到饱和。此时2DEG导电沟道在漏端一侧夹断,沟道内场强为dV(x)/dz=Eerit,这时:
 (8)
(8)
Id=β(Vgs-Vth)2(1+λVds) (9)
其中λ为沟道调制系数,反映了Vds对电流的影响。(4)增加负栅压,耗尽层加深,同时,费米能级向势阱底部下移,电子密度减小,直到Vgs≤Vth时,2DEG面密度ns=0,无漏极电流输出。此时,源漏之间电流仅存在漏极与源极之间的很小泄漏电流,器件处于截止区。
如上所述,AlGaN/GaN HEMT器件能通过外加栅压控制沟道的2DEG面密度,从而实现输出漏极电流随外加栅压和漏极电压的变化而变化;它既能工作在导通区,又能工作在截止区,能在不同外加栅压下截止和导通,因此,它既可以用作交流信号放大器件,又可以用作电力电子器件实现开关特性。
