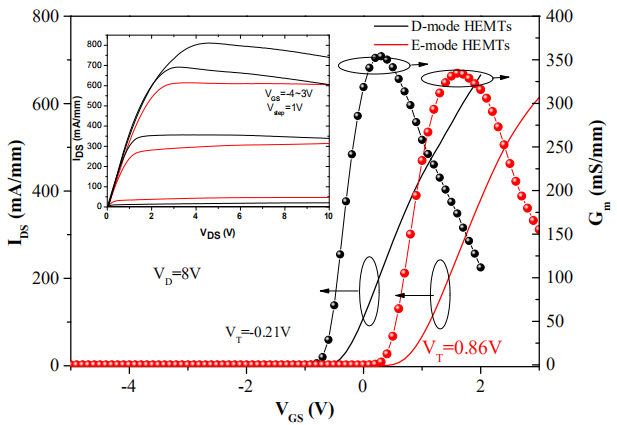
图1 增强型和耗尽型IDS-VGS转移曲线,图1的插入图为IDS-VDS输出特性曲线
脉冲I-V测试是揭示器件陷阱态情况的一种非常有效的测试方法。脉冲I-V测试中,同步地将特定的脉冲从设定好的静态偏置点加到器件的栅极和漏极上,以观察器件在脉冲和直流下变化情况。若栅极和漏极的静态点为(VGSQ,VDSQ)为(0V,0V),脉冲测量可以消除器件热效应和陷阱效应;而使用关态(OFF-state)静态点则是观察器件的陷阱效应。通常关态静态偏置点的选择为使器件完全关断的栅压,和夹断点后的漏极电压;开态(ON-state)静态点则使得器件工作在大电流状态。所以我们选择耗尽型的关态静态点为(-8V,10V),开态静态点为(0V,15V),而增强型的关态静态点设置为(-8V,10V),开态静态点设置为(2V,15V)。脉冲的宽度为500ns,周期为1ms。如图2所示,增强型HEMT器件的电流崩塌量为7%,耗尽型HEMT器件的电流崩塌量为15%。这表明了N2O并没有引入新的陷阱态到AlGaN势垒层中去。我们也可以看到,在图3画出的增强型和耗尽型HEMT器件的肖特基栅电流特性曲线上,相对较长的N2O等离子处理时间同样没有在正向和反向上增加器件的栅电流。AlGaN/GaNHEMT器件中,栅极和源极/漏极之间的电流和陷阱态密切相关,这点在后面的章节会讨论到。脉冲I-V和肖特基栅的电流特性的测试同时表明,N2O处理并没有明显增加栅下区域的陷阱态。
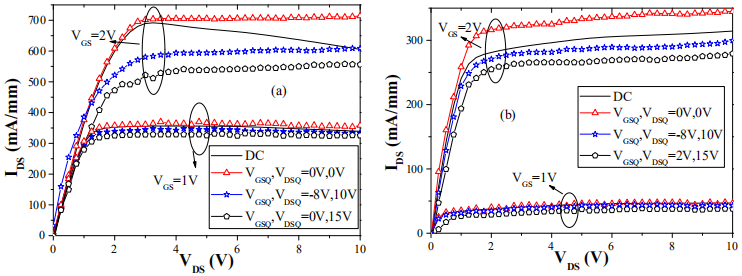
图2 不同静态偏置点下增强型和耗尽型期间的脉冲I-V特性曲线对比(a)耗尽型HEMT器件(b)增强型器件
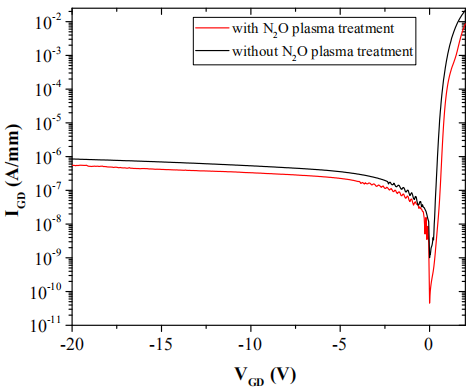
图3 增强型和耗尽型肖特基栅IGD-VGD曲线对比
图4所示的是三端关态击穿电压测试结果,图4(a)所示的是耗尽型HEMT(b)所示的是增强型器件。击穿电压(Vbr)的定义为在关态的栅源电压下,使得漏源电流到达1mA/mm时的漏源电压。对于增强型器件,关态栅源电压选择为-4V,而耗尽型为-6V。在图4中可以看到,N2O等离子体处理将器件的击穿电压从96V增加到了110V。增强型的击穿电压比耗尽型的击穿电压高了将近15%。栅极电流在漏源电流到达1mA/mm时只贡献了非常小的一部分电流,这意味着缓冲层电流是击穿电流的主要来源,栅下区域并不是主要因素。击穿电压提高的原因一部分可能是因为栅极电流的降低,一部分可能是在栅极等离子体工艺中改善的栅极形貌。
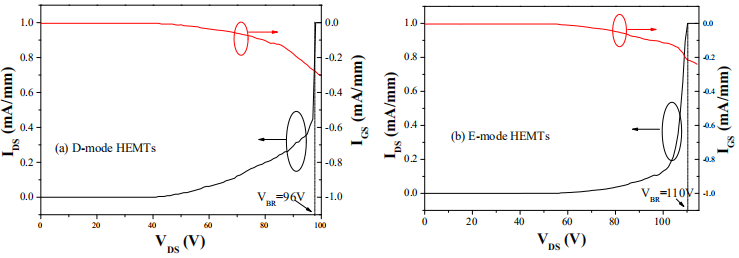
图4 三端关态击穿电压测试曲线(a)耗尽型HEMT(b)增强型HEMT

图5 增强型HEMT在不同温度下的亚阈值特性曲线
图5所示的是增强型器件温度相关的亚阈值特性曲线,温度变化的范围为室温(RT)到250℃,栅源电压的扫描范围为-6V到2.5V。从室温到250℃的阈值电压变化量非常小,只有100mV,温度导致的阈值电压漂移量为-0.40mV/℃。如此小的温度相关的阈值电压漂移量比常规的耗尽型器件和增强型器件有了改善。关态漏极电流从室温到250℃增加了大概2个数量级。阈值电压的热不稳定性来自于势垒层内部或者是AlGaN/GaN异质结界面处的陷阱态。当温度提升时,这些远离费米能级的陷阱态有可能释放或者捕捉电子,从而引发了不稳定的阈值电压。阈值电压的热不稳定性在增强型HEMT器件和增强型MIS HEMT器件中尤为明显,因为增强型器件通常会采用一种或多种栅极区域处理工艺,假如工艺处理条件不当或者本身不可避免的损伤,这些工艺处理就有可能改变栅极下区域的陷阱状态。这些陷阱态的影响可能在绝缘介质的加入后变得更加严重。对于常规耗尽型和增强型器件,尽管没有绝缘栅介质,但是如果栅极处理工艺本身就已经很严重地影响到了栅区域的陷阱,那么这些陷阱还是会影响到阈值电压的热稳定性。在一些离子注入工艺或者刻蚀工艺中,工艺后退火是一个常见的工艺步骤,被用来修复在工艺中造成的损伤。在N2O处理后的良好的界面态可能来自于300℃的PECVD腔体温度。
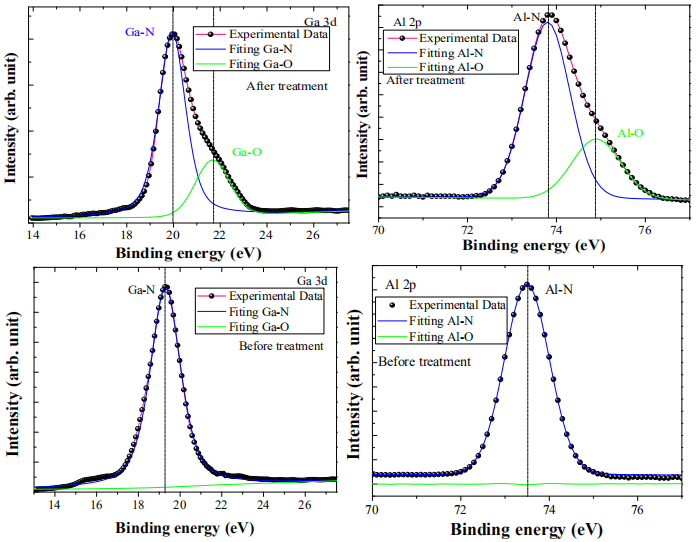
图6 N2O等离子体处理前后的Al2p和Ga3d核心能谱对比
我们使用X射线光电子能谱(XPS)来观察N2O处理前后的栅极区域元素组成变化情况。图6给出了N2O等离子体处理前后的Al2p和Ga3d核心能谱对比。对比处理先后的能谱图,在N2O等离子体处理后,Al-N和Ga-N峰高束缚能测都出现了Al-O峰和Ga-O峰。处理后的Al-O键和Al-N键的比例,Ga-O键和Ga-N键的比例都接近于1:3。这说明在高温的等离子体环境下,Al和Ga被部分的氧化,N2O等离子体可能在高温下将部分势垒层转变为了AlON/GaON复合结构,同时消耗了部分势垒层。前面提到过,在工艺进行25分钟后,监测的无栅结构的漏源电流值Ids0会趋于饱和。这表明在PECVD反应腔内的N2O等离子在低的轰击效果下,没有足够的能量注入到AlGaN势垒层更深的位置。在足够的反应时间后,已经形成的薄的AlON/GaON复合氧化层会阻止O离子进入势垒层,从而展现了自终止效应。作者认为N2O等离子体处理实现增强型器件是薄势垒层和PECVD系统内部分热氧化的共同作用结果。因为使用了薄势垒材料,势垒表面有很强的耗尽作用。在SiN钝化层淀积之前,AlGaN薄势垒层结构的2DEG通常不会很大。薄势垒AlGaN/GaN HEMT器件通常的阈值电压在-0.20V到0V之间。因此,在分解的氧离子消耗了本来就已经很薄的AlGaN势垒层形成AlON/GaON复合氧化层后,所剩的AlGaN势垒层足以把阈值电压往正漂移。而在表面形成的复合氧化层介质也更加的加大了这种正漂量,因为栅极电压会有一部分加在这新形成的复合氧化介质层上。薄势垒层和N2O等离子体处理的共同作用使得增强型器件得以实现。这种在高温氛围中形成的MIS-HEMT增强型器件比通过外延淀积的介质界面有着更好的介质/半导体界面,因此表现出来了高的阈值温度稳定性。增强型HEMT器件是GaN基E/D模电路的基础,有了优异性能的增强型HEMT器件才可能设计制备出性能良好、工作可靠的GaN基E/D模电流。本节提出的新型N2O等离子体处理实现增强型器件是一种新颖的思路。阈值电压最大可达0.86V,达到用于数字电路开关的要求。但是由于材料势垒层厚度仅为8nm,因此在片同时制备的耗尽型器件阈值接近0V。0V左右的耗尽型器件的阈值电压对于E/D模电路的负载充电过程是不利的,会使得E/D模反相器中耗尽型负载管快速充电的优势无法得到充分体现,影响了电路工作的速度。但是我们可以使用更厚势垒层的AlGaN/GaN材料,如16nm势垒层材料,此时在片同时制备的耗尽型HEMT器件的阈值电压约为-0.27V,能够满足E/D模反相器快速充放电的要求。进行N2O等离子体处理时,考虑到N2O的自终止现象,可以分多步N2O等离子体处理的方法。由于在一定时间后可能形成的AlON/GaON复合氧化物阻止进一步氧化,可以在一定时间后使用KOH等溶液等去除AlON/GaON复合氧化物,进一步减薄势垒层厚度,然后再进行N2O等离子处理。这样经过两次或多次等离子体处理/去氧化层工艺后,增强型器件和耗尽型器件的阈值电压满足E/D模电路要求,实现E/D模工艺兼容。
