势垒调制技术
势垒调制技术包括薄势垒、P型帽层、含Al缓冲层、极化抵消以及局部背势垒缓冲层等技术手段,其中薄势垒技术是较早地在AlGaN/GaN异质结器件中实现增强型的技术。由于2DEG主要来自AlGaN层中压电极化电荷的吸引,因此对AlGaN层的压电极化进行削弱是自然而然的思路。
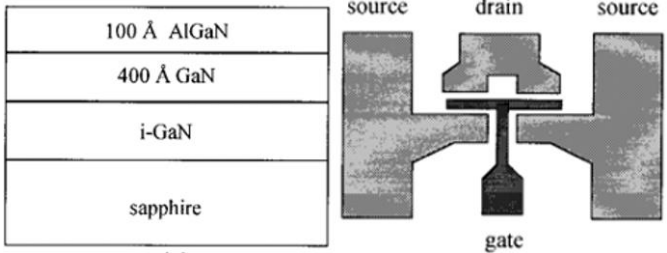
图1 薄势垒增强型AlGaN/GaN HEMT结构
具体来说,即在AlGaN/GaN异质结外延的过程中,降低AlGaN层的外延厚度。如图1所示而当低Al组分的AlGaN层厚度降低到10nm时,异质结中的2DEG浓度将会剧烈降低。此时,利用高功函数栅极的耗尽作用,可以形成阈值电压在0V左右的赝增强型MISFET。然而,本文本着探究的原则对所报道的薄势垒结构进行仿真研究,其结果如图2所示,器件并未有明显的开关性能,这可能和所报道的器件外延层中背景载流子数量较多有关,这是因为十几年前的外延工艺并不十分成熟。也有可能是所报道的实验结构中栅极对沟道进行了全覆盖的缘故。
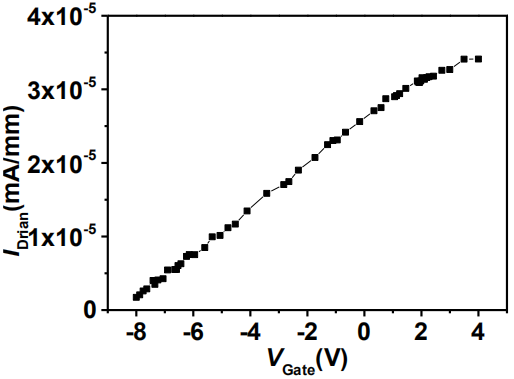
图2 薄势垒增强型AlGaN/GaN HEMT转移特性仿真曲线
当然,随着2DEG浓度的降低,器件对电流输运的能力也会降低,因此这种技术虽然在某种程度上实现了增强型功能,但是由于其对器件电流输运能力负面影响太大,不具有被看好的发展前景。与此类似的是含Al缓冲层技术。这种技术的思路是在外延片制备的过程中通过对AlGaN/GaN异质结的GaN层进行低Al组分掺杂,来降低异质结界面处的极化强度以减少极化电荷,进而降低2DEG浓度以实现增强型性能。本文对利用低Al组分缓冲层技术调制AlGaN/GaN异质结器件阈值电压进行了初步仿真验证,其中具有不同Al组分缓冲层的器件转移特性如图3所示。可以明显观察到器件随着含Al的GaN层中Al组分的提高,阈值电压开始右移。同时,随着Al组分的增高,饱和电流显著下降。在仿真中没有设置对漂移区的全覆盖栅,但可以合理地推断,当Al组分不断提高时,整个沟道中2DEG会被全部夹断,器件功能完全失效,此时的增强型便没有了意义。而当栅极对漂移区进行全覆盖后,漂移区又失去了耐压意义,这使得器件很难在功率系统中得到应用。
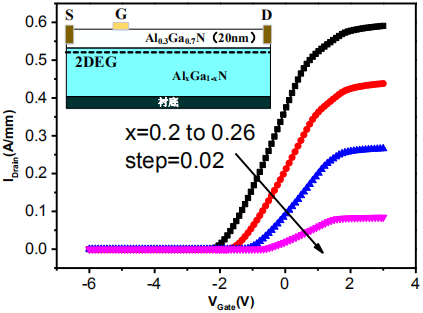
图3 含Al背势垒技术对AlGaN/GaN HEMT阈值电压的调制
为了解决这些问题,一个较为容易得到的思路即是将具有能带调制功能的结构局域化。2000年时X.Hu等研究人员提出了解决方案,他们制备出具有p-GaN帽层的增强型器件,使阈值电压达到2.5V。其原理是通过对帽层进行Mg元素的掺杂,和下方AlGaN层以及2DEG形成类似于p-i-n的半导体结,并耗尽沟道中的2DEG实现增强型性能。目前,p型帽层技术已经广泛应用在GaN功率开关的商业化产品中,如图4所示。但是,由于Mg金属在外延时的记忆效应,考虑到设备的维护,制备p型层成本极高,因此此技术的发展受到较大制约。同时,Mg掺杂需要高温退火激活才能有效形成p型杂质,这也增加了这类器件的工艺难度,限制了新结构的研发。

图4 EPC公司利用p-帽层技术制备的GaN增强型功率开关产品
同样地,利用GaN(Al/In)/AlGaN/GaN多异质结的相互作用也能实现增强型功能。具体来说,利用部分外延或选择性刻蚀技术在AlGaN/GaN异质结表面进行再外延,形成一层极化方向和异质结相反的AlGaN或InGaN等材料层,使得最表面的GaN(Al/In)/AlGaN异质结形成的极化电场方向和AlGaN/GaN异质结形成的极化电场方向相反。这样就能通过方向相反的两个极化电场相互抵消的方式,实现异质结局域净极化为零,进而实现增强型功能。其器件一般结构如图5所示。
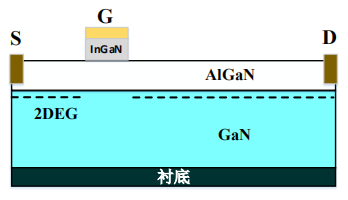
图5 用InGaN极化抵消层实现增强型GaN HEMT结构
随着外延技术的发展,越来越多的外延层可以被成功制备。其中选择性外延技术为GaN增强型器件新结构的设计开拓了新方向。最近,一种具有局域含Al组分混合缓冲层结构,实现了GaN异质结器件的增强型性能。图6所示的是应用此技术实现的混合缓冲层GaN异质结MISFET式横向功率整流器(LCB-FER)仿真剖面示意图,可以看到含Al的缓冲层位于阳极MIS栅下,这样既可以通过栅电压对AlGaN/GaN(Al)异质结进行能带调制,又相当于在漂移区集成了一个异质结二极管,极大提高了反向阻断能力。
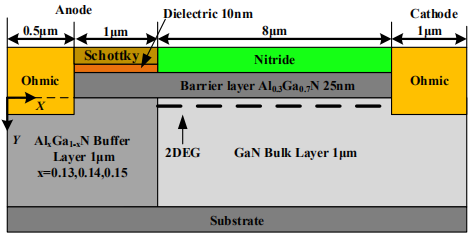
图6 用混合Buffer技术实现的高耐压LCB-FER仿真结构
图7(a)是仿真中LCB-FER的MISFET区域能带图。可以明显看到,随着局域低Al组分GaN层(LAC)的Al组分升高,MISFET下方沟道处导带不断提高。当MISFET金属功函数较高时,取LAC的Al组分为0.13则MISFET下沟道导带最低值即可提高至费米能级以上,使二极管具有整流能力。图7(b)是LCB-FER混合缓冲层(AlGaN-GaN)异质结二极管的能带图。可见混合缓冲层有效提高了阳极和MISFET结构下方的导带。
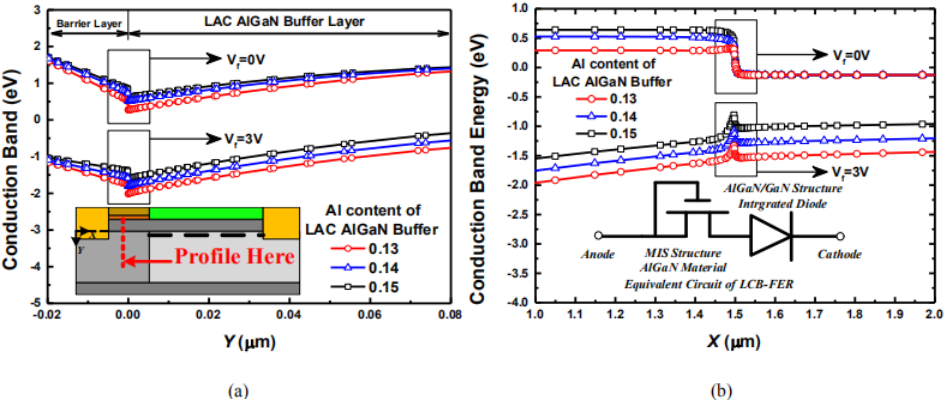
图7 LCB-FER能带结构。(a)阳极MISFET纵向能带分布;(b)混合缓冲层横向能带分布
图8是仿真中LCB-FER的I-V和BV曲线图。随着Al组分的升高,开启电压也在升高,而当Al组分为0.13时,器件和相同漂移区的MG-HAD相比在耐压方面具有相当大的优势,同时也保持了较为强劲的正向性能。
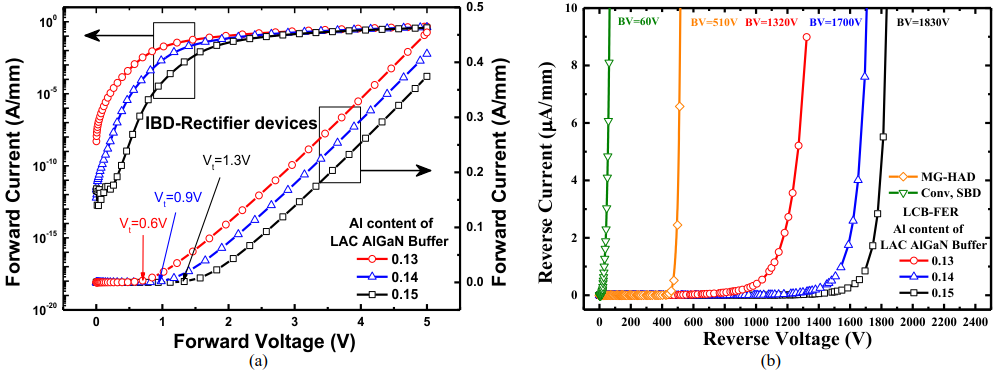
图8 LCB-FER的I-V曲线。(a)正向特性曲线;(b)反向特性曲线
综上所述,本设计实现了AlGaN-GaN异质结体二极管和AlGaN/GaN异质结横向二极管的集成。在实现MISFET区域增强型性能也即整流特性的同时,极大地提高了器件的反向阻断能力。而其中应用的混合缓冲层技术也为新型增强型GaN异质结器件的开发提供了崭新思路。