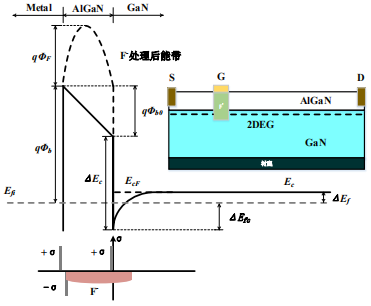
图1 F离子注入技术示意图
F离子注入技术的结构、能带、电荷分布如图1所示,利用离子注入机或感应耦合等离子体机(ICP)等设备,通过对带有负电荷的F离子进行加速,使之注入异质结的栅极下方区域。在注入的一瞬间,为了满足器件整体电中性,注入区域下方沟道的2DEG即被耗尽,此时2DEG沟道连续性被破坏,增强型性能得以实现。从能带图可以观察到,F离子的注入提高了AlGaN层的导带,同时使GaN层的导带也受到影响而提高。这种技术的优势在于,相较于外延技术,F离子注入技术对局部能带的调制成本大大降低。而从电荷分布状态可以明显看出,F离子注入技术的缺陷也是显著的,即注入电荷的均匀性难以控制,制备的增强型器件阈值电压稳定性不高,且注入离子分布较难控制,诸多数量的F离子会穿越异质结界面进入GaN层,使栅下沟道品质下降,这导致了晶格损伤、载流子迁移率下降等负面后果。
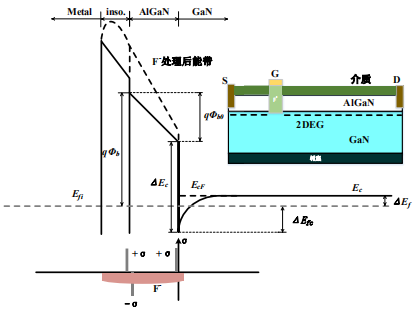
图2 介质F离子处理技术示意图
为了解决这个问题,2011年电子科技大学刘兴钊等人开发出一种介质F离子处理技术,使得F离子能够注入进介质中发挥作用形成增强型器件。其能带和电荷分布如图2所示。这种技术减少了F离子对异质结晶格的损伤,极大地提高了器件性能。但美中不足的是,这种技术使介质对F离子有较大地吸收作用,这降低了F离子对AlGaN与GaN层导带的抬升作用,因此所制备的增强型器件阈值电压仅在0V附近。
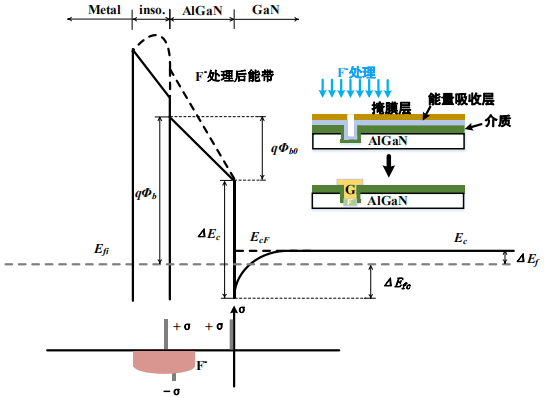
图3 F离子埋层半凹栅技术示意图
为了既增强F离子注入对栅极下方2DEG的耗尽,又尽量减少F离子对异质结晶格的负面影响,近期本文作者所在课题组的周琦博士提出了一种F离子埋层半凹栅技术来实现增强型器件。这种技术主要利用能量吸收层对注入的F离子进行有效减速,使F离子能更“柔和地”进入介质,之后通过溶液漂洗祛除能量吸收层,实现F离子的能带调制作用。其能带、电荷分布与简单的流程如图3所示。本文作者以及同课题组的杨溢共同对这种技术做了初步探索。利用仿真软件对能量吸收层以及介质材料进行选择以及厚度优化,得到了如图4所示的较优配置。即当能量吸收层选为25nm厚的SiN晶体,介质层选为15nm厚的氧化铝晶体,凹栅剩余10nm的AlGaN时,注入结果较为理想。
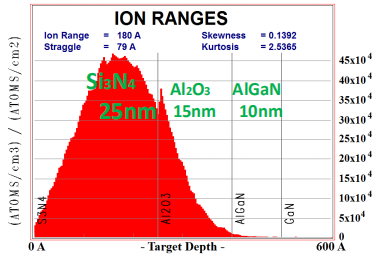
图4 F离子埋层半凹栅技术的注入工艺仿真优值
这种技术加强了F离子对栅极下方2DEG的耗尽作用,同时极大地降低了F离子对异质结晶格的损伤,并且通过对栅极进行凹槽刻蚀,降低了F离子与沟道的间隔,有可能实现高阈值电压的增强型器件,具有广泛的应用前景。