GaN具有高的最大饱和速度,因此在高频、高速方面应用潜力很大;GaN又有极佳的物理、化学稳定性,允许GaN器件在很高的温度下工作和具备高功率输出的能力;GaN有比其他材料高一个数量级的击穿电场,使得GaN电子器件有很高的栅、漏击穿电压,因此可以在更高的电压下工作;AlGaN/GaN界面附近二维电子气具有高的电子迁移率,使得氮化镓器件可应用于高频场合,也由于二维电子气的存在,使得GaN开关器件在栅源电压为0时,导电沟道已经形成,即为耗尽型器件。
在应用方面,GaN HEMT器件在减小导通电阻的同时提高耐压,有助于使用高电压的电路缩小体积、提高效率。其将在诸如电源、通信、汽车以及电器等各个市场领域的终端应用中极大地提高性能并削减能耗,且在开关变换器领域的卓越优势和巨大的市场空间促使耗尽型器件的应用研究。
为了克服常规的开关变换器控制方式难以直接驱动耗尽型器件的应用瓶颈问题,文中将致力于解决在现有的控制方式下实现GaN HEMT在开关变换器领域的应用,这将加快GaN HEMT器件在商业化后的市场推广应用。
1. GaN组合开关电路
为使现有驱动技术可对耗尽型的GaN HEMT器件实施控制,提出了一种如图1所示的组合开关电路,其中Q1为GaN HEMT,Q2为增强型MOSFET。其基本工作原理为:由外部的驱动器或控制器输出常规PWM信号来控制该组合开关的开启与关断,当驱动器或控制器输出高电平时,增强型器件Q2因为栅源电压正偏而导通,从而将Q2的源极电位下拉到低电平,使得GaN HEMT器件Q1的栅、源极间电压接近于零而使其导通;当驱动器或控制器输出低电平时,Q2截止,但由于Q2漏、源极间存在寄生电容,使得开关回路中的电流不可能突然减小到零,而是给Q2漏、源间的寄生电容充电,随着Q2漏源电压的上升,施加在Q1栅源极间的反向电压增加,当增加到Q1的夹断电压时,GaN HEMT器件Q1被关断,从而实现了在现有控制方式下对GaN HEMT实施有效地开关控制。
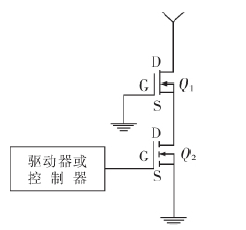
图1 组合开关驱动电路
为使在驱动器或控制器输出低电平时Q1能可靠关断,故在上述组合开关驱动电路的基础上增加了分压限压电阻R1和R2,如图2所示,电阻R1和R2分别并接在Q1,Q2的漏源极间,并使电阻R1和R2大大小于Q1,Q2关断时的漏、源极间的等效电阻,即如果Q1,Q2关断时的漏源极间等效电阻为RDS1,RDS2,则有R1《RDS1,R2《RDS2,但为避免产生太大的损耗,R1和R2的值也不能太小。
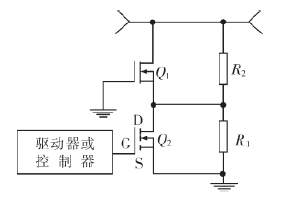
图2 组合开关驱动控制改进电路
图2中,在驱动器或控制器输出低电平时,当Q1栅源间的反向电压增加到其夹断电压时,Q1关断,Q2也关断,由于R1《RDS1,R2《RDS2,电路中电流会通过电阻R1继续对Q2的漏、源极间的寄生电容充电,从而继续将Q1的源极电位抬高,Q1,Q2的漏、源极间的电压最终由电阻R1和R2的分压值决定,Q2的漏、源极间电压即为Q1栅、源极间的反向电压,因此,可通过合理选择R1和R2,使得R2上的分压大于Q1的夹断电压,即可保证Q1可靠关断所需的栅、源极间的负偏置电压。同时,为了确保Q2的安全工作,R2的分压还必须小于Q2的漏、源极间的击穿电压。
2. 可快速关断GaN器件的驱动电路
上述组合开关驱动电路解决了对耗尽型GaN HEMT器件的开、关控制问题,并能可靠关断对GaN HEMT器件。但其关断速度不够快,故需要设计开关速度更快的驱动电路。
为此,所提出的快速开关驱动电路如图3所示,其中将P沟道和N沟道2个增强型开关器件Q1,Q2串联连接,它们在脉冲宽度调制信号的控制下交替导通,为GaN HEMT提供快速充放电回路,并将N沟道增强型开关器件Q2的漏、源极间电压反向加在GaN HEMT器件Q3的栅、源极间来控制其开通和关断。由外部驱动器或控制器输出PWM信号送到图3中的A点。当驱动器或控制器输出高电平时,Q1截止,Q2导通,Q2的漏、源极间电压接近零,使得GaN HEMT器件Q3导通。当驱动器或控制器输出低电平时,Q2截止,Q1导通,则电源VCC经Q1提供的电流和流经GaN HEMT器件(此时还未关断)的电流同时向N沟道开关器件Q2漏、源极间的寄生电容快速充电,随着Q2漏、源极间电压的快速上升,施加在Q3栅、源极间的反向电压也快速增加,当增加到Q3的关断负电压时,Q3关断。GaN HEMT器件Q3关断后,P沟道开关器件Q1保持导通状态,VCC继续向N沟道开关器件Q2的漏、源极间寄生电容充电,从而保证了Q3关断所需的负电压,确保Q3的可靠彻底关断。
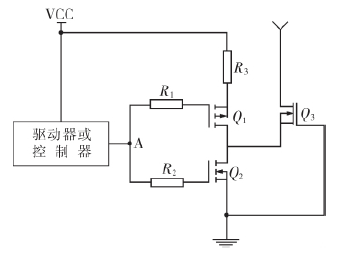
图3 快速开关驱动电路
进一步提高GaN HEMT器件开关速度的改进电路如图4所示,即在2个增强型开关器件的栅极电阻上分别并联二极管D1和D2,一是可加速P沟道增强型器件Q1和N沟道增强型器件Q2的开关过程,从而提高GaN HEMT器件的开关速度;二是可避免2个开关器件在开、关转换的瞬间同时导通而出现直通现象,以确保驱动电路工作的可靠性。这不仅解决了GaN HEMT器件的快速开通和快速关断问题,特别是快速关断问题,还能充分发挥GaN HEMT器件开、关速度快的特点,同时,工作安全可靠。
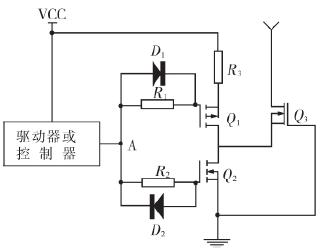
图4 快速开关驱动控制改进电路
该驱动电路的主要特点是在控制GaN HEMT器件关断时通过2个支路的电流同时向N沟道开关器件Q2的漏、源极间寄生电容充电,其中一个支路的电流是由电源电压VCC通过P沟道增强型开关器件Q1直接提供,它不受电源负载变化的影响,可使充电电压快速达到耗尽型开关器件所需的栅、源极间的关断负电压,使其快速关断,并在GaN HEMT器件关断时仍可通过P沟道增强型开关器件Q1继续向N沟道开关器件Q2的漏、源极间寄生电容充电,确保了耗尽型开关器件的可靠彻底关断;另一支路是由于Q2的漏源寄生电容,使GaN HEMT器件Q3关断的瞬间流过Q3的电流不能突变为0,而是给Q2的漏源寄生电容和Q3的栅源寄生电容充电,从而进一步保证了GaN HEMT器件Q3的可靠关断。
如图3和图4所示的驱动电路均在GaN HEMT器件Q3的导通时,其栅源电压约等于0,特别是当电流较大时,由于Q2的导通内阻将会产生一个较小的电压,这将使GaN HEMT器件Q3栅源承受一较小的负电压,这虽不影响GaN HEMT器件的开关工作状态,但却使其导通内阻偏大,从而产生较大的导通损耗,为此,可在图4的基础上,在GaN HEMT器件Q3的栅极加一较小的正电压,以使其导通时栅源电压较大而减小导通损耗,具体电路如图5所示,其通过电阻分压产生一较小的栅极正电压。
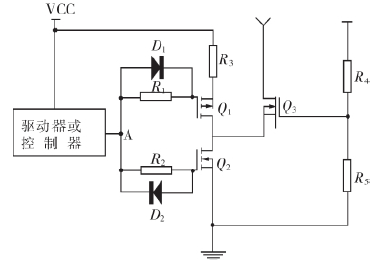
图5 电阻偏置式开关驱动电路
3. 实例及验证
3.1 组合开关电路的开关特性实验
如图6所示为组合开关电路的开关特性测试电路,其中Q1为耗尽型器件IXTH10N100D,Q2为增强型MOSFET器件FU120,电阻RL取20Ω,输入PWM脉冲频率为330kHz,占空比约为50%,高低电平分别为10V和0V,电源VCC取20V。
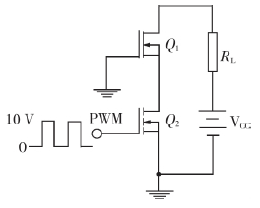
图6 组合开关驱动控制测试电路
由图6测得Q2栅极和Q1源极对地波形如图7所示,可见,当外加PWM脉冲为低电平时,由于此时Q1尚未完全关断,故其源极电压在Q2作用下被充至3V,从而使Q1承受-3V的栅源电压而关断,从而实现了PWM脉冲对耗尽型器件Q1的控制。
另由测试电路测试得到Q2栅极和Q1漏极的开关波形如图8所示,其更直接地反映了Q1的开关工作状态,并从图中也可看出其漏极电压完全上升至电源电压VCC的时间约400ns。
3.2 快速开关驱动电路的特性测试
快速开关驱动测试电路如图9所示。

图7 Q2栅极(2)和Q1源极(1)波形

图8 Q2栅极和Q1漏极波形
其中R1,R2分别取20Ω,以防止Q1,Q2的栅极电压波形振荡,同时具有限制峰值电流的作用;漏极电阻R4取100Ω;D1,D2为快恢复二极管,以加快Q1,Q2的关断速度;电源VCC取10V,信号发生器输出脉冲信号频率为200kHz,高低电平分别为10V和0V。

图9 快速开关驱动控制测试电路
当R3取10Ω时,由图9测得A点和Q3的源极对地波形如图10所示,由图可知,在A点常规PWM脉冲作用下,Q3的栅源电压由于其栅极接地而转换为正负脉冲,从而实现了Q3开关控制。

图10 A点(2)和Q3源极(1)对地波形
为了测试此驱动电路的开关时间,现测得Q3的源极和漏极电压波形如图11所示,图中显示了Q3器件的关断时间为260ns。

图11 Q3源极(1)和Q3漏极(2)对地波形
现将图9中的R3换成50Ω,同样测得Q3源极对地波形如图12所示。

图12 Q3源极对地波形
由上图可明显看出,由于R3的增加,使得信号发生器输出低电平时,电源VCC通过Q1向Q3的栅源电容的充电时间常数变大,从而使得Q3的源极电压上升速度变慢,图中显示其电压的上升时间为788ns,这远远大于当电阻R3为10Ω时的上升时间,将大大地影响到Q3的开关速度。故也可看出此快速开关驱动电路与组合开关驱动电路相比的一个主要特点是其具有灵活可调的开关速度控制。
4. 结论
针对耗尽型GaN HEMT器件的负电压关断特性,提出了GaN HEMT器件与增强型MOSFET的组合开关电路,应用现有驱动控制技术即可对耗尽型的GaN HEMT器件实施开、关控制。
所提出组合开关驱动电路通过控制寄生参数相对较小的增强MOSFET,从而达到对高压大功率耗尽型GaN HEMT器件的控制,具有控制电路简单可靠的特点。
所提出快速开关驱动电路中,将耗尽型GaN HEMT器件的栅极接地,通过控制其源极电压从而达到在常规PWM脉冲情况下对其施加控制的目的,且电路设计中外加了独立的充放电回路来加快GaN HEMT的开关过程,从而可以更有效地发挥高速GaN HEMT器件的优势。
