这种器件是GaN基HEMT的一种新形式。由于HEMT结合了高速开关和极高击穿电场两大特性,这类器件在功率电子学领域有着广阔的应用前景。
这个团队所开发器件的一个优点是它是常关型的,这赋予了HEMT安全的操作特性。由于在AlN和GaN界面极化会产生二维电子气,使得GaN基HEMT一般倾向于采用常开型。
根据文章的通信作者,来自Honik大学的HoYoung Cha的说法,有一些研究团队对GaN基HEMT器件进行了调整来制作常关型HEMT,所采用的方法包括有氟处理、或者是引入凹栅或p型栅,然而这些调整都会对晶体管的电流密度产生限制。
他强调说,想要实现常关型高电流密度的HEMT,除了上述的调整方法之外,唯一的替代方案就是将一个常开型HEMT与硅的MOSFET进行配对。MOSFET以共源共栅方式连接,充当了开关作用,然而使用两个器件来形成常关型HEMT无疑会增加成本。
这个团队所开发的器件中还包括有一个肖特基势垒二极管,它是嵌入在具有MOS栅常开型HEMT的输入端位置。
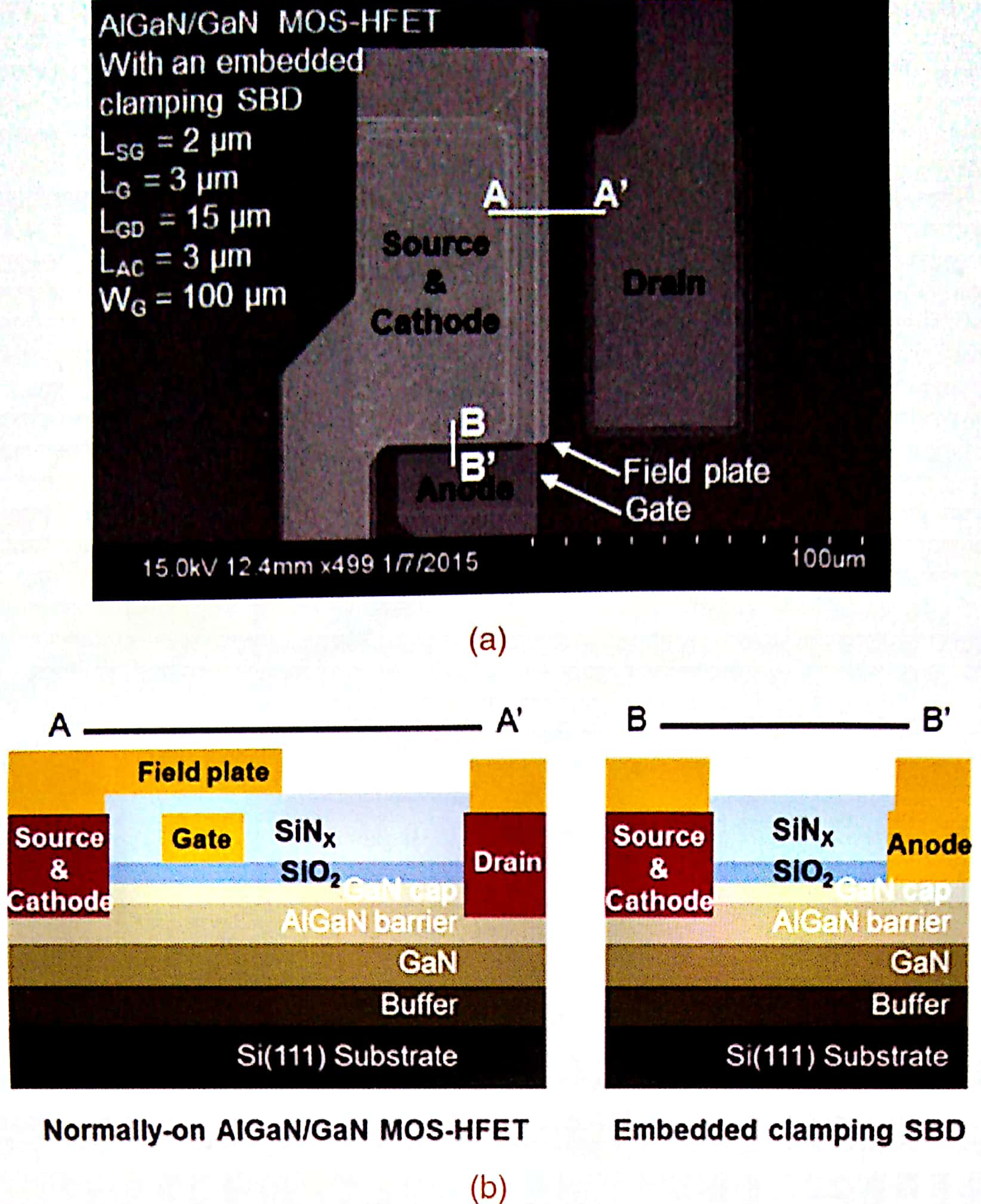
Cha表示:“二极管的嵌入式集成并不会增加成本,因为它几乎不需要额外的空间或者加工工序”。他还补充道,唯一需要增加的工序就是要在器件上增加一个电容器。
“如果一个芯片的电容是集成在功率器件的封装中,而不是以单片集成形式制作的电容,那么它的成本要远远低于硅MOSFET。因此,从成本控制的角度来看,我们的方案比共源共栅方案要更好”。
工程师是用GaN/Si外延晶圆来制备器件,采用了p型导电衬底,之上是3.9μm厚的碳掺杂GaN缓冲层、0.4μm厚的GaN沟道层、20nm厚的AL0.25Ga0.75N势垒层,以及2nm厚未经掺杂的GaN层。通过刻蚀形成有源区之后,利用酸和溶剂清洗晶圆,之后装入等离子体增强CVD生长室来生长30nm厚的SiO2层。
在刻蚀出欧姆接触区之后,再淀积一个金属叠层并且进行退火,然后进一步刻蚀出肖特基接触区。
采用一个Ni/Au叠层来形成肖特基二极管的正极,之后通过在氧气气氛中400℃温度下退火20分钟以提升氧化层和界面的质量,最后再加入一个场板来抑制陷阱效应。
对这种新型的HEMT的伏安特性测试显示,其关态击穿电压超过900V,开态电阻为2.34mΩ cm2,栅阈值电压为-14V,零栅极电压下的最大漏极电流密度为600mA/mm。这个电流密度几乎是其它常关型HEMT结构的两倍,无论它们是经过了氟处理,还是引入凹栅或者p型栅结构。
将一个电容与HEMT连接可能会引发对高速高频开关能力退化的担忧,这有可能会影响这种器件来取代现有硅基器件的进程。
Cha对此做出回应:“只要电容在开始状态下就已经充电,这种箝位电路并不会限制开关的频率特性,只要这个电容还没有放电”。
