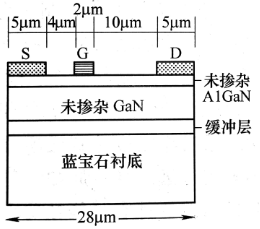
图1 Gan常规 HEMT结构示意图
该器件栅宽157mm的样管(芯片尺寸4mm×4mm)在直流测试和脉冲测试条件下的漏极电流分别超过7A和30A,相应的通态比电阻分别为16.2mΩ·cm2和14.5mΩ·cm2;而栅宽100μm的样管在直流测试条件下的漏极电流超过30mA,通态比电阻只有6.01mΩ·cm2。
这种器件的阻断电压是栅-漏电极间距的函数,而且电场主要集中在栅-漏极间的栅极边沿,因而须采用场板技术做终端保护。该实例主要是为了表现2DEG沟道的大电流效果,未采用任何终端保护。因此其栅宽100μm的样管在栅-漏极间距为8μm时的阻断电压只有340V。
