1) 用MOCVD法在蓝宝石衬底上顺序外延2.5μm不掺杂的GaN和总厚20nm的变杂质浓度Al0.125Ga0.375N势垒层,各层厚度及掺杂层的杂质浓度如图所示。霍尔测试表明势垒层的薄层载流子密度为1.3×1013/cm,电子迁移率为1100cm2/V·s。
2) 用Cl2/He等离子体RIE刻出元胞两侧的隔离台面。
3) 用电子束蒸发顺序淀积Ti/Al/Ni/Au,然后用快速退火法在850℃的氮气氛中退火30s,形成源和漏的欧姆接触。其接触电阻和薄层电阻分别为1Ω·mm和400Ω。
4) 在RIE掩膜的栅极位置上开长度为1μm的栅极窗口,然后在RIE系统的CF4等离子体中对窗口内的 Algan/GaN注氟。用150W等离子体功率和170s处理时间即能在其中掺入足够密度的氟而使器件成为增强型。
5) 用电子束蒸发淀积Ni/Au栅电极。
6) 在栅漏之间靠近栅极处开LDD注氟窗口,然后跟第4步相似地进行注氟处理,但处理时间要短,只需45s。然后在400℃的氮气氛中退火10min。
该器件所有试验样品的栅长LG和栅源距LGS都固定为1μm,而LDD窗口长度LLDD和栅-漏距LGD对不同的样品取值不同,包括LLDD=0的对比管。
经过这样两次注氟处理之后,源-漏之间AIGAN/GaN异质结中2DEG的电子密度n2DEG形成了如图所示的阶梯式分布。
对试验样管的测试结果表明,栅下注氟能有效地将 GAN HEMT从耗尽型变成增强型,其LGD=3μm的样管阈值电压都是+0.75V(参考文献报道的类似工作在注氟条件为150W、150s时阈值电压达到+0.9V),最大跨导都是150mS/mm,最大输出电流都是300mA/mm,改变LLDD对这些特性的影响不大。但LDD结构对改善器件的阻断特性和抑制电流崩塌的作用十分明显。在不加场板电极的情况下,利用LDD结构可将同等规格器件的击穿电压提高50%,而且不降低器件的截止频率和电流增益。LDD对电流崩塌的抑制能力跟LLDD在LGD中所占比例有关,比例太小抑制作用不明显,栅-漏间全部注氟可以完全抑制电流崩塌。
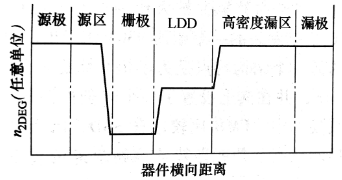
图1 LDD-HEMT中2DEG密度的横向分布示意图
