氮化镓MOSFET的栅氧化物只能用淀积法来制备,因而可选品种很多,但根据大量实验结果看,最好的还是SiO2。
2006年,RPI的周达成研究室发表了一个用蓝宝石上的p型和n型GaN外延层制作常关型横向 MOSFET的对比报告。该器件的剖面结构非常简单,如图1所示。其p型外延层厚4.6μm、掺杂浓度4×1015cm3,其n型样品为未经刻意掺杂的外延层,厚度3μm。两种样品的源漏区都用Si离子选择注入形成,注入剂量为3×1015cm2,深度0.25μm,然后在600nm Sio2的保护下送入1100℃的氮气氛中退火5min以激活注入的Si。在用 PECVD淀积SiO2之前要对芯片进行清洁处理。重新淀积100nm Sio2并在1000℃的氮气氛中退火30min作为栅介质。然后溅射650nm多晶硅做栅。该器件的源、漏欧姆接触用Ti/Al双层膜经700℃氮气氛快速退火30s来实现。
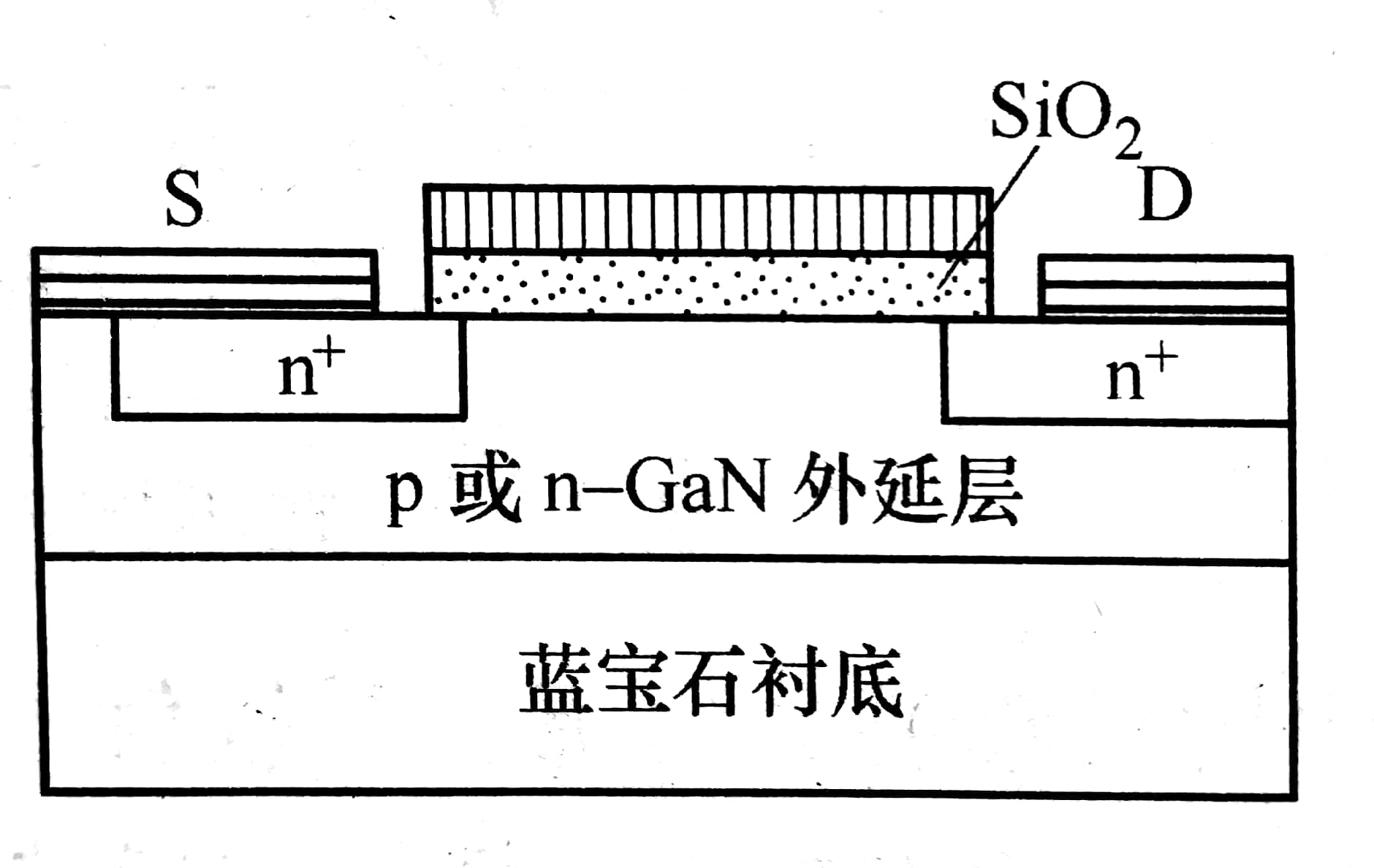
图1 GAN MOSFET结构示意图
该器件的平面结构有线形和环形两种。图2是分别做在p型外延层和n型外延层上的两个环形样管的输出特性曲线,其沟道长皆为20μm、宽皆为800μm。同样两个样管的转移特性曲线如图3所示。
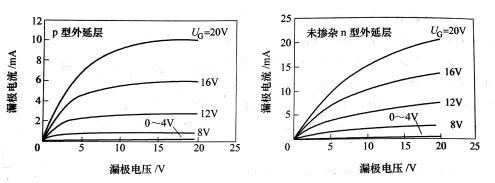
图2 在不同外延层上制作的氮化镓 MOSFET的输出特性
由图3所示的转移特性曲线可见,这两个样管的阈值电压分别为3.3V和1.5V,最大场效应迁移率分别为97cm2/V·s和104cm2/V·s。由于场效应迁移率的推算要受到源、漏接触电阻的影响,沟道越长,源、漏接触电阻在总电阻中所占比例越小,场效应迁移率的推算就越准确。参考文献用沟道长度为100μm的环形样管测到的场效应迁移率高达167cm2/V·s。
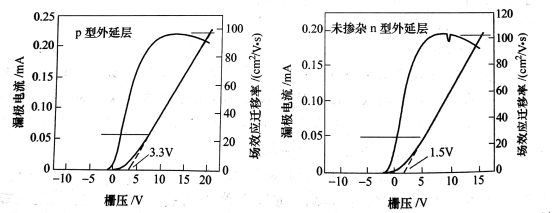
图3 在不同外延层上制作的氮化镓 MOSFET的转移特性
这种器件的阻断电压是栅-漏极间距的函数。使用栅-漏间距不同的n型外延层样管在固定栅压-20V下进行的阻断电压测试结果表明,栅-漏间距为16μm的样管的阻断电压可达960V。如果引入RESURF设计,其阻断特性和导通特性也会大有改善,在1000V阻断电压要求下的通态电阻大约要比硅 MOSFET低两个数量级。
