1. MOS二极管的基本结构
理想MOS电容可定义为:
(1)仅半导体体内和金属内靠近介质层处存在电荷,不存在界面缺陷和氧化层电荷;
(2)直流偏置条件下,介质层内没有载流子通过;
(3)金属功函数和半导体功函数相等。
图1为理想MOS二极管的剖面结构图,由金属层、氧化层和n型半导体层组成,其中V是施加在电极上的电压,d为介质层的厚度。图2为不加偏压时理想MOS电容的能带图,其中金属功函数φm定义为金属费米能级到真空能级间的能级差,电子亲和势χ定义为导带底到真空能级间的能级差,此时能带并没有发生弯曲,即为平带状态。MOS结构整体相当于一个电容,上层的金属和下层的欧姆接触等同于电容的两端,当外加偏压V时,偏压一部分落在介质层上即Vox,一部分落在n型半导体上即Vs。
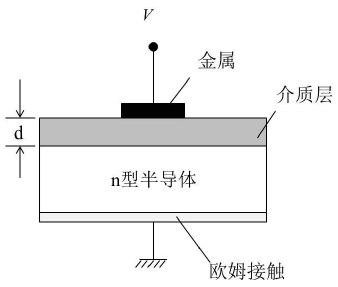
图1 理想MOS二极管剖面结构图
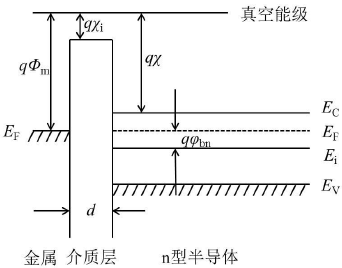
图2 不加偏压下理想MOS电容能带图
MOS结构的电容可定义为:

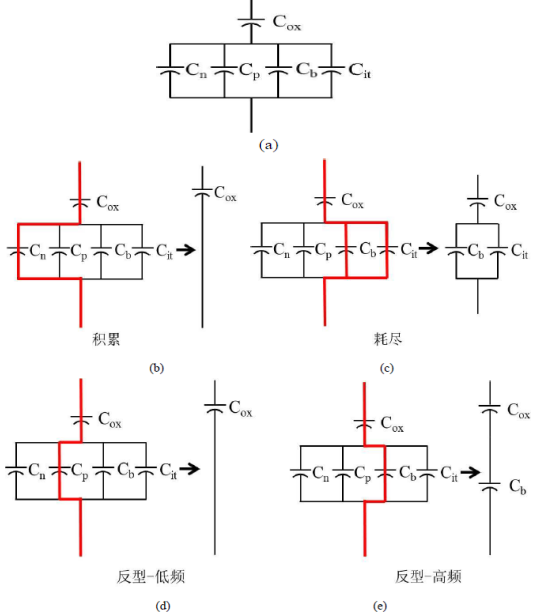
图3 不同状态下的等效电路图(a)一般情形;(b)积累;(c)耗尽;(d)低频反型;(e)高频反型
(1)积累状态。对于n型衬底来说,当MOS二极管的外加偏压为正时,介质层/半导体表面产生大量负电子,表面处能带向下弯曲,引起EF-Ei能级差变大,进而提升电子的浓度,使电子在介质层/半导体表面处堆积,形成积累现象,能带图如图4(a)所示。此时,Cn占主导作用,且Cn过大形成短路,电路等效为只有氧化层电容Cox,如图3(b)所示。
(2)耗尽状态。当施加的外加偏压为小负偏压时,半导体表面处能带向上弯曲,电子形成耗尽现象,能带图如2-4(b)所示。此时,电路等效为空间电荷区电容和界面缺陷电容并联,且空间电荷区电荷浓度Qb=-qNdW占主导作用,如图3(c)所示。
(3)反型状态。当进一步增加负偏压,半导体表面处费米能级继续向上弯曲,使表面本征费米能级Ei超过费米能级EF,呈现反型现象,此时表面处空穴数目远大于电子数目,能带图如图4(c)所示,此时,空穴电荷占主导作用。若为低频电路,空穴能够跟随电路频率变化,Cp过大形成短路,电路等效为只有氧化层电容Cox,如图3(d)所示;若为高频电路,反型电荷跟不上电路的频率,反型层无法建立,等效电路如图4(e)所示。
综上所述,由于等效电路只有在耗尽情形下包含界面缺陷的信息,因此在使用电容法表征界面缺陷时常常将测量电路保持在耗尽区状态。
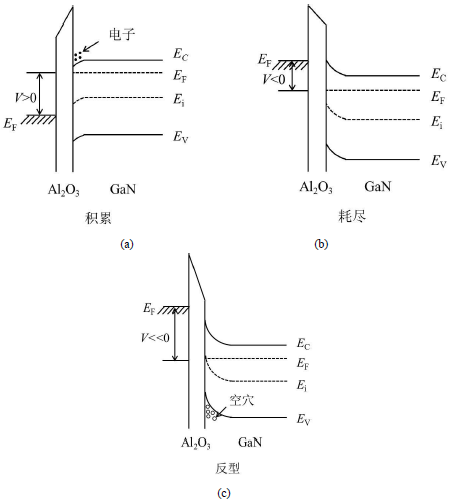
图4 理想Al2O3/n-GaN不同状态下的能带图 (a)积累;(b)耗尽;(c)反型;其中实心黑点为电子,圆圈为空穴
2. MOS电容的参数提取
高频C-V法由于对表征设备和器件要求低,且能准确表征器件特性参数,因此在研究半导体器件性能方面具有重要意义。本节主要研究通过高频C-V曲线提取器件的重要物理参数,如氧化层厚度dox、掺杂浓度Nd、平带电压等VFB。
(1)氧化层厚度和氧化层电容
MOS器件的氧化层厚度可由公式(2-7)计算,其中A为器件的电容面积,ε0为真空介电常数,约为8.85×10-14F/cm,εox为氧化层介电常数,Cox为氧化层电容。由MOS基本理论可知,当正偏压足够大时,即强积累区状态下,氧化层电容Cox等于电容最大值Cmax。因此,可通过高频C-V曲线的电容最大值获得氧化层电容,进而获得氧化层厚度。

(2)衬底施主掺杂浓度
金属与半导体接触的耗尽层类似于单边突变结,当金属与n型半导体接触时,x<Wd时,ρ≈qNd;x>Wd时,ρ≈0,且ε≈0,其中Wd为耗尽层宽度,得到

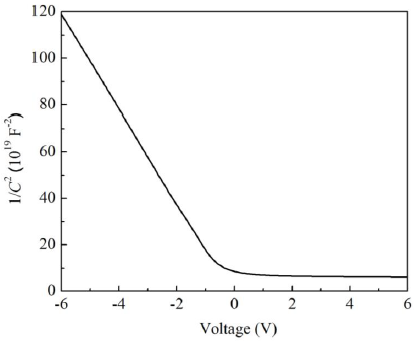
图5 均匀掺杂半导体的1/C2-V曲线
(3)平带电容和平带电压
平带电压是表征MOS器件电容特性的重要参数,通常从高频C-V曲线获得平带电容,通过平带电容确定平带电压。半导体表面势为零时的表面能带称为平带,此时的电容称为平带电容CFB,电压称为平带电压VFB。平带电容由公式(2-14)计算:


(4)阈值电压
阈值电压Vth是MOS器件中重要的物理参数之一,可定义为:从平带状态到半导体表面发生强反型时的栅极偏压称为MOS器件的阈值电压,即平带电压、氧化层上分得的电压与半导体上分得的电压的总和:

