界面缺陷态可用类施主类受主理论来解释:对n型半导体来说,定义中性能级E0以上缺陷态为类受主态(无电子占据为电中性,有电子占据带负电),中性能级以下为类施主态(无电子占据带正电,有电子占据为电中性),能带图如图1(a)所示,其中实心黑点为电子。当外加偏压为零时费米能级EF以上为空,且为电中性;EF以下被电子占据,中性能级至EF间缺陷态被电子占据,带负电;中性能级以下被电子占据,为电中性。
(1)当外加偏压为正时,半导体表面呈现积累现象,半导体表面能级向下弯曲,此时几乎所有的界面缺陷态都在EF以下,被电子全部占据,类受主缺陷态带负电,类施主缺陷态为电中性,因此总的界面缺陷态带负电,能带图如图1(b)所示。
(2)当外加偏压为小负偏压时,半导体表面呈现耗尽区,半导体表面能级向上弯曲,此时,类受主缺陷态部分呈电中性,部分带负电,类施主缺陷态呈电中性,因此总的界面缺陷态带负电,能带图如图1(c)所示。
(3)当继续增大外加负偏压时,半导体表面呈现反型区,半导体表面能级继续向上弯曲,此时类受主缺陷态全部在EF之上,类受主缺陷态未被电子占据,呈电中性,类施主部分未被电子占据带正电,部分被电子占呈电中性,因此总的界面缺陷态带正电,能带图如图1(d)所示。
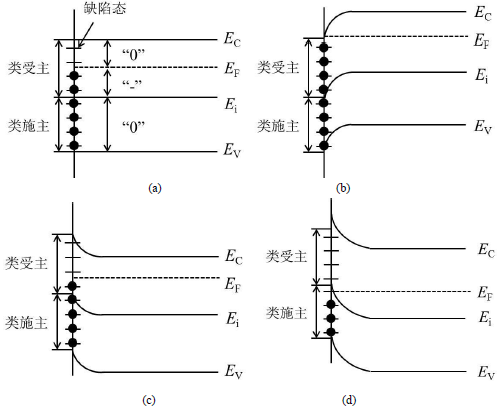
图1 不同状态下界面缺陷态的能带图 (a)无外加偏压;(b)积累型;(c)耗尽型;(d)反型,其中实心黑点为缺陷态捕获的电子
1. 准静态法
准静态法也称为高-低频电容法,是表征Si系统界面特性的一种常用方法,能够表征SiO2/Si系统中整个禁带宽度的界面缺陷态密度。其基本原理为:将低频法测出的C-V曲线与理想的无界面缺陷的C-V曲线相比较,由于频率足够低,界面缺陷态会响应低频信号,使C-V曲线发生变化,对比理想C-V曲线可计算出界面缺陷态密度。低频电容可由式(1)计算:
 (1)
(1)
准静态法在表征过程中对以下两点具有较高要求:(1)对介质层的薄膜质量要求高,漏电流要小;(2)对测量环境要求高,环境的噪声数量级要足够低。虽然准静态法能够表征SiO2/Si系统整个禁带宽度范围内的界面缺陷,但是在GaN系统中,GaN的电子发射时间极长、少子产生速率极低,GaN深能级的缺陷态无法响应测量信号,因而使用准静态法表征GaN系统的界面缺陷态,获得界面缺陷态密度的能级深度十分有限。因此,若使用准静态法表征GaN MOS结构需进行修正。
2. 电导法
电导法由Nicollian和Goetzberger于1967年提出,是表征界面缺陷态密度最灵敏的方法,能表征量级为1010cm-2eV-1及以下的界面缺陷态。其基本原理是:对n型半导体而言,当器件处在耗尽区(负偏压)状态时,电子费米能级向价带处移动,界面缺陷态能够捕获和发射载流子,与衬底进行载流子交换,导致能量发生损耗,损耗量Gp与能级Et处的界面缺陷密度有关,由此表征界面缺陷信息。
电导法的等效电路如图2(a)所示,包含氧化层电容Cox、半导体电容Cs、界面缺陷态电容Cit,界面缺陷态捕获和发射载流子用电阻Rit表示。
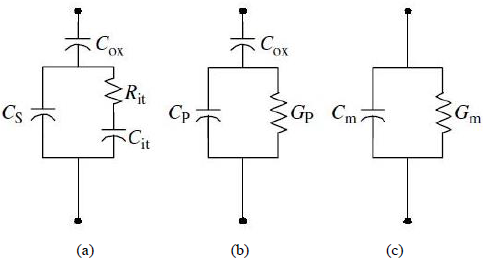
图2(a)电导法的等效电路图;(b)耗尽状态电容等效电路图;(c)不考虑寄生电阻的等效电路图
图2(b)是耗尽状态下电容等效电路图,不考虑寄生电阻的情况下,将电路等效为图2(c)所示电路,可得:

3. Terman法
Terman法,也称为室温高频电容法,是由Terman开发的一种表征界面缺陷密度的一种方法。其基本思想基于以下假设:(1)中性能级E0以上为类受主缺陷,中性能级E0以下为类施主缺陷;(2)设置的频率足够高,使得界面缺陷跟不上扫描速度,但是能够响应直流信号,因此界面缺陷态不贡献额外的电容分量。换句话说,当给处于耗尽状态下的器件一个小的外加偏压,会引起额外的半导体电荷QG=-(Qb+Qn+Qit),且:

 (9)
(9)