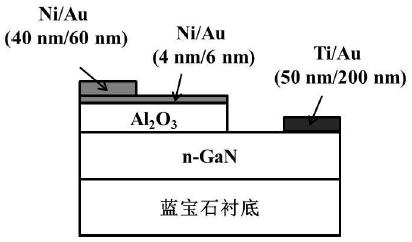
图1 器件截面结构图
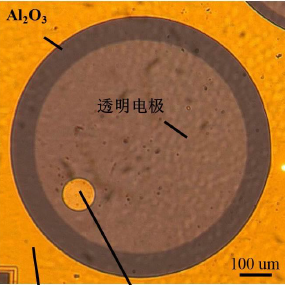
图2 器件俯视图
器件制备的主要工艺流程包含清洗、光刻定义图形、生长Al2O3薄膜、制备欧姆接触、制备肖特基透明电极、制备肖特基接触电极,具体工艺步骤如下所示。
1. GaN外延片清洗
去离子水(DIW)超声清洗5min;丙酮溶液超生波清洗5min;DIW冲洗;HCL:H2O=1:1溶液浸泡3min;DIW冲洗;2%HF溶液浸泡10s;DIW冲洗;N2吹干。
2. 使用光刻板1制作对准标记
3. 光刻板2定义Al2O3生长区域
(1)匀胶:
AZ5214反转胶:500转/秒×9秒;5000转/秒×30秒。
AZ5214反转胶,其特性为一次曝光后,曝光区域的光敏成份转变成羧酸,可溶于碱性显影液,作为正胶使用;再经过硬烘焙和泛曝后,高温使得光刻胶中树脂成分发生交联反应,羧酸对交联反应具有促进作用,于是曝光区域交联反应较多,溶解性降低,从而未曝光区域溶于显影液,实现反转特性。
(2)软烘焙:
在100℃下软烘焙30秒。
软烘焙的意义在于蒸发掉光刻胶中的一部分溶剂,一方面是为了排除后续光刻过程中溶剂对光的吸收,另一方面是为了让光刻胶与衬底表面较牢固地黏在一起。
(3)前曝:
使用光刻板2进行前曝5秒。
前曝的目的在于将光刻胶中曝光区域内的光敏成分转变成羧酸,变成可溶区域。
(4)硬烘焙:
在120℃下硬烘焙90秒。
硬烘焙的意义在于进一步蒸发光刻胶中的溶剂,使光刻胶与衬底黏结更牢。
(5)泛曝:
移除光刻板泛曝20秒。
泛曝的目的在于使前曝过程中曝光区域从可溶变为不可溶,实现反转特性。
(6)显影:
放入碱性显影液中显影30秒。
4. ALD技术制备
Al2O3将样品放入ALD设备中,300℃下制备5nm厚度的Al2O3非晶薄膜。
5. 剥离光刻胶
将样品放入丙酮浸泡1分钟;DIW冲洗;N2吹干,以移除光刻胶。
6. 光刻板3定义欧姆接触图形
匀胶:AZ5214:500转/秒×9秒;5000转/秒×30秒;
软烘焙:100℃×30秒;
前曝:光刻板3,曝光5秒;
硬烘焙:120℃×90秒;
显影:碱性溶液中显影30秒;
7. 淀积欧姆接触电极
PVD生长Ti/Au(50nm/200nm)欧姆接触。
8. 剥离光刻胶
丙酮浸泡1分钟,DIW冲洗,N2吹干。
9. 快速热退火
700℃的N2下快速热退火1分钟。
10. 光刻板2定义肖特基透明电极图案
匀胶:AZ5214:500转/秒×9秒;5000转/秒×30秒;
软烘焙:100℃×30秒;
前曝:光刻板3,曝光5秒;
硬烘焙:120℃×90秒;
显影:碱性溶液中显影30秒;
11. 淀积肖特基透明电极
PVD生长Ni/Au(4nm/6nm)肖特基透明电极。
提高光的透过率。
12. 剥离光刻胶
丙酮浸泡1分钟,DIW冲洗,N2吹干。
13. 光刻板4定义肖特基接触电图案
匀胶:AZ5214:500转/秒×9秒;5000转/秒×30秒;
软烘焙:100℃×30秒;
前曝:光刻板3,曝光5秒;
硬烘焙:120℃×90秒;
显影:碱性溶液中显影30秒;
14. 剥离光刻胶
丙酮浸泡1分钟,DIW冲洗,N2吹干。
15. 器件完成
器件制备的主要工艺流程如图3所示。
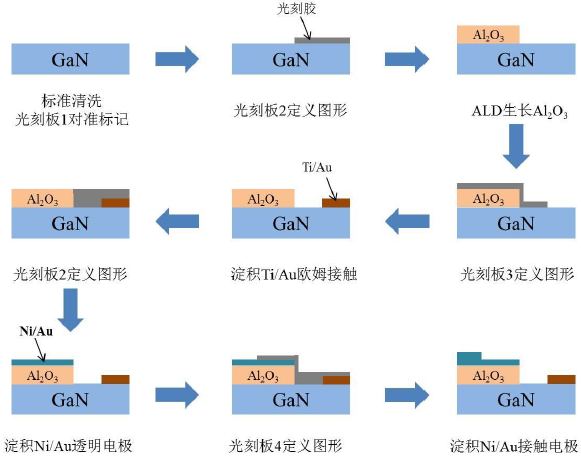
图3 器件制备工艺流程图
