1. GaN深能级电子发射时间及少子产生速率
GaN为宽禁带半导体,介质层与其界面存在深能级缺陷态。外加偏压时,费米能级快速扫过深能级缺陷态,被深能级缺陷态捕获的电子具有极长的电子发射时间,无法在有限的测量时间内发射到导带中去。因此传统的C-V法无法表征深能级缺陷态密度。根据Shockley-Read-Hall理论,电子发射时间τ可表示为:
 (1)
(1)式中,Vth为电子热运动速度约为2.6×107cm/s,σth为电子捕获截面约为10-19cm-2,NC为GaN导带有效态密度约为1.2×1018cm-3,EC、ET分别为导带和缺陷态能级。
图1给出了公式(1)计算所得的τ与缺陷态能级深度(EC-ET)的关系。可以看出,距导带底0.5eV处的缺陷态中电子发射至导带需要时间约70s,而禁带中间能级的电子发射时间高达1021s。

图1 室温下GaN中电子发射时间常数与能级深度的关系
此外,GaN的少子热产生速率极低,深能级被陷电子与反型空穴的复合速率极低。室温平衡状态下少子的热产生速率可表示为:
Gth=βnn0Pp0 (2)
式中,复合系数β室温下约为10-14cm3s-1,nn0和pp0分别为热平衡下n型GaN中的电子和空穴浓度。可计算得室温下GaN中的少子热产生速率约为106cm-3s-1,远低于Si的1017cm-3s-1。综上所述,由于室温下GaN中电子发射时间极长、少子产生速率极低,传统的低频法、Terman法等无法准确地表征Al2O3/GaN的深能级缺陷密度,因此需要开发新的方法表征Al2O3/GaN的界面缺陷。
2. 变波长光辅助高频C-V技术
基于GaN材料的特性,无法在室温下获得禁带中间及禁带以下的缺陷态密度分布,只能通过变波长光辅助C-V法估计部分能级的界面缺陷态密度平均分布值。我们的测量方法为:首先在室温无光环境下,从积累区(正偏压)向耗尽区(负偏压)扫描偏压,获得无光条件下的C-V曲线;然后保持样品在耗尽区状态下,使用能量为Eλ1=hv1(能量低于禁带宽度)的光垂直照射样品表面1分钟,再在室温无光环境下从耗尽区扫描回积累区,获得C-V曲线1;继续保持样品在耗尽区状态下,使用能量为Eλ2=hv2(hv2>hv1)的光垂直照射样品表面1分钟,再在室温无光环境下从耗尽区扫描回积累区,获得C-V曲线2,以此类推,所使用光的波长分别为1168nm、1003nm、932nm、650nm、435nm,获得如图2所示的C-V曲线图。
光的能量与波长之间的关系如式(3)所示:
E=hc/λl (3)
其中h=4.14×10-15eV·S为普朗克常量,c为光速,λ为光波长。通过计算得不同的波长对应的能量为:Eλ1=1eV,Eλ2=1.2eV,Eλ3=1.3eV,Eλ4=2.0eV,Eλ5=2.8eV。
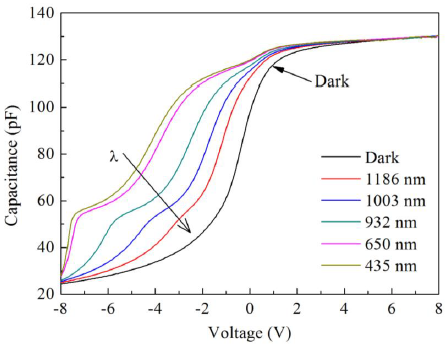
图2 变波长光辅助法C-V曲线
图2中,最下面的黑色实线为无光条件下测得的样品C-V特性曲线。我们发现,当负偏压进一步增大时,样品并没有出现反型的现象,而是继续表现出耗尽行为,这就是宽禁带半导体中常见的深耗尽行为。GaN中少子产生速率极慢,当偏压进入反型区时,反型层无法形成。少子产生速率极慢意味着电子的准费米能级将随着偏压上下移动,而空穴的准费米能级由于较长的产生时间而保持不变,即少子的热产生速率极低,无法跟上偏压的扫描速度和半导体表面势的变化速度。
n型GaN的施主掺杂浓度可表示为:
 (4)
(4)式中,q为电子电量,εs为GaN的介电常数。作出样品耗尽区1/C2D与V关系应为一条直线,如图3所示,将直线延长与横坐标交点为平带电压0.2V,求出Nd为1×1017cm-3,与设计参数基本一致。
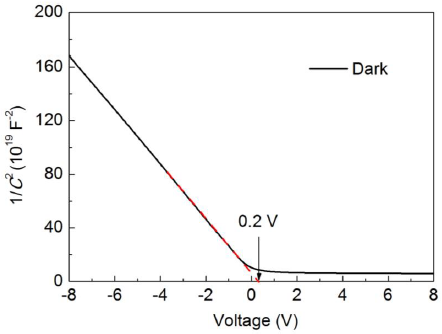
图3 室温无光下样品的1/C2-V关系
光照后,样品的C-V曲线均沿负偏压方向延伸,且能量越高的光,C-V曲线延伸现象越明显,表明系统中引入了正电荷。具体的物理过程可描述为:在正偏压时,样品处于积累区,界面缺陷态都在电子费米能级以下,缺陷能级全部被电子占据,能带图如图4(a)所示。当光入射耗尽状态下的Al2O3/GaN界面时,负偏压下GaN表面的能级向上弯曲,半导体界面附近会产生大量的电子-空穴对,在内建电场的作用下,电子带负电向中性区移动,空穴带正电向界面处移动,这样界面处被陷的缺陷电子能与空穴复合,能带图如图4(b)所示;当直流偏压从耗尽区向积累区扫描时,被排空的缺陷态重新捕获GaN中的电子,系统中引入正电荷,电容曲线沿负偏压方向延伸能带图如图4(c)所示。

图4 不同状态下Al2O3/n-GaN结构能带图,(a)积累区界面缺陷态被电子占满;(b)光照时产生电子-空穴对;(c)从耗尽区扫描回积累区,界面缺陷捕获GaN导带中电子能带图;其中实心黑点为电子,圆圈为光生空穴
3. 界面缺陷态平均值计算
在忽略氧化层缺陷电荷的情况下,当使用能量为Eλ1的光照射耗尽状态下的Al2O3/n-GaN时,E=Eλ1以上的缺陷态被光生空穴复合,E=Eλ1以下的缺陷态状态保持不变,从耗尽区向积累区扫描时,只有E=Eλ1以上的界面缺陷态捕获GaN导带中电子,引入正电荷使C-V曲线1向负偏压方向延伸;当使用能量为E=Eλ2(Eλ2>Eλ1)的光进行照射时,光生空穴复合能级E=Eλ2以上的界面缺陷态,使得C-V曲线2继续向负偏压方向延伸,此时曲线2相较于曲线1的延伸变化量即为能级Eλ1<E<Eλ2间的界面缺陷电荷引起的,能带图如图5所示。
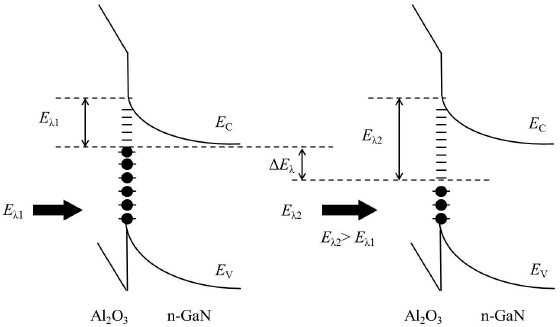
图5 变波长光辅助C-V法能带示意图
界面缺陷态的平均值计算公式为:
 (5)
(5)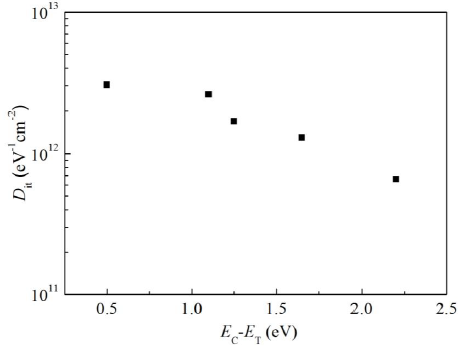
图6 变波长光辅助C-V法计算界面缺陷态平均分布值
