
图1 Al2O3/n-GaN的变频C-V曲线
第一种可能的原因是由氧化层中靠近半导体的边界缺陷引起的。在MOS器件中,氧化层中的边界缺陷能与半导体通过隧穿方式进行载流子交换。StemmerS等人认为边界缺陷的类型及空间分布甚至氧化层的生长方式都会引起频率散射现象,不同的工艺条件及生长方式引起氧化层内边界缺陷的分布也不同。图2给出了Al2O3/n-GaN积累状态下氧化层边界缺陷电荷与半导体发生载流子交换的能带示意图。
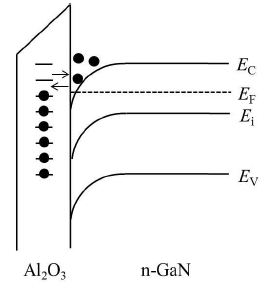
图2 氧化层边界缺陷电荷与半导体发生载流子交换的能带示意图
半导体导带界面处的电子通过类似隧穿的形式与边界缺陷发生复合。当半导体费米能级与氧化层边界缺陷态费米能级齐平时,交流信号引起界面缺陷态占据情况发生变化,等效电路如图3所示。
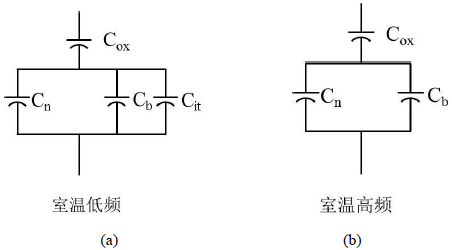
图3 室温(a)低频和(b)高频状态下的等效电路图
在正偏压积累情形下:
(1)低频状态下,深能级的氧化层边界缺陷电荷能够响应交流信号,边界缺陷电荷的填充状态随着外加偏压引起费米能级的变化而改变,偏压增大,电子在半导体表面聚集,填充边界缺陷电荷,使得边界缺陷态的费米能级上升。此时,边界缺陷电荷能够贡献额外的电容分量,等效电路如图3(a)所示,电路的总电容可表示为:


第二种可能的原因是界面缺陷态与金属层发生载流子交换。一般情况下,界面缺陷态会与半导体发生载流子交换,但当氧化层很薄时界面缺陷态能与金属发生载流子交换。在正向偏压下,金属费米能级与高密度的界面缺陷能级齐平,此时电子可以从缺陷态隧穿至金属。交流信号使金属费米能级上下扫过界面缺陷态能级,通过提供一个导电通道使载流子与界面缺陷发生复合。当隧穿时间常数与表面复合时间常数相比较小时,这种隧穿称为“复合控制隧穿”。假设界面缺陷与电导发生载流子交换,在给定电压V下交流信号电导可表示为:

