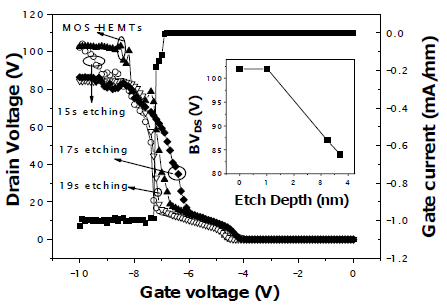
我们采用漏电流注入方法(DCIT)来测试不同凹槽栅深度的MOS-HEMTs和常规MOS-HEMTs器件的击穿特性。漏电极输入1mA/mm的电流,源端接地,栅压从0V扫到阈值电压以下,检测栅电流和漏源间电压,在栅压大于阈值电压时,沟道是导通的,漏端电流很容易就能达到1mA/mm,而当栅压小于阈值电压时,为了达到1mA/mm的漏端电流,则需要增加漏源电压。当栅电流和漏电流都达到1mA/mm时,就是栅电流都流到漏端,此时器件击穿。从图1可知,常规MOS-HEMTs和不同凹槽栅深度的MOS-HEMTs器件的击穿电压为102,102,87和84V。击穿电压随着凹槽栅刻蚀深度的增加发生退化,这可能是在刻蚀凹槽栅过程中在AlGaN势垒层表面负电荷Cl电荷富集,这导致了能带中导带边缘的弯曲。在AlGaN势垒层表面富集的负电荷与N空位会增加肖特基与势垒层间的界面态,这会增加陷阱辅助隧穿的几率,使得器件的击穿特性发生退化。这都是由于凹槽栅刻蚀造成的,可以通过等离子体预处理来消除,或者退火来消除陷阱和平坦刻蚀过的表面粗糙度。
