
图1 不同凹槽栅深度MOS-HEMTs器件的电流崩塌对比。
由图1可见,D区(常规MOS-HEMTs)器件的崩塌量是最高的,而A,B和C区(凹槽栅深度分别为0.62nm,2.71nm,3.25nm)的器件通过Cl2刻蚀形成了凹槽栅,由于暴露在空气中的材料表面会有一层自然氧化层,在AlGaN亚表面区域会由于AlOx和GaOx氧化物的产生使得N原子的缺失,从而形成了N空位,同时亚表面区域也有其他杂质(如C,O,Si等)。通过Cl基刻蚀这层氧化层减小了栅下区域界面态密度,而小功率刻蚀不产生新的界面陷阱类型。所以通过凹槽栅刻蚀后,AlGaN和栅介质氧化铝间的界面态有所减小,器件的电流崩塌效应有所抑制。可见,可通过凹槽栅刻蚀的办法来抑制器件的电流崩塌效应。
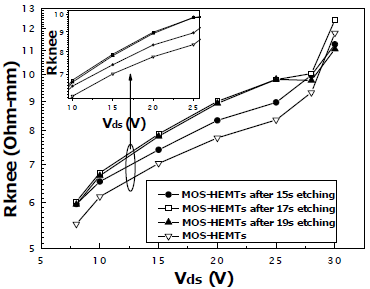
图2 不同槽栅深度MOS-HEMTs的膝点电压随源漏电压变化的关系(栅压为0V)。
槽栅结构会由于刻蚀损伤形成体或表面陷阱而加剧电流崩塌。槽栅刻蚀后电流崩塌与AlGaN表面态的相关性很强。为了表征电流崩塌,我们定义了膝点电阻(膝点电压和膝点电流的比值)。采用脉冲测试输出曲线,栅压固定在0V,漏压分别为0-8,0-10,0-15,0-20,0-25,0-28,0-30V,如图2所示。Conwayetal报道在槽栅刻蚀后,由于表面态的增加,器件的Vknee发生了漂移,并认为更浅的槽栅深度(更少的表面刻蚀区域)能够减小这现象。图2中所示不同槽栅深度的MOS-HEMTs的膝点电阻随漏压的增加趋势基本一致,可见短时间低功率Cl基刻蚀并不会对材料表面产生过多的表面态。
