1. AlGaN势垒层的表面态
裸露的AlGaN表面通常都有较多的表面态,这些缺陷会成为陷阱辅助遂穿等效应的载体,成为栅泄漏,栅低频噪声和器件可靠性的一大问题。AlGaN表面缺陷常有C、Si等杂质,这可能是由于MOCVD里的石墨基座和衬底高温扩散导致的;N和Ga空位是常见的缺陷,这是由于晶体生长到界面时由悬挂键所产生的,通常N空位还由于因为暴露空气中的材料表面会有一层自然氧化层,在AlGaN亚表面区域会由于AlOx和GaOx氧化物的产生使得N原子的缺失,从而形成了N空位。
2. 表面预处理减小AlGaN势垒层的表面态
高密度的界面态,会使得器件在材料界面产生费米钉扎,而GaN HEMTs的表面态密度更高,达1013cm-2 ,表面费米能级的位置就成为研究的焦点。使用DLTS,变频CV或者低频噪声测试方法等都能有效地测出GaN HEMTs器件在工作状态下的表面态。虽然采用钝化工艺,使得高的界面态产生的电流崩塌有所抑制,但并不能完全的抑制住电流崩塌,特别是在电学应力下或者热应力等应力,电流崩塌效应有所增强。可见,界面态对器件的性能和可靠性有着极其关键的影响。如何减小界面态已成为一大关键问题。
本文主要研究等离子体预处理减小如何减小界面态和提高器件的性能。特别是当凹槽栅刻蚀深度较深时,槽栅刻蚀会在刻蚀 AlGaN 势垒层的同时,产生相关的刻蚀损伤,这将会大大增加栅上电子通过陷阱辅助遂穿的几率,从而增加器件的栅漏电,影响了器件的关断特性和可靠性,会也增加器件的栅低频噪声。
3. 表面预处理对常规HEMT结构电容的影响
测试C-V环所用的欧姆区域采用的是环形结构,电子束蒸发Ti/Al/Ni/Au多层金属,在870度下40s高温退火所形成,而圆环内部为肖特基接触,肖特基图形半径为63um,由电子束蒸发Ni/Au双层金属形成。图1所示为GaNHEMTs器件在不同等离子体处理的电容结构CV特性和载流子分布,其中我们通过分场曝光形式,将圆片分为常规不预处理区域,O2等离子体预处理区域和N2O等离子体预处理区域。其中N2O等离子体预处理是在等离子体增强化学气相沉积(PECVD)腔体中进行处理,处理条件:温度为250度,压强为600mTorr,功率为400W,处理时间2min;O2等离子体预处理条件为:常温,压强为-96Pa,250W,O2流量为3L/min,处理时间为2min。
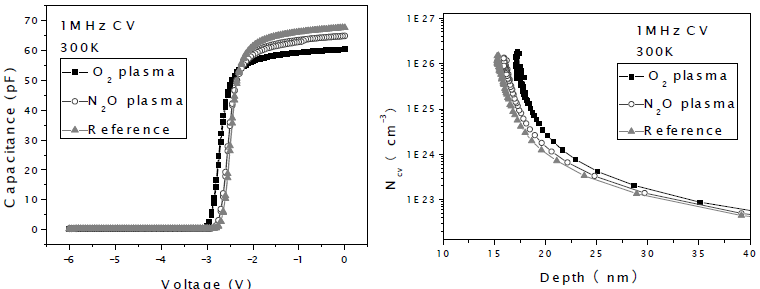
图1 不同等离子体预处理的电容结构CV特性和载流子分布。
肖特基栅下区域通过O2和N2O等离子体预处理后,在栅下有源区的表面进行了氧化,产生一层薄薄的原位氧化层。由图1所示,通过O2和N2O等离子体预处理后,积累区电容都出现不同程度的减小,阈值电压都向负方向漂移,O2等离子体预处理的氧化效果能更好些,同时,对比三种器件下的载流子分布,不难看出N2O等离子体预处理后二维电子气浓度基本不变,而O2等离子体预处理后的二维电子气浓度有所提高,这说明O2等离子体预处理对肖特基栅下区域的表面态有覆盖作用,能减小栅下区域的陷阱数量。
4. 表面预处理对常规HEMT肖特基特性的影响
栅泄漏电流是衡量high-k介质MOS电容的主要参数,小的栅泄漏电流可以让器件工作在更高的偏置下,而栅泄漏电流是器件可靠性和低频噪声的主要来源。分析O2和N2O等离子体预处理对肖特基特性的影响,
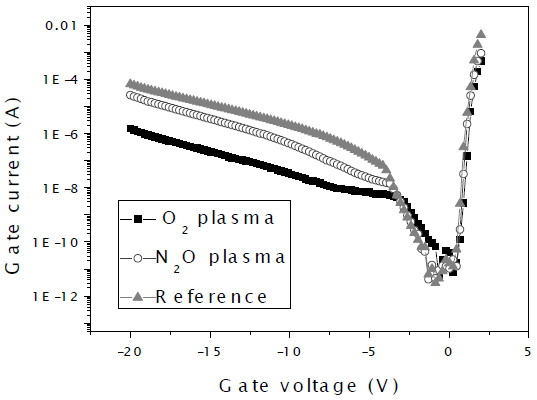
图2 不同等离子体预处理后的肖特基正反向特性。
如图2所示,我们比较了不同等离子体预处理对CV环上的肖特基栅泄漏特性,O2和N2O等离子体预处理后的栅泄漏电流都有所减小,特别是O2等离子体预处理栅反向电流减小了两个量级,同时栅正向电流通过O2和N2O等离子体预处理也减小一个量级。对比O2和N2O等离子体预处理,O2等离子体预处理的原位效果较理想,预处理后的肖特基正反向特性都比较好。通过对肖特基正向电流的线性区进行拟合计算出肖特基势垒高度和理想因子。对线性区域进行线性拟合(半对数坐标中),肖特基接触电流为:

表1 肖特基势垒高度和理想因子

5. 表面预处理对常规HEMT器件直流特性的影响
研究不同等离子体预处理对常规HEMTs器件直流特性的影响,主要是研究器件的输出和转移特性,我们发现经过O2等离子体预处理,器件的亚阈值特性有所改善和饱和输出电流有所增加,同时也能减小关态电流和栅泄漏,可见O2等离子体预处理是提高器件直流特性的一个有效方法。另外,由于O2和N2O等离子体预处理对肖特基接触都有这显著效果,均能减小肖特基和AlGaN层间的界面态,减小了陷阱辅助遂穿的几率,从而提高了器件的栅泄漏特性和击穿特性。
图3所示为经过不同等离子体预处理后器件的输出特性,曲线栅压是漏压是从0V扫到10V,步长为0.1V,栅压从-6V到2V,步长为2V。由图中的饱和电流可见,经过不同等离子体预处理,器件的饱和输出电流基本没发生变化,而关态电流在经过O2等离子体预处理后得到改善,提高了器件的关态特性。同时,图4中看出经过O2等离子体预处理后关态电流有所减小,而N2O等离子体预处理后却有所增加,这可能是N2O等离子体对材料表面的轰击造成的损伤导致的。而器件的最大跨导在经过不同等离子体预处理后基本保持一致。氧等离子体预处理对器件的直流特性有所改善,特别是器件的关态特性。
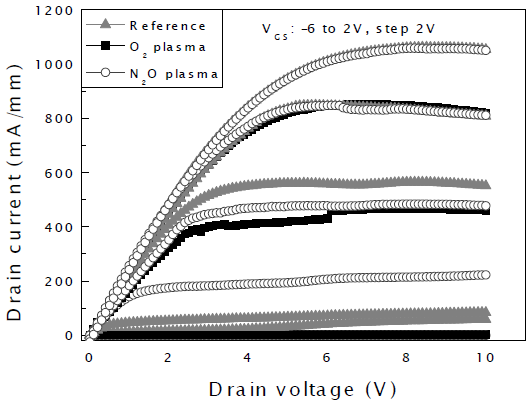
图3 不同等离子体预处理后器件的输出特性。

图4 经过不同等离子体预处理后的器件转移特性。
