减小电流崩塌有钝化、场板和帽层结构等,MOS栅介质也是解决电流崩塌的一种,而对于缓冲层所产生的漏延迟,具体体现为在器件工作时,沟道开启状态下,沟道电子被加速,不断和晶格碰撞,另外沟道温度也随之增加,导致沟道电子有一部分变成了“热电子”,这部分“热电子”遂穿到栅和漏电极间的势垒层表面缺陷和表面态,引起电流延迟,也可能被AlGaN层的体缺陷所俘获,还有很大一部分“热电子”被缓冲层的陷阱所俘获,毕竟异质结靠缓冲层端的势垒高度较低,“热电子”较容易发射到缓冲层被体陷阱所俘获,导致漏延迟(电流崩塌)。
本文提出使用AlGaN层作为缓冲层,牺牲了异质结的极化强度来提高异质结靠缓冲层端的势垒高度,这会大大减小“热电子”被缓冲层体缺陷所俘获,但研究者认为,AlGaN层作为缓冲层会使得缓冲层的体缺陷大大增多,这将会影响器件的功率特性和高频特性。

图1 AlGaN缓冲层(a图)和常规GaN缓冲层(b图)的器件在不同静态工作点下的电流崩塌特性。
图1描述了常规常规GaN缓冲层和AlGaN缓冲层结构的凹槽栅MOS-HEMTs器件在四个静态工作点,Q点分别为(0,0)、(-9,0)、(-9,20)和(0,20),分析在这四个静态工作点下的电流崩塌量。为了分析在器件关断状态下的崩塌量,将图3中的Q点(0,0)、(-9,0)和(-9,20)另外放在一起在做图,如图2所示,a图为器件在Q点(-9,0)下的电流崩塌,b图为在Q点(-9,20)下的电流崩塌,c图为在(0,20)下的,而d图为三种直流静态工作点下的电流崩塌量。当器件的静态工作点为(-9,0)和(-9,20)时,器件是处于截止状态下,沟道中并没有电子,崩塌量都比较小。但随着漏压的增加,不管是GaN缓冲层结构的还是AlGaN缓冲层结构的器件崩塌量都会增加,都会受到漏压调制崩塌效应。另外当器件的静态工作点处于(-9,0)和(-9,20)时,AlGaN缓冲层的崩塌量均大于GaN缓冲层的,这主要是由于AlGaN作为缓冲层(Al组分为7%)引入了大量的陷阱所导致的。但当器件静态工作点处于(0,20)时,沟道开启,电子被加速,部分成为热电子,可能会通过遂穿形式等发射到势垒层和缓冲层中去,被体陷阱和势垒层表面态所俘获而导致较为严重的电流崩塌,相比于GaN缓冲层的器件46%的崩塌量,AlGaN缓冲层的器件35%的崩塌量就小得多了,这因为GaN作为缓冲层缺少背势垒结构来阻止热电子被缓冲层的体陷阱所俘获,而AlGaN作为缓冲层结构会提高异质结背势垒的势垒高度,从而降低热电子遂穿到缓冲层的几率,减小崩塌量。总结两种结构的电流崩塌情况,各有优缺点,AlGaN作为缓冲层可以有效地抑制热电子发射效应,但同时也引入大量陷阱到缓冲层结构中,这是今后研究的重点,如何降低AlGaN作为缓冲层所引入的陷阱数量,如ELOG技术。
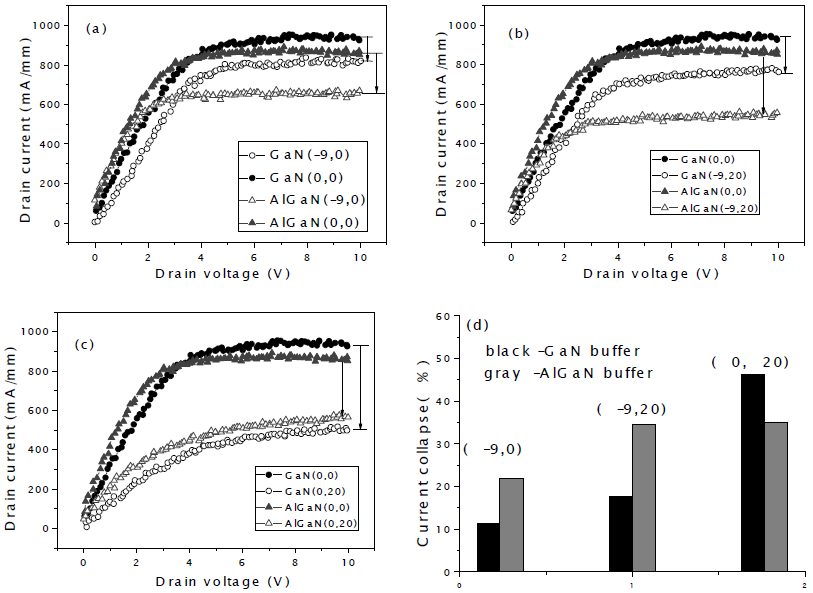
图2 GaN(buffer)和AlGaN(buffer)凹槽栅MOS-HEMTs器件的电流崩塌特性,Q点为(a)(-9,0),(b)(-9,20),(c)(0,20)和(d)器件在不同直流静态工作点下的电流崩塌量。

图3 AlGaN缓冲层凹槽栅MOS-HEMTs器件频率特性
