开态应力是指在栅上加一个恒定0V的电压,漏上加一个恒定20V的电压,使得器件处于长时间正常导通状态[50];而关态应力则是指器件栅上电压恒定为-10V,漏上恒定为20V,使得器件长时间处于关断状态,而且器件处于强电场应力的作用下[51]。其中每个状态的应力总时间都是7200s,并且在应力过程中也对器件的特性进行测试,下面是测试和分析的结果。
现在我们研究AlGaN缓冲层凹槽栅MOS-HEMTs器件在开态应力退化的分析和机制研究。
图1是AlGaN缓冲层凹槽栅MOS-HEMTs器件在长时间开态应力过程中测试得到的栅压为2V的输出结果比较,从图中明显看出随着应力时间的加长,器件的退化越来越显著,而且器件在膝点电压附近退化最大,而在饱和区退化则相对较小,另外线性区斜率和饱和区输出电流都有所减小,这是因为在开态应力下,栅漏区下的沟道中部分热电子发射到势垒层和缓冲层中的陷阱,被俘获了,导致栅漏间的沟道电阻增加,使得线性区和饱和区特性都得到了退化。对比常规GaN缓冲层的器件和AlGaN作为缓冲层的器件在线性区和饱和区的退化,可以看出,由于AlGaN背势垒的存在减小了栅漏区域下的沟道部分热电子发射到缓冲层被陷阱所俘获的几率,另外,由于AlGaN缓冲层本身就具有较大的栅漏电阻(由于7%Al组分使得缓冲层的陷阱增多),从而降低了由热电子发射效应所导致的栅漏间电阻的增加效果,这样使得AlGaN缓冲层的凹槽栅MOS-HEMTs器件在开态下(热应力下)的退化比常规GaN HEMTs器件小得多。

图1 开态应力过程中的栅压为2V时输出结果的比较(a)AlGaN缓冲层;(b)常规GaN缓冲层。
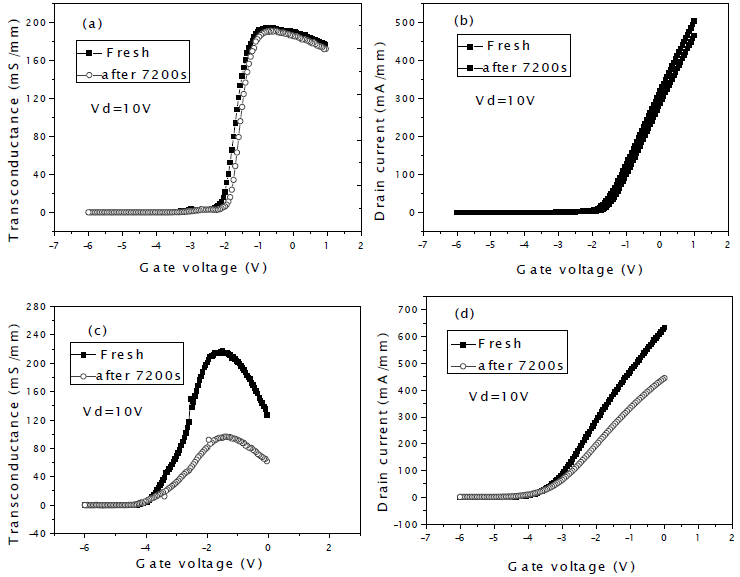
图2 应力前后不同缓冲层器件的转移特性,(a)和(b)为AlGaN缓冲层凹槽栅MOS-HEMTs器件,(c)和(d)为常规GaN缓冲层凹槽栅MOS-HEMTs器件。
如图2所示,比较了两种缓冲层结构的凹槽栅MOS-HEMTs器件在应力前后转特特性退化的程度,不难看出,经过两小时的电学开态应力后,两种器件的阈值电压都向正漂移,这主要是由于沟道二维电子气浓度减小的缘故,另外跨导峰值也都有所减小,也是由于输出电流减小有关,即是都是由于栅漏间沟道电阻的增加所导致的。从退化的程度来看,常规GaN缓冲层的器件无论是阈值电压还是跨导峰值都退化的比较厉害,这说明了AlGaN缓冲层器件抑制热电子效应的效果更加明显。
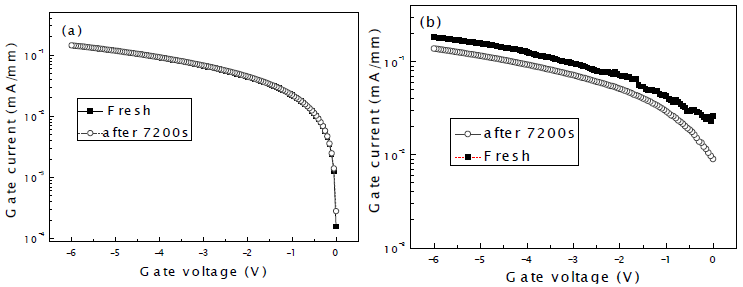
图3 应力前后不同缓冲层器件的栅泄漏特性,(a)为AlGaN缓冲层凹槽栅MOS-HEMTs器件,(b)为常规GaN缓冲层凹槽栅MOS-HEMTs器件。
图3对比了应力前后不同缓冲层器件的栅泄漏特性,经过两小时开态热应力后,AlGaN缓冲层凹槽栅MOS-HEMTs器件的反向栅泄漏电流基本不退化,而常规GaN缓冲层凹槽栅MOS-HEMTs器件的发生了退化,这主要是由于常规器件不能很好的抑制热电子效应,导致沟道温度随之增加,这将会对势垒层和肖特基接触产生一定影响,使得势垒层由于热应力产生新的陷阱,同时对肖特基接触也有所退化,这两方都会导致栅反向泄漏电流增大。但AlGaN缓冲层凹槽栅MOS-HEMTs器件由于能很好地抑制热电子发射效应,所以栅泄漏特性基本不发生退化。
图4对比了不同缓冲层器件的瞬态特性,栅信号时从关态到开态的一个过程,-6V到0V,漏压一直维持在20V,同时检测漏端电流。经过两小时的开态热应力后,两种器件都发生了明显的栅延迟现象,相对地,AlGaN缓冲层凹槽栅MOS-HEMTs器件的延迟量会小一些,这主要是在两小时开态热应力,AlGaN缓冲层结构能够抑制热电子效应,减小沟道热电子被势垒层和缓冲层的陷阱所俘获,特别是缓冲层的陷阱。另外观察两种器件在上升沿区域的曲线,发现两种器件的漏电流相应栅信号上升沿的相应时间不同,这可能是由于缓冲层内陷阱的时常数不同导致的,因为AlGaN缓冲层引入的陷阱不同于常规GaN缓冲层的陷阱,所以在栅延迟信号下的反应程度也不同。所以瞬态电流的退化量主要取决于沟道热电子被俘获的数量是相关的,这方面AlGaN缓冲层结构的器件具有较大优势。

图4 应力前后不同缓冲层器件的瞬态特性对比,(a)为AlGaN缓冲层凹槽栅MOS-HEMTs器件,(b)为常规GaN缓冲层凹槽栅MOS-HEMTs器件。
现在我们研究AlGaN缓冲层凹槽栅MOS-HEMTs器件在关态应力退化的分析和机制研究。
对于常规GaN HEMTs器件而言,当栅电压处于关断时,漏电压处于工作电压时,栅漏之间处于强场之下,沟道中的电子完全被耗尽,此时从栅极注入的电子在栅漏的强场作用下遂穿进入到势垒层的表面、势垒层中或缓冲层中,从而引起漏电流和跨导的退化,因此栅极的注入电流是引起器件在关态应力条件下退化的主要因素。
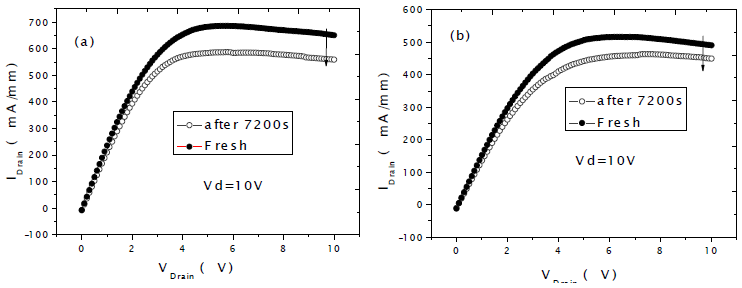
图5 应力前后不同缓冲层器件的输出特性对比,(a)为AlGaN缓冲层凹槽栅MOS-HEMTs器件,(b)为常规GaN缓冲层凹槽栅MOS-HEMTs器件。
如图5所示,对比了在两小时关态应力后不同缓冲层结构器件的输出特性,我们发现两种器件的最大输出电流均发生退化,沟道中的载流子都减小了,但退化量有所不同,由于AlGaN所引入的大量缓冲层陷阱,这使得栅极注入电流会被缓冲层的陷阱所俘获,而注入GaN缓冲层结构的器件沟道中的电子却可以补偿了二维电子气的浓度,弥补了之前应力下被陷阱所俘获的部分电子。另外由于常规GaN缓冲层的背势垒较低,在关态应力间俘获的电子可以部分释放到沟道中弥补了二维电子气的减小量。

图6 应力前后不同缓冲层器件的转移特性对比,(a)为AlGaN缓冲层凹槽栅MOS-HEMTs器件,(b)为常规GaN缓冲层凹槽栅MOS-HEMTs器件。
如图6所示,对比不同缓冲层结构的器件在关态应力前后的转移特性,我们发现对于缓冲层采用AlGaN的器件而言,其阈值电压从-1.96V减少到-2.03V,发生了少量的负漂,而其峰值跨导从180mS/mm增加到187mS/mm,这主要是因为从栅极注入的电子进入到沟道中,使得沟道的电子浓度增加所导致;对于GaN缓冲层的器件来说,其阈值电压基本上没有发生变化,而其峰值跨导却从209mS/mm减少到200mS/mm,这主要还是由于少量栅极注入电子进入到缓冲层中,造成沟道二维电子气的部分耗尽所导致。
在关态应力过后,我们比较了应力前后的栅极开关的瞬态特性,发现了两种不同外延结构的器件出现了完全不同的栅延迟现象。测量时,使栅极电压信号从-6V变化到0V,而漏极电压保持20V不变。对于AlGaN/GaN/Al0.07GaN(buffer)凹槽栅型MOS-HEMT器件而言,其漏极瞬态电流的上升沿没有退化,其漏极瞬态峰值电流从312mA/mm增加到324mA/mm,增加量达到3.7%;而对于传统GaN缓冲层结构的凹槽栅型MOS-HEMT器件来说,其漏极瞬态峰值电流从710mA减少到630mA/mm,减少量达到11.2%。漏极瞬态峰值电流因缓冲层结构不同而发生的这种变化与上述器件在关态应力下直流特性退化的结果一致,这表明AlGaN缓冲层能够有效阻挡栅极注入电子进入到缓冲层中,对提高器件关态应力下的可靠性有着积极的作用。
