随着硅基功率MOSFET开关器件的发展,使得近代高效率开关电能转换技术得已实现。功率开关器件的开关性能及其导通电阻是能否获得最高转换效率的两个关键性因素,在高电压、大电流的情况下,这两个因素的影响还会变得更大。在这里我们要特别强调的是,这种高效率、低损耗开关器件的应用涵盖了马达驱动、电动汽车、发电和输配电等市场,这些市场不仅需要产品有着更好的性能,也要有合适的成本。
在效率上的提高并不是来自于在硅器件性能上的改进,因为硅器件的性能已经接近了硅材料的极限。因此工业上已经转向研究其它性能更为优异的材料,采用宽禁带(WBG)半导体材料的GaN和SiC器件能够满足未来高效率、低损耗电能转换系统的需求。
采用SiC和GaN材料的功率器件已经商业应用了好多年,但是相比于目前广泛应用的硅器件而言,由于受到高成本和缺失可靠性证明的影响,阻碍着这种新材料器件的进一步广泛应用。但是在预期的性能表现方面,宽禁带材料将具有更加明显的优势(如图1所示)。
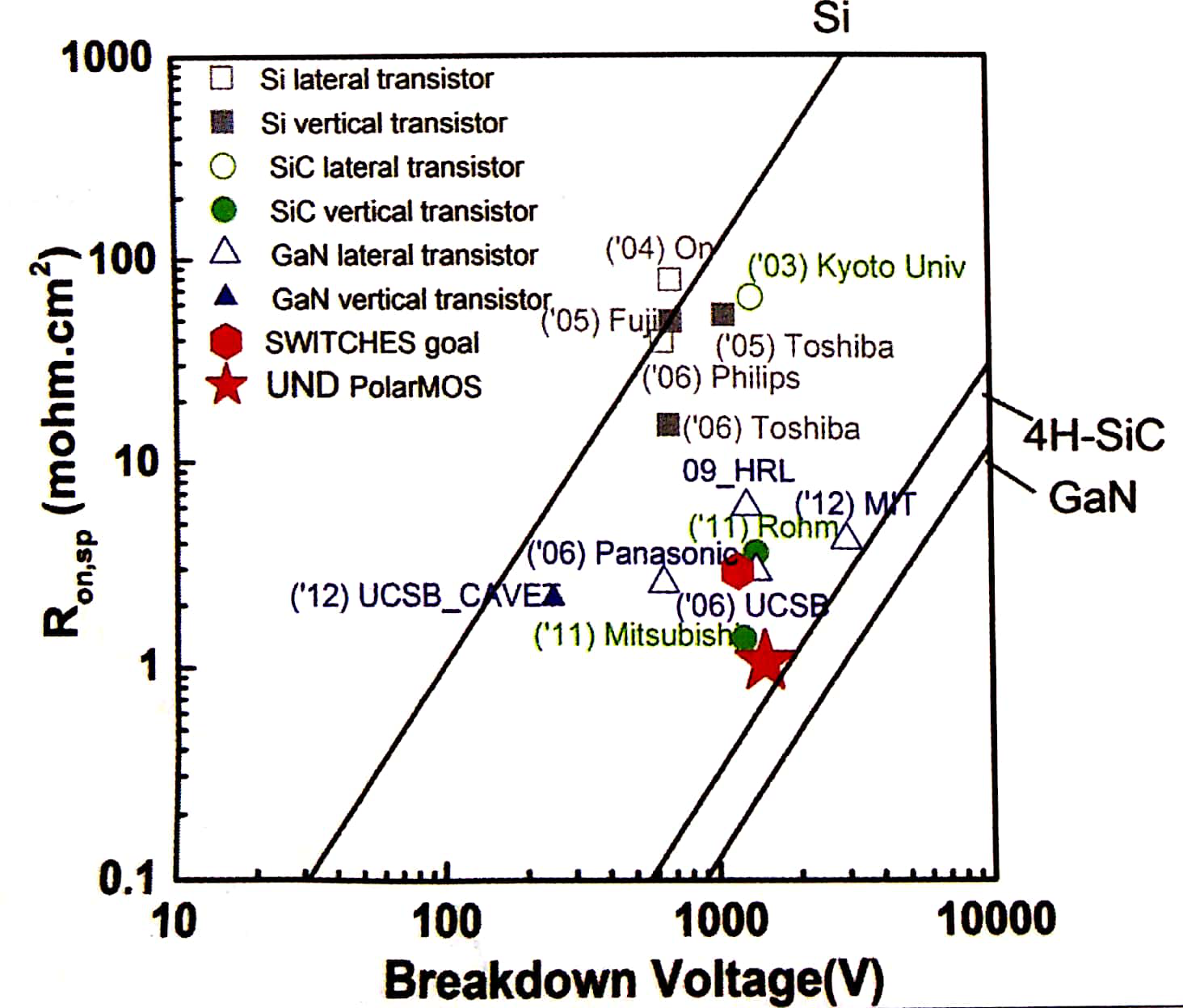
图1. 制备功率开关器件的理想材料必须具有较高的击穿电压和较小的导通电阻,硅是制备这类器件最为常用的材料,但是许多研究已经证实宽禁带材料制作的器件能够克服硅材料的技术瓶颈。不论是从实验角度还是理论角度来看,GaN的优势要比SiC更大一些。
在大多数电能转换应用中,相比于SiC而言,GaN凭借其优异的介电强度和电子迁移率使它具有更高的品质因数(FOM),只有在极高温的工作环境中SiC才能表现出优于其它材料的性能。目前已经使用了多种不同的品质因数来评估这两种材料的应用前景,最有名的就是来自Baliga,他考虑了纵向FET中特定漂移区域的导通电阻这个因素,另外两个关键因数是具有双极结构器件的开关速度及其功率处理能力,如图2所示。
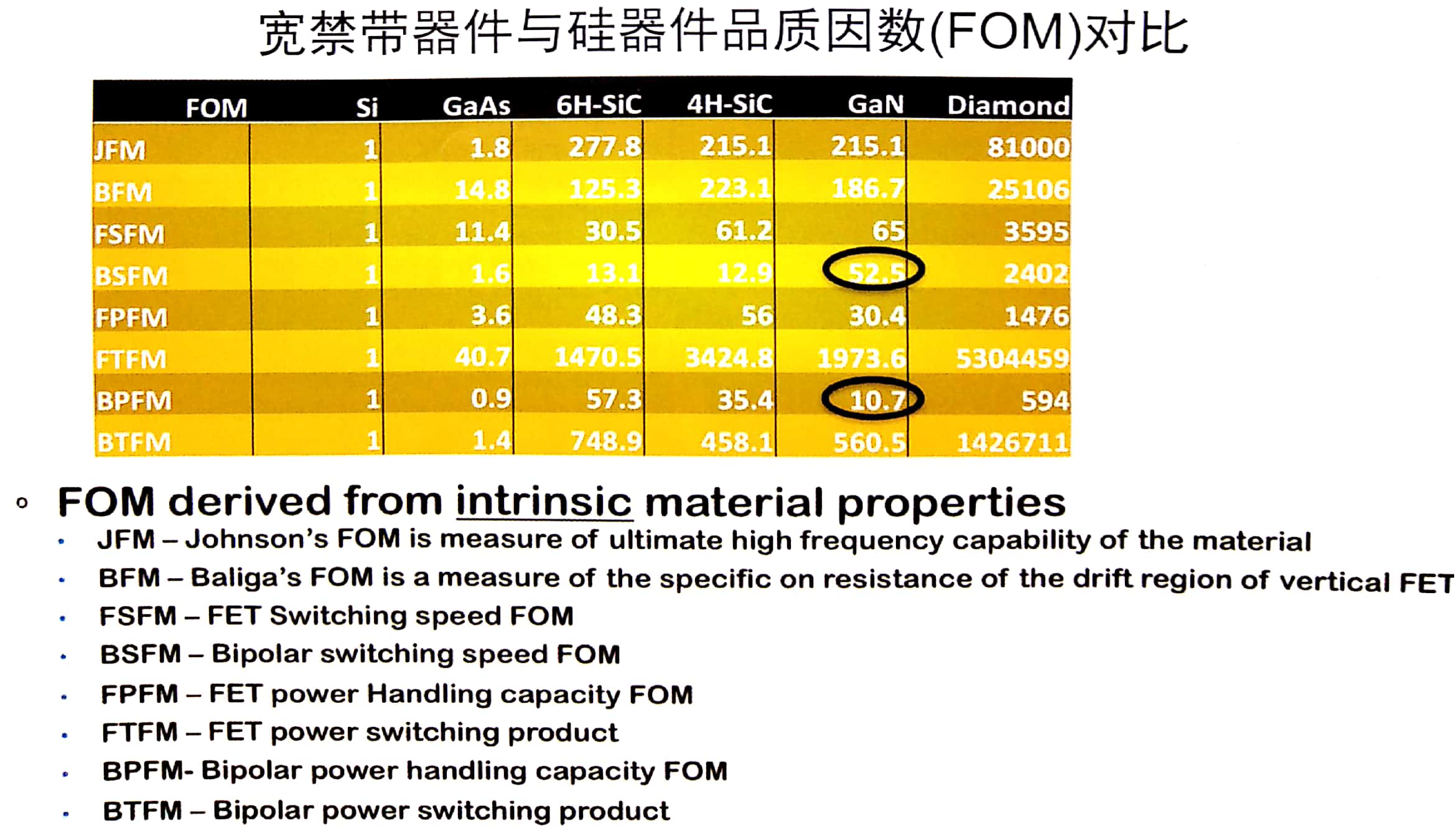
图2. 宽禁带器件特别是GaN基器件的发展机遇,相比于以Si基和GaAs基器件,它的品质因数明显要更加优异。
如果利用在Si衬底上生长GaN的外延片来生产横向GaN HEMT,那么其生产成本很可能会与生产硅器件相当,但是其工作电压将会被限制在650V以下。对于更高工作电压的应用,用SiC衬底代替硅衬底就能够克服在工作电压上的限制,但是由于SiC衬底的成本较高,因而会增加器件成本,而在提高电压时还需要增加器件的横向尺寸。
一种更佳的选择是转为在器件构造上的创新:采用一种纵向器件结构。类似于超PN结MOSFET的结构,这种纵向器件由于大大减小了芯片的尺寸,能同时满足对器件高性能和低成本的要求,但是需要采用同质外延的GaN衬底来保证纵向电流的正常通过。
这就是目前纵向GaN功率开关器件所面临的最大挑战,如果能够解决这个问题,就能够开启通向新型的具有高的效益/成本比的高效电能转换器件的大门。
新一代纵向GaN器件能够提升电能转换效率和减少碳足迹的优点已经引起了美国ARPA-E部门的关注。为了能够将这一计划变为现实,已经成立了一个为期三年、共计2700万美金投入的名为SWITCHES的开发项目,这是一个用于高效控制系统的低价宽禁带晶体管的研发策略(简称为SWITCHES)。SWITCHES的目标是最终实现对宽禁带材料的转换,新器件的结构设计及其制造,以生产出工作电压超过1200V、工作电流超过100A的单芯片功率器件。日前已经有14个SWITCHES的子项目得到了该基金的资金资助。
从横向器件到纵向器件
GaN衬底上GaN器件的核心优势就是能够实现纵向晶体管结构,横向器件中的AlGaN/GaN界面处会形成一个二维电子气(2DEG)层,电流就在这一靠近表面的二维电子气层中流动,而纵向器件的电流传导方式就比它要好(如图3所示)。横向晶体管结构的缺点是如果要维持一个较高电压和较大电流,其横向尺寸就必须放大。由于硅衬底较差的热学性能以及具有明显的电流崩塌效应(即在二维电子气沟道的传导电流中陷阱电荷的记忆效应),使得在开关转换过程中它的漏极电流会减小。总而言之,这些因素使得大规模生产高电压/电流但成本又低的横向器件遇到了障碍。
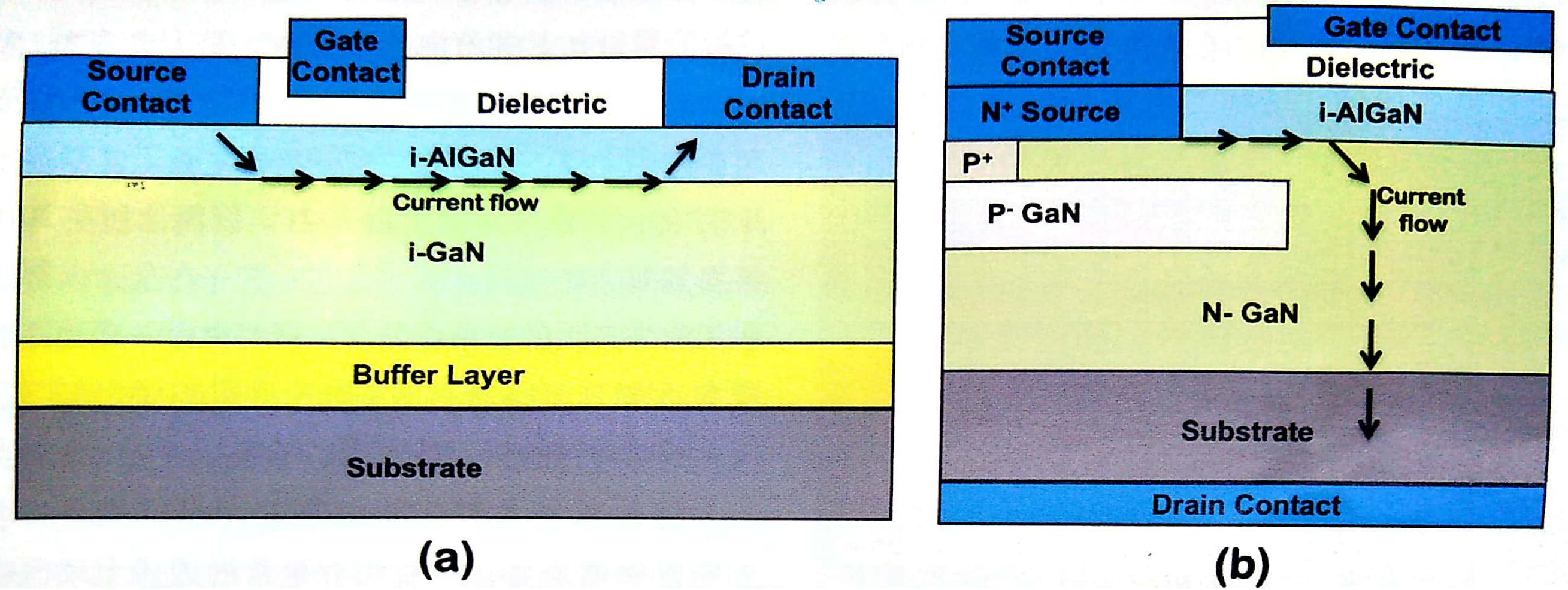
图3. (a)传统横向GaN晶体管是一种横向结构,这种结构的缺点是:在高功率容量时芯片的尺寸要增大,其热学性能差以及存在电流崩溃效应。(b)而采用纵向晶体管结构能够全面解决这些问题。
来自美国加州大学Santa Barbara分校的研究小组,在采用同质外延纵向GaN器件来克服这些问题的研发过程中走在了前沿。在这种器件中,其纵向电流流过GaN衬底,使得其大部分电压降都产生在垂直方向上。随之,在横向维度上就不必考虑工作电压与其尺寸的比例关系。正是因为这一点,纵向器件芯片的尺寸要比横向器件小5倍以上。此外,纵向器件结构还能够消除电流崩塌效应,这样就能够提升器件的开关速率及其对热量的处理能力。但是这里我们依然要指出纵向器件所面临的挑战:它需要一个极性PN结来形成二极管和晶体管,而且由于众所周知的在材料上的限制性问题,目前在制造P掺杂GaN器件上还存在着困难。
为了解决这些技术问题,Notre Dame大学(UND)和Cornell学联合研究小组的负责人Huili Grace Xing和Debdeep Jena开发了极化掺杂(polarization-doped)的p型和n型层以及相关的PN结。由于在掺杂技术上的突破,现在已经能够用来制备高击穿电压、反型沟道的高迁移率和低导通电阻的晶体管结构。另一项关键技术是在极化掺杂的p区采用低成本的硅离子注入方法来转变成为n型沟道(见图4)。
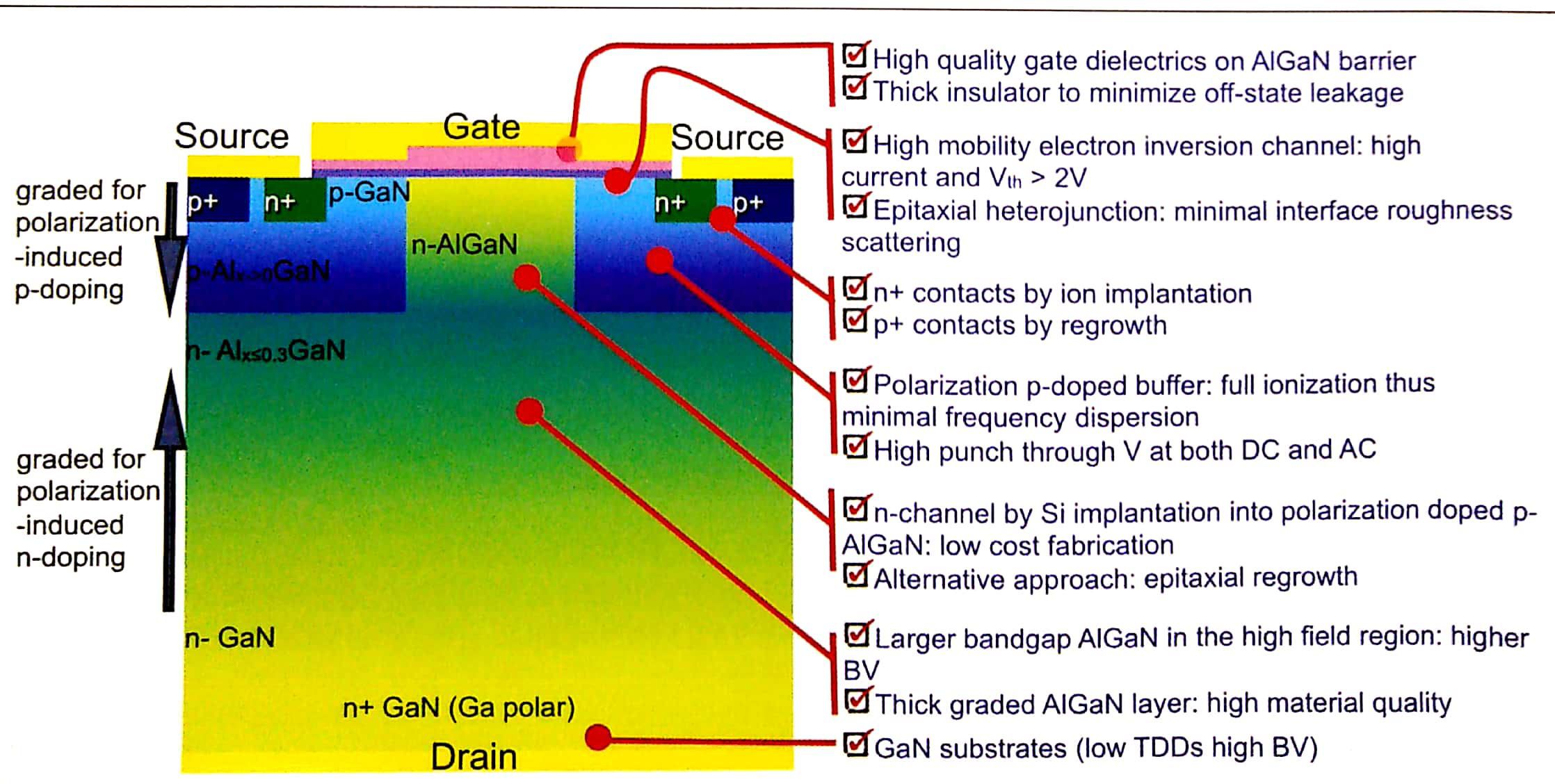
图4. polarMOS技术结合了pn结器件、MOSH和JFET技术
除了上述的挑战之外,如果纵向GaN器件要在商业上得到普及,还必须克服技术成熟性以及供应链等问题。这种类型的GaN器件在马达驱动、光伏逆变器、电动汽车充电、电信应用中的DC-DC转换以及军工领域将存在大显身手的机会。它能否取得成功还取决于其它方面的多种因素,但其中器件的性能永远是最为重要的因素,需要这种纵向GaN器件能够在高频和高温工作环境下进行高效率开关操作。如果能够做到这一点,并能够满足在工业可靠性上的要求,这种技术就能在系统级层面上来减小器件的尺寸并降低成本。
一种双管齐下的方法
UND/Cornell大学至今为止所做出的贡献是振奋人心的,他们已经成功利用了IQE公司根据SWITCHES项目要求开发的外延片,设计并制造出了阻塞电压为1200V的GaN衬底上GaN p-n结二极管,以及阻塞电压超过3000V的pn结二极管。这种在GaN衬底上GaN的p-n极性二极管有近乎完美的I-V曲线和雪崩特性,PolarMOSH器件已被测量证实其阈值电压为1.3V,最大电流为250mAmm,最高栅压超过15V,除此之外,Qorvo公司最近还发现,采用分子束外延再生长工艺制备的JFET的阻塞电压可以达到700V。
目前来讲我们仍然面临着许多挑战。一个近期目标就是要在衬底和外延片的改进上取得成功,并需要证明纵向极性JFET的工作电压和工作电流要能够分别达到300V和10A。这项工作在芯片加工时能够降低多种风险,当前的工作主要是集中在对工艺的控制和校准上。
另一个挑战是要生产更大尺寸的JFET,使它能够在10A甚至更高的电流下工作,要能够在4英寸晶圆厂的大尺寸GaN衬底基体上进行加工。已经制订了一个更具进取性的计划来推动衬底供应商提供4英寸晶圆的衬底,这将能使我们在Qorvo 4/6英寸工厂中加速工艺的开发和成熟进程。
我们下一步的计划是推进polarMOSH工艺和polarJFET工艺的整合集成工作,来生产极性MOSHFET-PolarMOS器件。尽管我们已经证明所生长的材料已经能够获得超过1200V的阻塞电压,但是这一结果需要在再生长或离子注入沟道中能得到重复。有一个好消息是我们已经开发和获得了具有更高阻塞电压、兼具更高可靠性的新技术及其知识产权。除此之外,将外延层的剥离技术与新型器件结构进行整合的工作也已提上了日程。最后的挑战就是要在系统级层面上来开发封装技术,来制造兼具元件集成的小尺寸外形的大功率器件,Corvo正与和其他两个子项目成员合作进行封装技术的开发,使之能够在系统级层面上来最大程度的发挥纵向GaN衬底上GaN器件的性能,这种新型器件的性能够满足实现低成本高效率开关的要求,对它的需求也正在与日俱增,这将有助于在全球范围内来削减电能的损耗和加速替代能源的广泛应用。
