本文通过ICP干法刻蚀凹栅和等离子增强化学气相沉积(PECVD)生长SiO2技术,获得增强型Si衬底SiO2/GaN场效应晶体管(MOSFET),研究了Si衬底SiO2/GaN MOSFET和MOS二极管在不同偏压条件下的电流-电压(I-V)和电容-电压(C-V)曲线变化,分析造成阈值电压偏移以及C-V曲线偏移的原因,并通过热退火处理,有效降低绝缘栅界面陷阱,提高界面质量,改善器件稳定性。
1. 工艺步骤
SiO2/GaN MOSFET器件的横截面如图1所示。采用金属氧化物化学气相沉积(MOCVD)外延技术在Si衬底上依次生长缓冲层:u-GaN,1.5μm厚;AlGaN(Al的质量分数为28%),30nm厚。工艺步骤如下:首先通过ICP刻蚀形成台面隔离,为实现器件常关,通过ICP刻蚀栅极区域,深度约为50nm;然后采用PECVD方法沉积厚80nm的二氧化硅作为栅绝缘介质层,作为对比,将其中一个样品在沉积介质层后,利用快速退火炉在氮气氛围下1000℃处理3min;随后采用电子束蒸发在源、漏两端沉积Ti/Al/Ni/Au(15nm/80nm/20nm/60nm),并利用快速退火炉在氮气氛围下870℃退火30s形成欧姆接触,最后在栅极区域蒸镀Ni/Au(20nm/80nm)作为栅电极。为分析评价SiO2/GaN MOS栅电荷特性,制备了圆形SiO2/GaN MOS二极管,见图1。
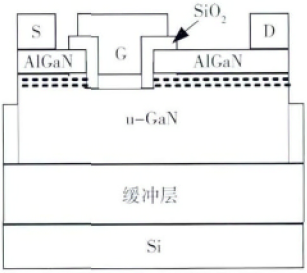
图1 SiO2/GaN MOSFET器件横截面示意图
2. 实验结果及分析
采用功率器件分析仪Agilent B1505对SiO2/GaN MOSFET器件的电学特性进行测量和分析。器件栅长L=2μm,栅宽W=2μm。图2为Vd=0.1V时,由负偏压往正偏压测试的转移特性曲线。根据转移特性曲线的线性外推法,阈值电压为3V,最大输出电流为180mA/mm(Vg=30V,Vd=15V);当转移特性曲线由正偏压往负偏压测试时,转移特性曲线往正向偏移,SiO2/GaN MOSFET器件的转移特性曲线出现回滞窗口。为进一步研究器件转移特性曲线产生回滞现象的原因,给栅极施加不同条件的偏压,接着再测量转移特性曲线。在栅极施加25V电压,并分别维持1、2、4、6和10min,漏极施加8V电压,测量器件的转移特性曲线,如图3(a)所示。栅极分别施加15~35V的电压,间隔为5V,并保持15s,在漏极电压为8V的条件下,测量器件的转移特性曲线,如图3(b)所示。
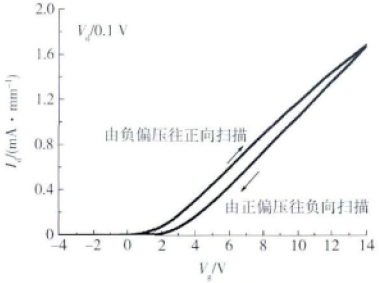
图2 SiO2/GaN MOSFET器件的转移特性曲线

图3 施加不同偏压时MOSFET器件的转移特性曲线
观察图3(a)所示的测试结果,在相同偏压下,随着偏压时间的延长,或者在相同偏压时间下,随着偏压的增加,器件的转移特性都有一定程度的正向漂移,说明在栅极施加正向偏压,SiO2/GaN MOS结构的电荷状态发生改变,导致器件阈值电压漂移。
上述器件特性测试中,考虑到SiO2/GaN MOS-FET器件的栅极在施加不同条件的偏压以后,测试转移特性时还要在漏端施加一定的偏压,这样栅极下方区域的电场就不再均匀,使得不同区域SiO2/GaN界面能带的变化情况不同,不利于探寻引起转移特性曲线回滞窗口产生的原因;另外,在Si基半导体器件工艺中,MOS电容的C-V特性就像一个可以揭示器件结构内部性质的窗口,该窗口可以作为一个强有力的判断工具来确定在氧化层和半导体中与理想情况之间的偏差。因此,考虑采用简单的环形MOS结构的C-V测试。在SiO2/GaN MOS二极管上进行了C-V偏压测试,以进一步得知引起器件转移特性曲线回滞窗口的原因,消除漏极电压对SiO2/GaN MOS器件的干扰,有效评价栅绝缘层及界面电荷。MOS二极管横截面结构与上述MOSFET器件横截面结构类似,俯视平面结构为圆环结构,圆形阳极半径为100μm。采用功率器件分析仪Agilent B1505的MFCMU单元测试SiO2/GaN MOS二极管的C-V曲线,测试频率为100kHz,步长为50mV,扫描速率为1V/s。首先从7V往-3V扫描,然后在7V维持1min后,再从7V往-3V扫描,不断重复以上的测试方法,累计14次,测试结果如图4(a)所示,图4(a)中插图为图4(a)所示C-V曲线平移之后的结果。在SiO2/GaN MOS二极管的阳极施加一定偏压并维持一段时间后再次测量,C-V曲线表现出正向漂移;以相同方式进行多次测量,C-V曲线偏移量逐渐趋向于饱和。通过平移曲线,可以发现曲线几乎重合,如图4(a)中插图所示,说明C-V曲线在偏压后只是发生整体正向偏移,并未发生形变。接着依次施加从8V到15V的偏压(间隔1V)30s后,立刻由该偏压往负向扫描C-V曲线,如图4(b)所示,随着偏压的增加,C-V曲线同样整体正向漂移。
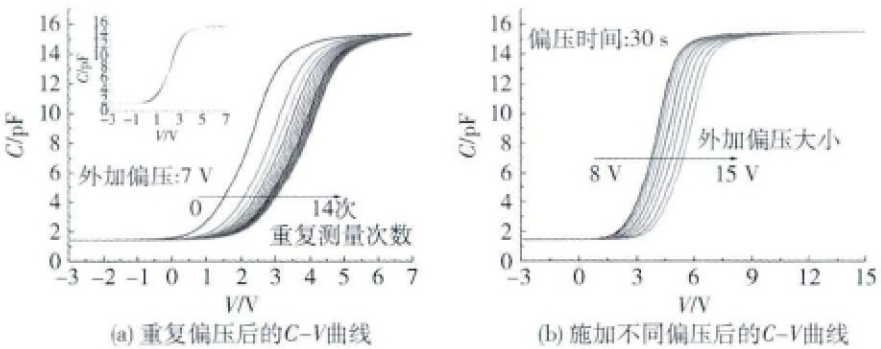
图4 SiO2/GaN MOS二极管C-V曲线
由图4(a)可见,SiO2/GaN MOS二极管阳极施加1min的外加偏置电压后,所测量到的C-V曲线形状几乎一致,说明外加偏压后界面束缚态几乎相同,C-V曲线的偏移主要受到偏压引起的SiO2/GaN界面类固定电荷的影响,这部分类固定电荷,近似存在于SiO2/GaN界面或者靠近SiO2/GaN界面的SiO2内,根据积累状态下Cox=dQ/dU,可以计算出不同偏压条件下引起曲线平移量对应的单位面积电荷变化量,如图5所示。
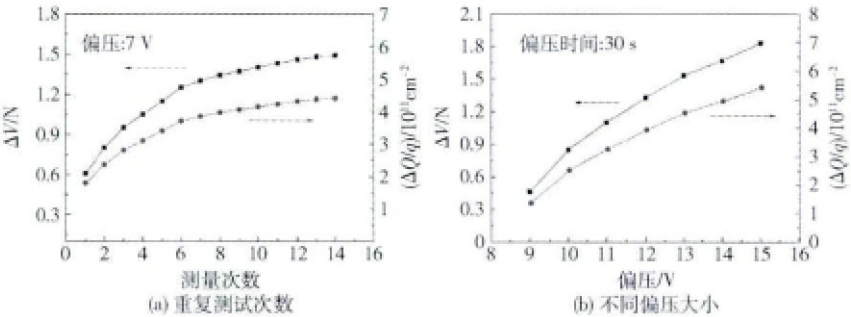
图5 不同偏压条件引起的SiO2/GaN MOS界面电荷变化量
从图5(a)可观察到,SiO2/GaN MOS二极管阳极施加相同偏压1min以后,重复相同的测试方法进行测量,C-V曲线的偏移量增加最终趋向于饱和;而在图5(b)中,增加阳极正偏压后,C-V曲线的偏移量继续增加。在SiO2/GaN MOS结构中,C-V曲线的偏移可能由SiO2/GaN界面处类固定电荷引起,其中包括部分深能级界面态束缚的电子或者注入到绝缘介质层内部的电子,这两类电荷都可能随着偏压时间的增加而增加,一定外加偏压下,电子有足够时间移动到绝缘介质层内或者被深能级界面态束缚。如图6(a)所示。对于深能级界面态,SiO2/GaN MOS二极管阳极施加正向偏压,GaN费米能级被抬升,一些界面态捕获电子。由SRH模型可知,界面态束缚电子发射时间常数表示为τT=(σTnNcUT)-1exp(ET/kT)。式中:ET为陷阱电荷激活能,υT=2.6×107cm/s为电子热运动速度;Nc=1.19×1018cm-3为GaN导带底的有效状态密度;σTn=3.4×10-15cm2为电子俘获截面;k=8.6174×10-5eV/K为玻尔兹曼常数。由于GaN禁带宽度为3.4eV,室温下束缚电子发射时间常数变化范围非常大(87ns~1.15×1050s),在C-V曲线扫描时间范围(10s)内,仅有发射时间短(GaN导带底以下0.5eV范围内)的快态电子被释放,由于深能级界面态发射时间较长,电子来不及释放,这部分电子的影响类似固定电荷,造成C-V曲线的整体平移,而没有出现C-V曲线形状的变化。
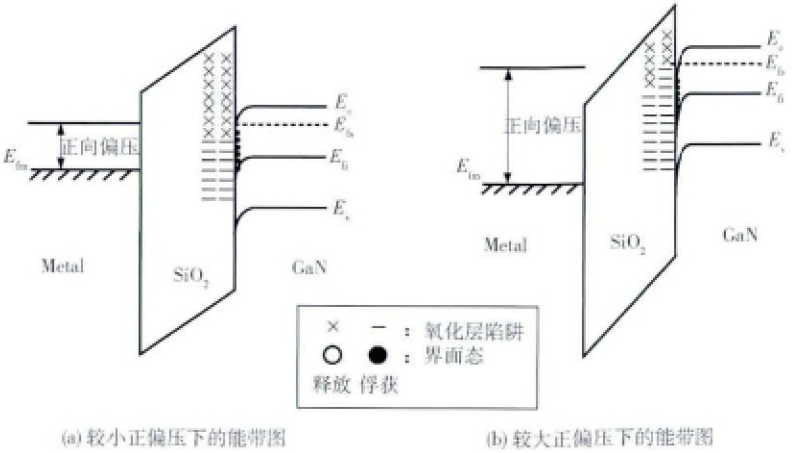
图6 不同偏压下SiO2/GaN MOS二极管能带图
如图6(a)所示,所有正偏压条件下,MOS二极管都保持在积累状态,半导体费米能级越过导带底,SiO2/GaN MOS界面态束缚电子,处于充电状态,即使增加偏压,对界面态的电离状态几乎没有影响,C-V曲线偏移量应接近饱和(类似于图5(a)的变化趋势)。然而,由图5(b)实际扫描结果观察到,C-V曲线的平移量随着偏压的增加明显增加,说明除了深能级界面态之外,还有其他因素引起C-V曲线偏移。C-V曲线平移的主要原因更可能是靠近SiO2/GaN界面的SiO2内部陷阱有电子注入。由图6(a)可见,阳极施加较小正偏压时,GaN的费米能级上升,SiO2/GaN界面处的GaN费米能级高于GaN导带底,此时电子开始积累,一些电子注入SiO2;由图6(b)可见,随着偏压的增大,GaN费米能级进一步抬升,SiO2/GaN界面电子浓度进一步增加,更多的电子注入SiO2,被SiO2内部陷阱束缚(如图5(b)所示,C-V曲线偏移量进一步增加,陷阱电子的影响类似固定电荷,并且注入量随着偏压时间和偏压大小的增加而增加)。器件的阈值电压偏移主要受界面态和氧化层陷阱两个因素的影响,通常ICP刻蚀界面会引入晶格损伤,引起氮空位等缺陷,引入GaN表面受主界面态;GaN表面的污染物,或者沉积薄膜前期的不稳定,都可能引起介质层靠近半导体界面的薄层内缺陷,造成介质层靠近半导体界面的内部陷阱,表面湿法处理和热退火等工艺可改善界面和氧化层质量。
为研究热退火SiO2/GaN MOS电容界面特性的影响,通过在沉积SiO2后利用RTA在氮气氛围下1000℃退火3min处理,其余工艺步骤不变,对比没有经过退火处理的样品,首先从7V往-3V扫描,然后在相同偏压大小(7V)下维持5min,并扫描C-V曲线,如图7所示。可以看到两样品在偏压后均有正向漂移,但是经过退火处理的样品漂移量明显小于没有经过退火的样品的漂移量,说明热退火处理减少了SiO2/GaN的界面陷阱,改善了SiO2/GaN界面的结合度,提高了SiO2的质量。
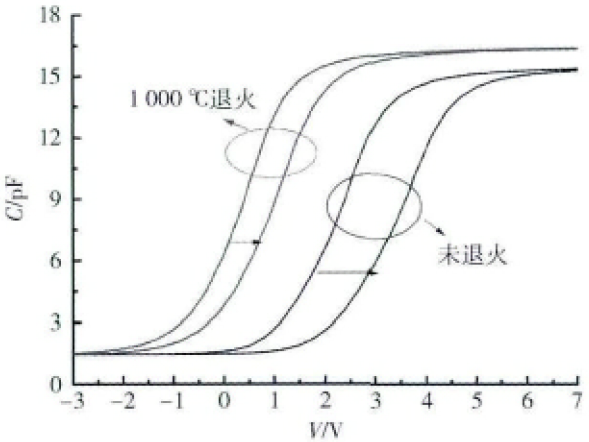
图7 SiO2退火器件的C-V曲线漂移对比
3. 结论
本文采用ICP干法刻蚀和PECVD沉积SiO2技术,成功制备了常关型SiO2/GaN MOSFETs;采用不同的偏压测试条件,分析了SiO2/GaN MOSFETs的阈值电压以及SiO2/GaN MOS二极管的C-V曲线偏移现象。实验结果对比和分析表明:采用PECVD制备的SiO2中存在内部陷阱,SiO2/GaN存在深能级界面态;外加正向偏压使得电子注入SiO2/GaN深能级界面态和SiO2内部陷阱,引起器件转移特性和二极管C-V曲线正向偏移;氮气1000℃退火可降低SiO2内部陷阱。
