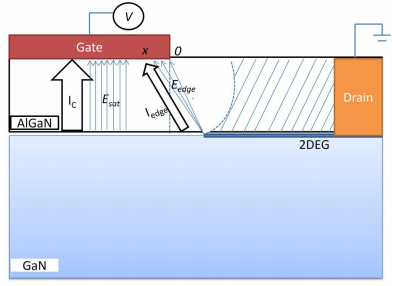
图1 面积电流和边缘电流分布示意图
上篇文章将栅极到漏极的二极管的反向漏电分成了两个部分,一个是面积相关的的面电流和边缘长度相关的栅边缘电流。如图1所示,定义在栅极的绝大部分流过的电流是面电流,而只在栅边缘流过的电流为栅边缘电流,且栅边缘电流的影响只在高栅偏置下才明显。由于之前研究并没有区分面电流和边缘电流,再加上实验的HEMT结构二极管的面积通常都很大,所以实际上之前研究的电流特性都是栅面积电流特性。反向栅面积相关电流与栅下的电场关系密切相关,在栅区域的电场E(V)由栅下的电荷分布和泊松方程给出

 。
。考虑栅极电压0V到阈值电压的范围,ns(V)随着电压的减小而不断减小,因而E(V)不断增大,反向栅面积电流也随之增大。但是当栅极电压等于阈值电压时,栅下2DEG被栅极完全耗尽,E(V)到达一个恒定值的最大值,栅电压继续增大,2DEG浓度已经降为零,E(V)不再随栅压的变化而变化,因而面积电流密度呈现了饱和的趋势。依据不同的拟合方法和分析,在此种偏置下的两种主要的栅漏电机制较多为人们接受:陷阱辅助隧穿(trap-assistedtunneling,TAT)与Frenkel-Poole发射(F-P)。但是显然这个理论的局限性在于低栅极偏置和大电流密度。对于增加的栅极负向电压,如1um甚至更低栅长的HEMT结构肖特基二极管,这个理论不能解释电流非饱和现象。
无论是面积相关的电流还是边缘长度相关的栅极边缘电流,必须明确电场分布及电场随栅极偏置电压变化的规律。因为所有的导电机制是和电场相关的,而非加在器件上的电压相关的。在栅极偏置为0V到阈值电压的范围内的电场变化规律已经在很多文献中讨论过。但是高于此范围的电场分布规律的分析模型却没有进行,或者就只是仅仅将电场用电压除以势垒层厚度(V/d)来代替。这样简略在栅极电压较小时可以适用,但是当栅极电压很大,饱和的电场分布将无法解释电流增强的原因。
栅极电压逐渐降低的时候,栅下沟道内的2DEG逐渐被耗尽。当栅极电压等于阈值电压时,在栅下沟道的所有电子都被全部耗尽,只剩下极化电荷。栅极电压继续降低,栅耗尽层的边缘接触到栅下沟道。此后再减小栅极电压,耗尽层将会向漏极/源极扩展。如图2所示。

图2 耗尽层沿着沟道往漏极/源极延伸示意图
外部的电压偏置沿着栅电极到栅下沟道所降落的压降为阈值电压,而其余的电压(VG-Vth)则横向地降落在漏极/源极延伸的耗尽层中。此时,栅下区域的电场仍然保持不变,阈值电压Vth作为以下推导方程的一个参考电位。我们可以将外部偏置分为两个部分,一个部分是阈值电压Vth,它的作用是耗尽栅下区域的2DEG;另外一部分是(VG-Vth),它的作用则是沿着沟道向漏极/源极的方向,耗尽长度为xEx距离的2DEG,横向延伸的耗尽层长度为xEx。为了简化问题,忽略栅下区域和x>xEx区域的耗尽渐变区域。空气中或者钝化层中的环绕电场的影响有可能严重的影响到耗尽层的电势分布,但是AlGaN/GaN异质结结构中栅电极的纵向位置和极化电荷能屏蔽掉环绕电场的影响,所以漏极/源极延伸的耗尽层仅由异质结内电荷决定。当横向延伸的耗尽层远大于纵向厚度时,AlGaN/GaN异质结的结构事实上变成了一维问题。根据电荷平衡条件,当xEx》d时,我们可以得到



为进一步评价ΔL的大小,可以通过数值计算来估算边缘电场影响的范围。在图2的坐标系下,x=0是栅极漏端,x越大则代表越深入栅极内部。考虑横向扩展的耗尽层的最大点xEx,这点的电压值为零,因此这点到栅极x点处的纵向电场可以近似表达为:


图3 栅极上离栅极漏端距离为x的电场分布
