场效应型横向功率二极管
场效应横向功率二极管的基本原理即是将三端异质结增强型场效应管器件的栅极技术移植到二极管的阳极附近并于阳极相连接,以实现正向导通、反向阻断的整流功能,其等效电路如图1所示。场效应型横向功率二极管的研制重点关注三个方面,即尽量降低开启电压同时降低导通电阻、尽量提高反向耐压、尽量减小工艺误差对器件开启电压的影响。
一般地,为了降低漏电以及提高反向阻断的能力,MISFET部分的栅极往往使用具有较高功函数的金属构成。而阳极部分为了降低正向导通电阻,往往由低阻的欧姆金属制备。
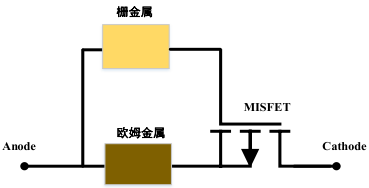
图1 场效应横向功率二极管等效示意图
另外,为了改善二极管整流器的性能,可以直接移植应用于AlGaN/GaN MISFET三极管中的各项技术。如通过增加MIS栅长度、添加场板结构、添加结终端(电极终端)等手段提高耐压性能,通过对MIS栅进行优化降低导通电阻。例如,栅式欧姆阳极整流器、GET-SBD、全凹槽阳极SBD,等诸多结构被提出以优化折中耐压与开启电压。本文作者所在实验室的一系列工作,如L-FER、HA-FER、MG-HAD等结构也为GaN异质结功率整流器的开发提出了思路。
但是,尽管MG-HAD这类性能优越的功率整流器实现了较高的性能,但因其阳极阴极金属都是欧姆金属接触,因此需要MISFET部分实现常关型以此实现整个二极管的整流能力。这对MIS凹槽栅必须具有一定的深度提出了要求。而经验与文献表明,MIS槽栅过深(势垒层剩余5nm以下)会显著影响MIS栅下沟道的导通能力。
下文将提出一种具有Γ型阳极的浅场板集成栅横向功率二极管整流器(GA-SBD)。通过应用浅场板集成栅极大地提高了器件的耐压同时降低了MISFET结构对整流器导通性能的影响。同时,通过采用肖特基Γ型阳极极大地降低了整流器的开启电压。
GA-SBD的工作原理
GA-SBD的结构如图2所示。器件的阳极采用较低功函数的肖特基金属接触以降低开启电压。阳极的阴极一侧采用浅场板式的MISFET,其中栅金属采用功函数较高的肖特基金属接触。此MISFET部分既是一个耗尽型结构,又是一个浅凹槽的场板。所以此结构既能有效提高器件的反向阻断能力,又不会剧烈地影响器件的开启与导通。器件采用欧姆阴极,且需要在漂移区上进行钝化处理以提高性能。在下文的仿真中,整个器件利用一个AlGaN/GaN-on-Si晶圆来制备。
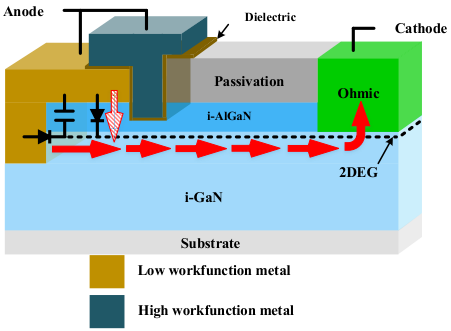
图2 GA-SBD结构示意图
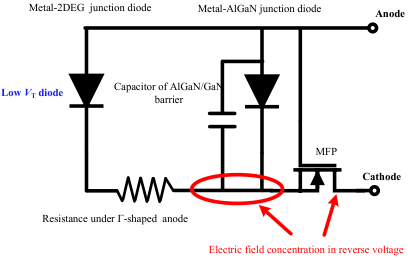
图3 GA-SBD的等效电路
图3所示的是GA-SBD的等效电路模型。可以清晰地看出,GA-SBD的设计关键是低开启电压SBD与高耐压的MISFET型浅场板(MFP)。而为了进一步降低阳极SBD的开启电压,GA-SBD采用了Γ型低功函数阳极的设计。这样一来,阳极可以分成两部分分析,一部分是垂直的全凹槽金属-2DEG结SBD,一部分是常规的金属-AlGaN结SBD。对于前一部分,由于其所具有的金属-2DEG结是低功函数金属与高浓度2DEG的直接接触,在某种意义上说,是一种具有极薄势垒的欧姆接触,因此这部分结构有极低的开启电压和极高的电流输运能力。而对于后一部分的金属-AlGaN结SBD,将会在阳极电压较高时开启,形成双SBD并行输运的模式,进一步提高了器件整体电流输运能力。另外,金属-AlGaN结由于具有宽禁带的AlGaN层,因此在反向阻断时可以看做一个电容器,协同MFP更加有效地保护金属-2DEG结,提高器件耐压能力。器件的反向阻断主要依靠MFP,当阴极具有高压时,器件MFP可以有效钳位,使阳极承受极低电压。另外,通过金属-AlGaN电容的协同保护,势垒较低的金属-2DEG结能够不被反向击穿。
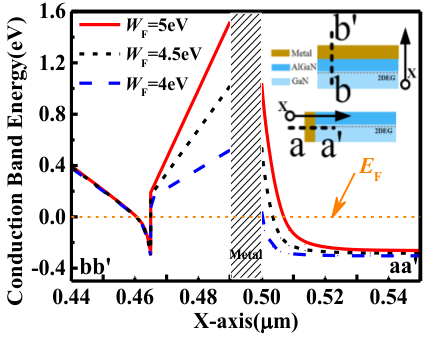
图4 Γ型阳极不同肖特基结的导带分布
图4所示的是Γ型阳极的金属-2DEG结与金属-AlGaN结的能带图。当肖特基金属功函数为4eV时,金属-2DEG结基本没有势垒,而金属-AlGaN结势垒高度仅为0.5eV左右。当金属功函数为5eV时,金属-2DEG结即具有1eV左右的势垒而金属-AlGaN结的势垒高达1.4eV左右,而此时整个器件接近为一个常规SBD,失去了低开启电压的功能,故本文不做讨论。从图4中也能看出,Γ型阳极的两个结势垒高度之差的绝对值约0.4eV,这个值将会在后文中应用。另外,在后文的研究中,为了方便起见,依旧用4eV功函数代表锰金属,4.5eV功函数代表铁金属。
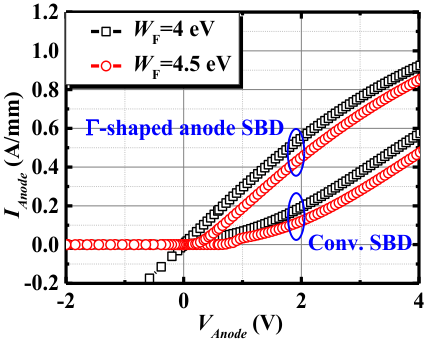
图5 低功函数Γ型阳极SBD与传统SBD导通性能比较
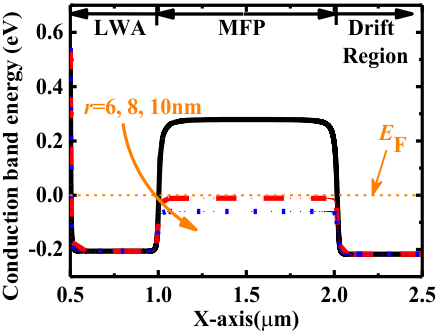
图6 MFP下沟道的导带分布图
通过仿真可以明显看出低功函数的Γ型阳极对整流器电流输运能力的提升。图5所示的是低功函数Γ型阳极SBD与传统SBD正向导通时的电流的比较。可以看出当阳极金属功函数WF为4eV和4.5eV时,Γ型阳极SBD极大地提高了器件的电流输运能力。但是同样也值得注意的是,低功函数阳极也使器件反向漏电很大,如图5中阳极电压为较低的负值时,WF=4eV样品的漏电即非常之大。这说明MFP的设计至关重要。图6是不同凹槽深度的MFP能带图。可以看出当MISFET结构的栅凹槽对势垒的剩余高度在8nm以下时,栅下方沟道处的导带即提升至费米能级以上。这说明MIS栅极下方的2DEG开始被有效耗尽。而当剩余高度在8nm以上时,MISFET结构对器件沟道基本没有影响。但是从图中也可以看出,剩余高度在6nm时,MIS栅下方势垒高度仅为0.3eV。这个势垒在MIS栅的开启时能很快的形成2DEG积累而不影响整个器件的开启电压。因此本文的研究主要是对剩余深度为6nm(含)以上的MFP进行探讨。
