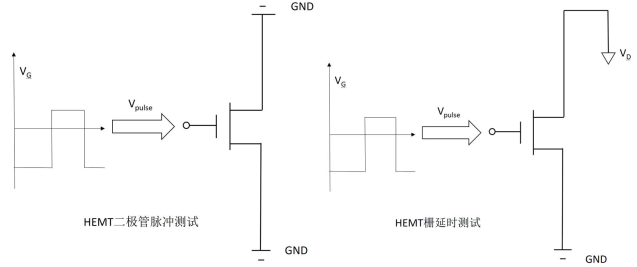
图1 HEMT栅极脉冲测试和HEMT结构二极管栅脉冲测试示意图
图2示出的是耗尽型和增强型HEMT器件的栅极延迟特性,由于器件势垒层,异质结界面,尤其是器件表面存在慢态陷阱,可以从图上看到,漏极的电流的变化相应要慢于栅电压的变化。在图中虚线框的部分可以明显看到在栅电压已经转换完成后,漏电流还有一个缓慢的上升过程。图2(a)和图2(b)的对比来看,耗尽型和增强型器件都展示了非常相似的栅延时特性,F处理并未明显改变栅延时特性。

图2 耗尽型和F处理增强型HEMT器件的栅延时特性对比(a)耗尽型HEMT器件(b)增强型HEMT器件
图3给出的是常规HEMT结构二极管和F处理二极管瞬态电流测试对比。从图上可以看到。二极管的栅极延时特性要明显好于HEMT器件的延时特性。栅电压完成电压变化后,栅电流并没有展示一个缓慢的上升至饱和区域。
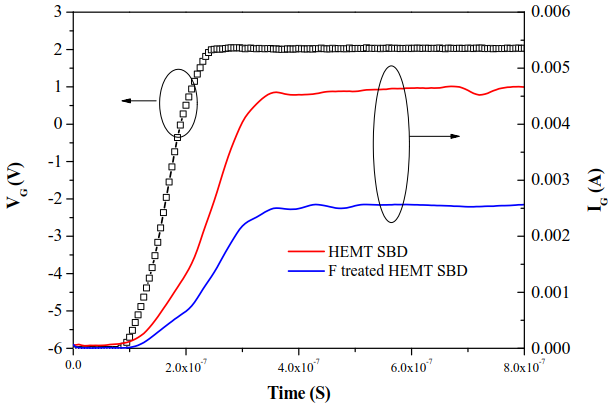
图3 常规HEMT结构二极管和F处理二极管瞬态电流测试
为了更清楚地对比HEMT器件电流延时和HEMT结构二极管电流延时,在图4中同时画出了HEMT器件瞬态电流和HEMT结构二极管瞬态电流。栅脉冲从1×10-7s时开始加入,经过100ns到达脉冲高度。耗尽型HEMT的电流到5.7×10-7s才稳定到达自己的饱和值;常规HEMT结构二极管的电流则在3×10-7就到达了稳定值。F处理HEMT器件的电流在5.5×10-7到达自己的饱和值,F处理HEMT结构二极管的电流在3.3×10-7s后已经稳定。无论常规HEMT结构二极管还是F处理HEMT结构二极管,栅极电流都比HEMT器件到达稳定值的时间快约2.1×10-7s。结果表明,实际的HEMT结构二极管虽然与寄生栅极悬空的HEMT始终相连,HEMT结构二极管的电流流过寄生HEMT和肖特基结,但是HEMT结构二极管的栅电流延迟特性并没有如HEMT器件一样受栅源/栅漏区域陷阱态的影响。HEMT结构二极管的电流能较快地响应栅极的电流。

图4 HEMT器件瞬态电流和HEMT结构二极管瞬态电流对比(a)耗尽型HEMT器件和二极管对比,(b)增强型HEMT器件和二极管对比
考察在正反向脉冲应力下HEMT结构二极管的退化情况,正向脉冲和反向脉冲的波形图如图5所示。采用4200半导体参数分析仪的脉冲模块(ARB wave form)编辑合适的波形,正反向的电压高度均为使得超过HEMT结构二极管正方向电场饱和值的电压。正向的电压为3V,大于常规HEMT结构二极管的内建势1.34V和F处理HEMT结构二极管的内建势1.98V,反向电压为-8V。正负脉冲的脉宽均为500us,脉冲上升下降时间为100ns。
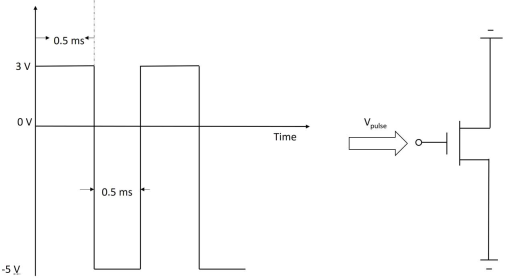
图5 正负电压交替栅极应力测试示意图
由于在脉冲应力过程中无法实时监测到电流的变化情况,因此在脉冲应力间隙的50s,100s,500s,1000s,2000s,5000s,10000s对栅电压为3.5V的电流进行测试记录,然后测量Vout在这些时间值后的变化情况。如图6所示的是3.5V栅电压下的HEMT结构二极管电流变化情况,常规HEMT结构二极管的正向电流几乎不变,F处理HEMT结构二极管的栅极电流在5000秒后有轻微的增加。
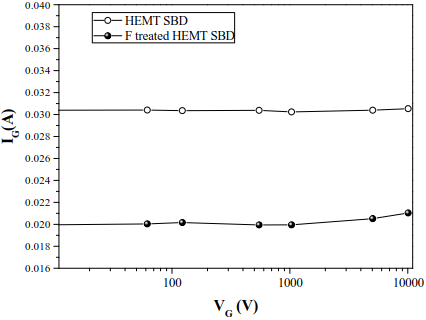
图6 10000秒正负脉冲应力不同类型HEMT结构二极管栅极3.5V时电流
图7是在50s,100s,500s,1000s,2000s,5000s,10000s时测试的Vout值。常规型HEMT结构二极管的Vout和直流偏置时类似,几乎没有变化。而F处理HEMT结构二极管的Vout已经比直流偏置时有了很大改善,10000s后的势垒高度偏移值仅为-0.07V,且在脉冲应力的前2000s基本没有漂移。

图7 10000秒正负脉冲应力后,有源电阻和HEMT结构二极管串联结构测量HEMT结构二极管输出电压在10000秒变化曲线
由以上直流和脉冲的应力测试分析,我们可以提出高正向偏置下F处理等离子体处理肖特基二极管退化的机理。肖特基势垒高度的变化意味着F离子的漂移或电学特性改变。一种可能的机理是大量的电子与F离子碰撞,使F离子电子成为一个中性的原子。失去电子的F离子也丧失了提高势垒高度的特性,因此原来因为F离子引入而升高的势垒高度降低;另一种可能的机制是F离子在大量电子的撞击下偏离了原来的位置。作者认为第二种解释更为合理。首先,从以上的应力实验来看,F处理HEMT结构二极管势垒高度的降低是不可恢复的过程,如果为碰撞电离,则在条件恢复后,F原子能继续捕捉电子从而恢复到原来势垒高度;其次,F处理HEMT结构二极管势垒高度降低是一个由电流驱动、时间积累的过程,而非瞬间发生的。F电离能是固定的值,若电子能量不足以电离F离子,那么无论多久的时间积累,对于电离是毫无用处的。如图8所示的正向大偏置下F处理HEMT结构二极管栅极区域能带示意图,当F处理HEMT结构二极管的正向偏置高于HEMT肖特基结的内建电势后,减去内建电势的外加电压值将加在寄生HEMT结构二极管的源漏两端。大量的电子从AlGaN势垒层中穿过,与注入到势垒层的F离子碰撞。F离子由于不和N,Ga,Al元素成键,在势垒层处于间隙位的相对平衡位置上,不存在一个固定能量的晶格位移阈值能。因此如果碰撞的电子的速度到达一定数值后,被撞击缓慢地离开源平衡位置往栅极方向移动。经过一定时间的积累,在势垒层内的F离子密度下降,造成势垒高度的降低。F处理Ni-AlGaN HEMT结构二极管的正向导电机理为陷阱辅助隧穿,势垒高度的降低对栅极正向的电流的改变并不明显,因此从栅漏电应力后的改变来看,应力前后的变化量并不大。
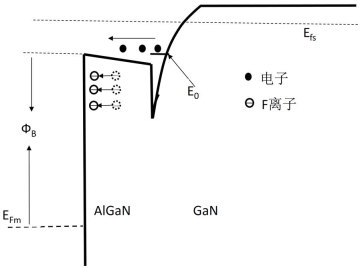
图8 正向大偏置下F处理HEMT结构二极管栅极区域能带示意图
